ЛАБОРАТОРНАЯ РАБОТА №1
по микроэлектронике
« ИССЛЕДОВАНИЕ КОНСТРУКЦИИ ПОЛУПРОВОДНИКОВОЙ
ИНТЕГРАЛЬНОЙ МИКРОСХЕМЫ».
Выполнил: Проверил:
Студент 312 группы Никитанов С.В.
Кузнецов А.А.
Саранск 2013
Цель работы: изучение элементов конструкции и физической структуры полупроводниковой интегральной микросхемы, изучение принципиальной электрической и топологической схем ИМС.
Интегральной микросхемой (ИМС) называют микроэлектронное изделие, выполняющее определенную функцию преобразования и обработки сигналов и имеющее высокую плотность упаковки электрически соединенных элементов (или элементов и компонентов) и кристаллов, которое с точки зрения требований к испытаниям, приемке, поставке и эксплуатации рассматривается как единое целое.
Полупроводниковая интегральная микросхема - это ИМС, все активные и пассивные элементы которой выполнены в объеме и (или) на поверхности полупроводниковой пластины. В зависимости от типа активного элемента полупроводниковые интегральные микросхемы подразделяются на ИМС с биполярными транзисторами и полевыми транзисторами. Технология изготовления полупроводниковых ИМС базируется на технологии производства транзисторов, но имеет свои особенности. Имея приблизительно одинаковые размеры, они отличаются от транзисторов тем, что в пределах полупроводниковой пластины располагается определенное количество транзисторов, диодов, резистивных и ёмкостных элементов, соединенных между собой согласно электрической схеме. В пределах полупроводниковой пластины эти элементы должны быть изолированы друг от друга. Изоляция элементов может быть осуществлена с помощью p-n -перехода, смещенного в обратном направлении, или слоя окисла кремния (SiO2).
Технологический маршрут изготовления полупроводниковой биполярной ИМС
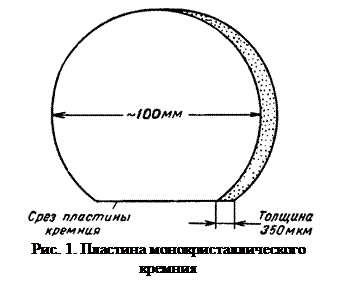 В настоящее время большинство полупроводниковых ИМС изготавливаются по планарной технологии, которая основана на использовании маскирующего слоя SiO2, диффузии, ионной имплантации, фотолитографии и эпитаксиального наращивания.
В настоящее время большинство полупроводниковых ИМС изготавливаются по планарной технологии, которая основана на использовании маскирующего слоя SiO2, диффузии, ионной имплантации, фотолитографии и эпитаксиального наращивания.
В современных интегральных схемах исходным материалом обычно является кремниевая пластина p -типа с эпитаксиальной пленкой n -типа. Рассмотрим этот процесс подробнее.
Исходный материал. Обработке подвергается пластина монокристаллического кремния (рис. 1), легированная до требуемого значения удельного сопротивления (обычно 10 Ом×см).
 Для лучшего понимания процесса рассмотрим фрагмент простой интегральной схемы, состоящий из транзистора, диода, резистора и конденсатора (рис. 2).
Для лучшего понимания процесса рассмотрим фрагмент простой интегральной схемы, состоящий из транзистора, диода, резистора и конденсатора (рис. 2).
Исходная пластина непосредственно перед обработкой полируется до зеркально-гладкой поверхности или подвергается легкому “финишному” травлению для снятия поверхностного нарушенного слоя, образовавшегося в процессе механической полировки.
Окисление пластин. Для структур, в которых используются скрытые слои, первой технологической операцией является окисление кремниевой пластины p -типа. Слой SiO2 предназначен для маскирования поверхности пластин при проведении диффузии для получения скрытого слоя. Для эффективной защиты поверхности подложки толщина окисной пленки должна лежать в пределах 0,2—1 мкм.
 Скрытый слой. Скрытый слой используется для уменьшения последовательного сопротивления коллектора. Для его создания обычно проводится диффузия мышьяка или сурьмы, поскольку их растворимость в кремнии больше, а коэффициент диффузии меньше, чем у бора и фосфора. Это позволяет получать низкоомные области в кремнии, которые на последующих операциях почти не изменяют своих размеров в результате диффузии (рис. 3). Для получения наименьшего возможного поверхностного сопротивления (менее 10 ом/ð) при диффузии мышьяка концентрация примесей должна составлять 1021 см-3.
Скрытый слой. Скрытый слой используется для уменьшения последовательного сопротивления коллектора. Для его создания обычно проводится диффузия мышьяка или сурьмы, поскольку их растворимость в кремнии больше, а коэффициент диффузии меньше, чем у бора и фосфора. Это позволяет получать низкоомные области в кремнии, которые на последующих операциях почти не изменяют своих размеров в результате диффузии (рис. 3). Для получения наименьшего возможного поверхностного сопротивления (менее 10 ом/ð) при диффузии мышьяка концентрация примесей должна составлять 1021 см-3.
 Эпитаксиальный слой. Эпитаксиальный слой n -типа выращивается после удаления с пластины всего слоя окисла. Для легирования эпитаксиальной пленки донорной примесью в качестве диффузанта обычно используется фосфин (рис. 4). Толщина эпитаксиального слоя составляет 7—15 мкм, его удельное сопротивление 0,5—5 ом×см. При температуре в эпитаксиальном реакторе порядка 1200°С этот слой выращивается за 10—20 мин.
Эпитаксиальный слой. Эпитаксиальный слой n -типа выращивается после удаления с пластины всего слоя окисла. Для легирования эпитаксиальной пленки донорной примесью в качестве диффузанта обычно используется фосфин (рис. 4). Толщина эпитаксиального слоя составляет 7—15 мкм, его удельное сопротивление 0,5—5 ом×см. При температуре в эпитаксиальном реакторе порядка 1200°С этот слой выращивается за 10—20 мин.
Повторное окисление пластины. После наращивания эпитаксиального слоя всю поверхность пластины вновь окисляют для создания маски, необходимой при последующих процессах диффузии. Повторно выращенный окисный слой должен иметь достаточную толщину для защиты пластины от диффузии примесей при создании изолирующего перехода; обычно толщина окисного слоя составляет 1 мкм. Окисные слои на последующих операциях повторного окисления выращиваются одновременно с диффузией, проводимой для создания изолирующих переходов, базы и эмиттера.
Диффузия для создания изолирующих переходов. Разделительная диффузия необходима для изоляции различных областей подложки, содержащих компоненты схемы, которые не имеют общих соединений между коллекторами. Диффузия должна пройти на всю глубину эпитаксиального слоя (рис. 5). При определении режимов процесса диффузии необходимо учитывать влияние температуры и времени каждого последующего процесса диффузии на предыдущие процессы. При изготовлении базы и эмиттера примесь, применяемая для создания изолирующего участка, будет углубляться в подложку. Разделительная диффузия является наиболее глубокой диффузией, применяемой в производстве интегральных схем. Для создания изолирующих областей p -типа диффузия бора из источника (ВВг3) проводится при температуре 1200° С в течение нескольких часов.
 Диффузия для получения базы. При проведении базовой диффузии помимо базовых областей транзисторов создается большинство диффузионных резисторов и анодов диодов. Диффузия для получения базы ведется на небольшую глубину (2,3—3,2 мкм) и требует более тщательного контроля, чем разделительная диффузия или диффузия для получения скрытого слоя. По это причине она проводится при меньших температурах (1100 °С) в течение 1 ч. После вытравливания окон для проведения базовой диффузии измеряют токи утечки и пробивное напряжение изолирующего перехода. На этом этапе выявляется плохое качество диффузии или дефекты материала. Базовая диффузия должна обеспечить как можно более точное значение поверхностного сопротивления, поскольку его величина и размеры окон определяют величину сопротивления большинства резисторов. Современные диффузионные установки позволяют получать поверхностное сопротивление порядка 200 ом/ð ± 5 % (рис. 6).
Диффузия для получения базы. При проведении базовой диффузии помимо базовых областей транзисторов создается большинство диффузионных резисторов и анодов диодов. Диффузия для получения базы ведется на небольшую глубину (2,3—3,2 мкм) и требует более тщательного контроля, чем разделительная диффузия или диффузия для получения скрытого слоя. По это причине она проводится при меньших температурах (1100 °С) в течение 1 ч. После вытравливания окон для проведения базовой диффузии измеряют токи утечки и пробивное напряжение изолирующего перехода. На этом этапе выявляется плохое качество диффузии или дефекты материала. Базовая диффузия должна обеспечить как можно более точное значение поверхностного сопротивления, поскольку его величина и размеры окон определяют величину сопротивления большинства резисторов. Современные диффузионные установки позволяют получать поверхностное сопротивление порядка 200 ом/ð ± 5 % (рис. 6).
Диффузия для получения базы всегда проводится в два этапа, поскольку необходимо контролировать глубину диффузии и поверхностную концентрацию. Если проводить базовую диффузию в один этап, то низкая температура, требуемая для получения необходимой поверхностной концентрации, увеличит продолжительность процесса (до одной недели).
При базовой и эмиттерной диффузии пластины размешаются в лодочке вертикально, что позволяет обрабатывать большее количество пластин в строго контролируемой зоне диффузионной печи. При вертикальном размещении пластин и использовании газообразного диффузанта диффузия примеси от пластины к пластине может оказаться неодинаковой. В предельном случае разница в концентрации примеси в пластинах, размещенных в начале лодочки (по направлению потока газа) по сравнению с концентрацией примеси в пластинах, расположенных в конце лодочки, составляет 10 %.
Диффузия для получения эмиттера. Диффузия для получения эмиттера позволяет одновременно создать омические контакты n -типа, низкоомные диффузионные резисторы и межкомпонентные соединения, для которых основной проблемой является изготовление пересечения.
 Процесс эмиттерной диффузии (поверхностное сопротивление 2—5 ом/ð, глубина 1,5—2,5 мкм) должен тщательно контролироваться (так же как и базовая диффузия), так как он влияет на высокочастотные характеристики транзистора и на его коэффициент усиления по току. Ширина базы определяется как разница между глубиной диффузии базы и эмиттера (рис. 7). Для получения высокой поверхностной концентрации примеси диффузия эмиттера проводится при высоких температурах (от 980 до 1050 °С) в течение 20—30 мин.
Процесс эмиттерной диффузии (поверхностное сопротивление 2—5 ом/ð, глубина 1,5—2,5 мкм) должен тщательно контролироваться (так же как и базовая диффузия), так как он влияет на высокочастотные характеристики транзистора и на его коэффициент усиления по току. Ширина базы определяется как разница между глубиной диффузии базы и эмиттера (рис. 7). Для получения высокой поверхностной концентрации примеси диффузия эмиттера проводится при высоких температурах (от 980 до 1050 °С) в течение 20—30 мин.
После диффузии эмиттера при более низкой температуре (900 °С) проводится окисление пластины во влажном кислороде. Окисный слой предназначается для защиты эмиттерных областей и предотвращения их закорачивания при металлизации поверхности пластины.
Травление перед изготовлением омического контакта. Для создания контактов к компонентам схемы в слое SiO2 вытравливаются окна. Окна в слое SiO2 вскрывают также для создания верхнего контакта к подложке, что позволяет измерять параметры транзисторов и резисторов, а также характеристики подложки (рис. 8). Поскольку последующие процессы проводятся при температурах значительно ниже температуры диффузии примесей, эти измерения позволяют определить параметры компонентов в готовой схеме. Таким образом, электрические измерения являются важным методом контроля качества интегральных схем.
 Металлизация. С помощью различных процессов диффузии в пластине создаются отдельные компоненты, мало отличающиеся по своей структуре и параметрам от дискретных компонентов. Для получения законченных интегральных схем эти компоненты необходимо соединить друг с другом с помощью токоведущих дорожек (рис. 9). При изготовлении таких соединений необходимо при выборе материала и метода изготовления выполнять следующие условия:
Металлизация. С помощью различных процессов диффузии в пластине создаются отдельные компоненты, мало отличающиеся по своей структуре и параметрам от дискретных компонентов. Для получения законченных интегральных схем эти компоненты необходимо соединить друг с другом с помощью токоведущих дорожек (рис. 9). При изготовлении таких соединений необходимо при выборе материала и метода изготовления выполнять следующие условия:
1. К каждому компоненту необходимо создать омические невыпрямляющие контакты,
2. На кремниевой пластине необходимо создать контактные площадки для присоединения проволочных или других выводов, осуществляющих соединение с внешней схемой,
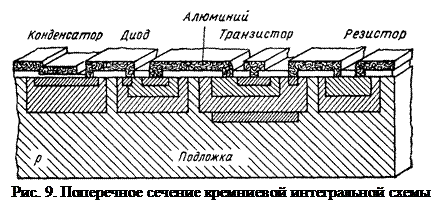 3. Соединение компонентов должно быть выполнено из низкоомного материала.
3. Соединение компонентов должно быть выполнено из низкоомного материала.
Первому условию удовлетворяют многие металлы, например золото, алюминий, свинец, серебро, хром и никель. Чаще всего используется алюминий, однако иногда ему предпочитают хром и золото.
Второе условие диктует требование совместимости материалов контактной площадки и вывода. Обычно используются золотые и алюминиевые проволочные выводы, которые имеют хорошую адгезию.
Третье условие выдвигает требование хорошей адгезии проводника к поверхности двуокиси кремния. При правильном проведении процесса металлизации этому условию удовлетворяют алюминий и хром. При невысоких температурах (200—300 °С) эти металлы реагируют с двуокисью кремния, образуя поверхность раздела окись металла — окись кремния, обладающую хорошими контактными свойствами.
После металлизации вновь проводится процесс фотолитографии, назначение которого — защитить рисунок соединений при травлении, проводимом для удаления лишнего металла.