Типовые технологические процессы и операции создания ИС
Создание П/П ИС начинается с получения монокристаллических слитков кремния или германия. используются методы Чохральского и зонной плавки.
 При мЧ монокристаллические слитки П/П получают пу-тем кристаллизации из расплава. При этом методе стержень с затравкой (в виде монокристалла кремния) после соприкосновения с расплавом мед-ленно поднимают с одновременным вращением. При этом вслед за затрав-кой вытягивается нарастающий и застывающий слиток. Метод обеспечи-вает получение П/П материала в форме совершенных мо-нокристаллов с определенной кристаллической ориентацией и минималь-ным числом дефектов. Нагреватель может быть резистивным, высокочас-тотным, электронно-лучевым.
При мЧ монокристаллические слитки П/П получают пу-тем кристаллизации из расплава. При этом методе стержень с затравкой (в виде монокристалла кремния) после соприкосновения с расплавом мед-ленно поднимают с одновременным вращением. При этом вслед за затрав-кой вытягивается нарастающий и застывающий слиток. Метод обеспечи-вает получение П/П материала в форме совершенных мо-нокристаллов с определенной кристаллической ориентацией и минималь-ным числом дефектов. Нагреватель может быть резистивным, высокочас-тотным, электронно-лучевым.

 М з п (метод перекристаллизации) является безти-гельным. Перед началом кристаллизации расплавляется не вся твердая фаза кристалла, а только узкая зона, которую перемещают вдоль кристалла смещением нагре-вателя. Большинство примесей обладают хорошей раст-воримостью в жидкой фазе по сравнению с твердой, поэтому по мере прод-вижения зона плавления все больше насыщается примесями, которые кон-центрируются на конце слитка. процесс з п повторяют несколько раз, по окончании очистки загрязненный конец слитка отрезают.
М з п (метод перекристаллизации) является безти-гельным. Перед началом кристаллизации расплавляется не вся твердая фаза кристалла, а только узкая зона, которую перемещают вдоль кристалла смещением нагре-вателя. Большинство примесей обладают хорошей раст-воримостью в жидкой фазе по сравнению с твердой, поэтому по мере прод-вижения зона плавления все больше насыщается примесями, которые кон-центрируются на конце слитка. процесс з п повторяют несколько раз, по окончании очистки загрязненный конец слитка отрезают.
Типовой диаметр слитков= 150 мм, а макс может достигать 300 мм и более. Длина слитков =3 м, но обычно она в несколько раз меньше.
Слитки кремния разрезают на множество тонких пластин (0,4 – 0,5мм) с помощью вра-щающихся стальных дисков с внутренней и внешней режущими кромками, армированными искусственными или природными алмазами; с помощью тонкой проволоки (0,08 – 0,1 мм). вольфрамовой проволокой, покрытой тонким слоем алмазной крошки.
После резки слитков на пластины для получения параллельности сторон пластин, точ-ного соответствия заданным размерам и уменьшения глубины нарушенного слоя проводят шлифование пластин(с помощью: абразивные материалы, алмазные по-рошки, полировочные пасты).
После шлифования проводят полировку пластин. Кроме мех, используется хим полировка (травление(Т), т. е. по существу растворение поверхностного слоя П/П в тех или иных реактивах. Выступы и трещины на поверхности стравливаются быст-рее, чем основной материал, и в целом поверхность выравнивается.
Важным в П/П технологии является также очистка поверхности от за-грязнений органич вещ-ми, особенно жирами. Для этого используют орг раств-ли (толуол, ацетон, этиловый спирт и др.) при повышенной тем-ре. Т, очистка и многие др процессы сопровождаются отмывкой пластины в деионизи-рованной воде.
Эпитаксия (Э)– процесс наращивания монокристаллических слоев на П/П подложку, при котором кристалл-ая структура наращиваемого слоя повторяет кристал-лографическую ориентацию подложки. Э используется для получ тон-ких раб-х слоев однородного П/П на сравнительно толстых подложках. Э позволяет выращивать монокристаллич слои любого типа электропроводности и любого удельного сопротивления на подложке. Граница между эпитаксиальным слоем и подложкой не получается идеально резкой, поэтому затруд-нено создание сверхтонких (менее 1 мкм) слоев и многослойных эпитаксиальных структур.она позволяет получать достаточно тонкие слои (1 – 10 мкм).
Э пленка может отл от подложки по хим составу. Спо-соб получения таких пленок наз гетероэпитаксией (гет), в отличие от гомоэпитаксии, описанной выше. При гет материалы пленки и подложки должны по-прежнему иметь одинаковую кристалл. Решетку
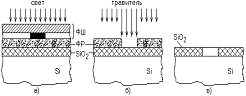
 При хлоридном процессе Э монокристаллич кремн-е пластины загру-жают в тигель и помещают в кварцевую трубу. Через трубу пропускают поток Н2, содержащий не-большую примесь SiCl4. При высокой темпер (около 12000С), на поверхности пластин реакция SiCl4 + 2H2 → Si + 4HCl.
При хлоридном процессе Э монокристаллич кремн-е пластины загру-жают в тигель и помещают в кварцевую трубу. Через трубу пропускают поток Н2, содержащий не-большую примесь SiCl4. При высокой темпер (около 12000С), на поверхности пластин реакция SiCl4 + 2H2 → Si + 4HCl.
В рез-те реакции на подложке постепенно осаж-дается слой чистого кремния, а пары HCl уносятся потоком Н2. Благодаря подбору температуры, химическая ре-акция происходит только на поверхности пластины.
Процесс, проходящий в потоке газа, наз газотранспортной реакцией, а основной газ (в данном случае водород), переносящий примесь в зону реакции, - газом-носителем.
Еще сущ-т жидкостная Э, при которой наращива-ние монокристал слоя осущ-ся из жидкой фазы, т. е. из рас-ра, содержа-щего необходимые компоненты.
 Э позволя-ет выращивать монокристаллич слои любого типа проводимости и любо-го удельного сопр-я на подлож-ке, обладающей тоже любым типом и величиной проводимости.
Э позволя-ет выращивать монокристаллич слои любого типа проводимости и любо-го удельного сопр-я на подлож-ке, обладающей тоже любым типом и величиной проводимости.
 23. Термическое окисление – получаемая в этом процессе пленка двуокиси кремния SiO2 выполняет несколько важ-ных функций:
23. Термическое окисление – получаемая в этом процессе пленка двуокиси кремния SiO2 выполняет несколько важ-ных функций:
а) ф-ю защиты – пассивации поверхности и, в частности, защиты вертик-х участков p-n-переходов, выходящих на поверхность;
б) ф-ю маски, через окна которой вводятся необходимые примеси;
в) ф-ю тонкого диэлектрика под затвором МОП-транзистора.
крем-ний в наст время явл-ся основным материалом для изготовл П/П ИС.
Поверхность всегда покрыта собственной окисной пленкой даже при самых низких темпер, но эта пленка имеет слишком малую толщину (около 5 нм). Поэтому ее нельзя использовать для выполнения перечисленных ф-й. Пленки двуокиси кремния приходится получать искус-м путем.
Искус-е ок-е кремния обычно осущ-ся при высокой тем-ре (1000 – 12000С) и наз термическим окислением. Оно м/б проведено в атмо-сфере кислорода (сухое окисление) и в смеси О2 с парами воды (влажное окисление) или в парах воды. Сухое окисл идет в десятки раз медленнее влажного. С умень-ем темпер на каждые 100С время окисл растет в 2 – 3 раза.
 Легирование – операция введения необходимых примесей в монокристаллический П/П. Основным способом легирования явл-ся диффузия примесных атомов при высокой температуре. Широкое распр-е получил и др способ – ионное легиро-вание (имплантация).
Легирование – операция введения необходимых примесей в монокристаллический П/П. Основным способом легирования явл-ся диффузия примесных атомов при высокой температуре. Широкое распр-е получил и др способ – ионное легиро-вание (имплантация).
Диффузионное легирование м/б общим (по всей поверхности, рис. а) и локаль-ным (на определенных участках через окна в масках, рис. б).
Общая диффузия приводит к обр-ю в пластине тонкого диффузи-онного слоя, который отл-ся от эпитаксиального неоднородным (по глубине) распределением примеси.
В случае локальной диффузии примесь распр-ся не только вглубь пластины, но и во всех перпендикулярных направлениях, т. е. под маску. В результате этой так называ-емой боковой диффузии участок p-n-перехода, выходящий на поверхность, оказывается “ав-томатически” защищенным окислом.
Диффузию можно проводить однократно и многократно. При проведении многократ-ной диффузии конц-я каждой новой вводимой примеси до-лжна превышать конц-ю предыдущей, в противном случае не образуется p-n-переход.
Ионное легирование осуществляется путем бомбардировки пластины (или эпитакси-ального слоя) ионами примеси, ускоренными до энергии, достаточной для их внедрения вглубь твердого тела.
ИЛ м/б общей и локальной (избира-тельной). В последнем, более типичном случае, облучение (бомбардировка) производится через маски, в которых длина пробега ионов должна быть значительно меньше, чем в крем-нии. достоинством ионной имплантации является то, что ионы, двигаясь по прямой линии, внедряются только вглубь пластины, а аналогия боковой диффузии (под маску) пра-ктически отсутствует.
Главным преимуществом ионной имплантации являются: низкая тем-ра процесс-са и его хорошая контролируемость. Низкая тем-ра обеспечивает возможность прове-дения ионного легирования на любом этапе технологического цикла, не вызывая при этом дополнительной диффузии примесей в ранее изготовленных слоях.
24.Травление в общем случае можно рассматривать как не механические способы изменения рельефа поверхности твердого тела.
Химическое травление подразделяется на изотропное, анизотропное и селективное. Изотропное травление – это растворение П/П материала с одинаковой скоростью по всем кристаллографическим направлениям. Такое травление позволяет равномерно стравливать тонкие слои и получать ровную поверхность. Такое травление называют также полирующим или хим полированием. Анизотропное травление – растворение П/П материала с неодинаковой скоростью по различным кристаллографическим направлениям, которое позволяет вытравливать глубокие канавки и щели. Селективное (избирательное) травление – растворение П/П материала с повышенной скоростью травления в местах выхода на поверхность структурных дефектов.
Характерной особенностью локального травления (через защитную маску) является так называемое подтравливание – эффект, аналогичный боковой диффузии. травление идет не только вглубь пластины, но и в стороны – под маску. В результате стенки вытравленного рельефа оказываются не совсем вертикальными, а площадь углубления – больше площади окна в маске.
Электролитическое травление отличается тем, что хим реакция жидкости с тв телом и образование растворимого соединения происходят в условиях протекания тока через жидкость, причем тв тело играет роль одного из электродов – анода. тв тело должно обладать достаточной электропроводностью. Преимуществом электролитического травлении: возможность регулировать скорость травления путем изменения тока в цепи и прекращать процесс путем его отключения.
При ионном травлении пластина кремния помещается в разреженное пространство, в котором, невдалеке от пластины, создается тлеющий разряд. Пространство тлеющего разряда заполнено квазинейтральной электронно-ионной плазмой. На пластину относительно плазмы подается достаточно большой отрицательный потенциал. В результате положительные ионы плазмы бомбардируют поверхность пластины и слой за слоем выбивают атомы с поверхности, т. е. травят ее. напряжение в этом случае значительно меньше ускоряющих напряжений при ионной имплантации, поэтому внедрение ионов в пластину не происходит. Аналогичным способом достигается очистка поверхности от загрязнений – ионная очистка.
Преимуществом: отсутствие “подтравливания” под маску: стенки вытравленного рельефа практически вертикальны, а площади углублений равны площади окон в маске.
Общее преимущество ионного травления заключается в его универсальности (не тре-буется индивидуального подбора травителей для каждого материала), а недостаток – необходимость дорогостоящих установок и значительных затрат времени на создание в них нужного вакуума.
Литография – процесс формирования отверстий в масках, применяемых для локальной диффузии, травления, окисления и других операций. Виды:
Фотолитография основана на использовании светочувствительных материалов фото-резистов (ФР), которые могут быть позитивными и негативными. Негативные фоторезисты под действием света полимеризуются и становятся устойчивыми к травителям. В позитивных фоторезистах свет, наоборот, разрушает полимерные цепочки, поэтому засвеченные участки фоторезиста разрушаются травителем. При производстве П/П ИС слой фоторезиста наносят на поверхность двуокиси кремния, а при производстве гибридных ИС – на тонкий слой металла, нанесенный на подложку, или на тонкую металлическую пластину, выполняющую функции съемной маски. Необходимый рисунок элементов ИС получают путем облучения фоторезиста светом через фотошаблон (ФШ), представляющий собой стеклянную пластину, на одной из сторон которой имеется позитивный или негативный рисунок элементов ИС в масштабе 1:1 (рис. а). После облучения светом неполимеризованные участки фоторезиста удаляются травителем и на поверхности двуокиси кремния (или металлической пленки) образуется фоторезистивная маска (рис. б), через отверстия в которой осуществляется травление SiO2 (или металлической пленки), в результате рисунок фотошаблона оказывается перенесенным на поверхность подложки (рис. в). Созданию фотошаблонов предшествует топологическое проектирование микросхемы, результатом которого является получение в увеличенном масштабе (100:1; 200:1; 500:1 или 1000:1) послойных топологических чертежей – фотооригиналов, вычерчиваемых с помощью специальных устройств – координатографов, работающих в автоматическом режиме в соответствии с программой, задаваемой ЭВМ. Следующим этапом является фотографирование оригинала с уменьшением в 20-50 раз, затем второе фотографирование с уменьшением и мультиплицированием (размножением) рисунка. В итоге получают эталонный фотошаблон с матрицей одинаковых рисунков в мас-штабе 1:1. С эталонного шаблона методом контактной печати изготавливают рабочие фото-шаблоны.
Важным параметром фотолитографии является разрешающая способность, характери-зуемая максимальным числом раздельно воспроизводимых параллельных линий в маске в пределах 1 мм. На практике разрешающую способность определяют минимальной шириной линии Δ. Принципиальным физическим фактором, ограничивающим Δ, является дифракция света, не позволяющая получить Δ меньше длины волны (для видимого света λ ≈ 0,5 мкм). Практически методом фотолитографии можно получить Δ ≈ 1 мкм. Таким образом, мини-мальный размер элемента ИС не может быть меньше Δ.
Рентгеновская литография использует мягкое рентгеновское излучение с длиной вол-ны около 1 нм, что позволяет получить Δ ≈ 0,1 мкм. Фотошаблон в этом случае представляет собой тонкую мембрану (около 5 мкм), прозрачную для рентгеновских лучей, на которой ме-тодом электронно-лучевой литографии создан рисунок элементов ИС.
Электронно-лучевая литография использует облучение электронорезиста сфокусиро-ванным потоком электронов. Перемещаясь по поверхности пластины, включаясь и выключа-ясь по заданной программе, электронный луч создает необходимый рисунок элементов ИС. Минимальный размер элемента Δ ≈ 0,1-0,2 мкм. Он ограничен минимальным диаметром эле-ктронного луча. Этот вид литографии используется в основном для изготовления рентгено-шаблонов.
Ионно-лучевая литография использует облучение резиста пучком ионов. Чувствитель-ность резиста к ионному облучению во много раз выше, чем к электронному, что позволяет использовать пучки с малыми токами и малым диаметром (до 0,01 мкм). Система ионно-лу-чевой литографии технологически совместима с установками ионного легирования[1, 3].