Министерство общего и профессионального образования Ростовской области
ГОСУДАРСТВЕННОЕ БЮДЖЕТНОЕ ПРОФЕССИОНАЛЬНОЕ ОБРАЗОВАТЕЛЬНОЕ УЧРЕЖДЕНИЕ
РОСТОВСКОЙ ОБЛАСТИ
«ТАГАНРОГСКИЙ МЕХАНИЧЕСКИЙ КОЛЛЕДЖ»
Тема:
По дисциплине ОУДП.09 ФИЗИКА
MRAM – будущее памяти произвольного доступа
Автор: Бондаренко И.А.
Научный руководитель: Шипшина О.В.
Проект защищен на оценку___________ ______________2017 г.
Содержание
1. Введение……………………………………………………………………….....3
2. Сравнение с другими типами памяти……………………………………….…7
2.1. Плотность размещения элементов в микросхеме…………………………...7
2.2. Энергопотребление.…………………………………………………………...8
2.3. Быстродействие………………………….………………………………….....9
2.4 Общее сравнение………………………………………………………..……..10
3. История…………………………………………..………………………............11
4. Заключение……………………………………..………………………………..14
5. Библиографический список.…………..…………………………………..…....14
1. Введение
Некоторое время назад сложно было поверить, что огромная коллекция музыки может поместиться на одном небольшом устройстве, едва превышающем по размерам ладонь. То же относится к тысячам снимков в высоком разрешении и карманным фотокамерам. Всего за несколько десятилетий в области технологий хранения данных произошли разительные перемены, а появление Flash-памяти без преувеличения можно назвать революцией. Но время не стоит на месте, и следующей вехой в "потребительской" хронологии должны стать чипы, которые будут способны хранить сотни фильмов в HD-качестве либо всю мировую библиотеку книг. Чтобы воплотить эти мечты в реальность, по всему миру в лабораториях совершенствуют текущие и разрабатывают новые технологии, самые удачные из которых обязательно попадут на рынок - прогресс нельзя остановить.
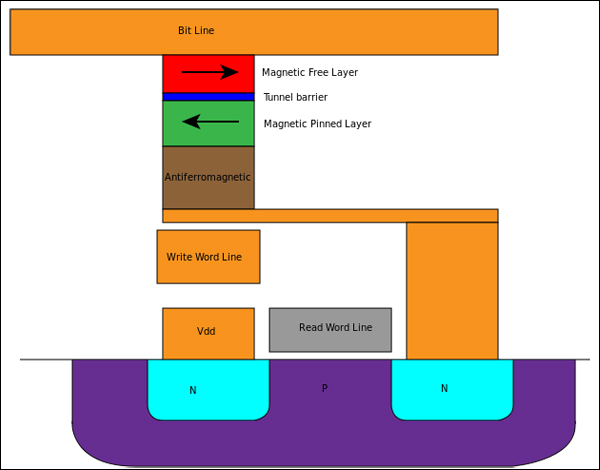
Рисунок 1- Структура MRAM памяти
Технологии устройств памяти следующего поколения будут использовать новые материалы, обладать временем доступа в единицы наносекунд и хранить информацию как минимум десятки лет без перезаписи. Сложно назвать чёткие сроки, когда же на полках магазинов появится "суперфлешка", но многомиллиардные доходы полупроводниковой индустрии не дают сомневаться, что для этого предпринимаются все возможные усилия, и на звание технологий следующего поколения уже есть претенденты.
MRAM (англ. magnetoresistive random-access memory - магниторезистивная оперативная память) - это запоминающее устройство c произвольным доступом, которое хранит информацию при помощи магнитных моментов, а не электрических зарядов. Важнейшее преимущество этого типа памяти - энергонезависимость, то есть способность сохранять записанную информацию при отсутствии внешнего питания.

Рисунок 2 -Упрощенная структура ячейки MRAM памяти
Технология магниторезистивной памяти разрабатывается с 1990-х годов. В сравнении с растущим объемом производства других типов компьютерной памяти, особенно флэш-памятью и памятью типа DRAM, она пока широко не представлена на рынке. Однако её сторонники верят, что благодаря ряду преимуществ, она в конечном счёте заменит все типы компьютерной памяти, и станет по-настоящему «универсальной» компьютерной памятью.
В отличие от других типов запоминающих устройств, информация в магниторезистивной памяти хранится не в виде электрических зарядов или токов, а в магнитных элементах памяти. Магнитные элементы сформированы из двух ферримагнитных слоёв, разделенных тонким слоем диэлектрика. Один из слоёв представляет собой постоянный магнит, намагниченный в определённом направлении, а намагниченность другого слоя изменяется под действием внешнего поля. Устройство памяти организовано по принципу сетки, состоящей из отдельных «ячеек», содержащих элемент памяти и транзистор.
Считывание информации осуществляется измерением электрического сопротивления ячейки. Отдельная ячейка (обычно) выбирается подачей питания на соответствующий ей транзистор, который подаёт ток от источника питания через ячейку памяти на общую землю микросхемы. Вследствие эффекта туннельного магнитосопротивления, электрическое сопротивление ячейки изменяется в зависимости от взаимной ориентации намагниченностей в слоях. По величине протекающего тока, можно определить сопротивление данной ячейки, и как следствие, полярность перезаписываемого слоя. Обычно одинаковая ориентация намагниченности в слоях элемента интерпретируется как «0», в то время как противоположное направление намагниченности слоёв, характеризующееся более высоким сопротивлением -- как «1».
Информацию можно записывать в ячейки, используя множество способов. В простейшем случае, каждая ячейка лежит между двумя линиями записи, размещёнными под прямым углом друг к другу, одна над, а другая под ячейкой. Когда ток проходит через них, в точке пересечения линий записи наводится магнитное поле, которое воздействует на перезаписываемый слой. Такой же способ записи использовался в памяти на магнитных сердечниках, которая использовалась в 1960-х годах. Этот способ требует достаточно большого тока, необходимого для создания поля, и это делает их не очень подходящими для применения в портативных устройствах для которых важна малое потребление энергии, это один из основных недостатков MRAM. Кроме того, с уменьшением размера микросхем, придёт время, когда индуцированное поле перекроет соседние ячейки на маленькой площади, что приведёт к возможным ошибкам записи. Из-за этого в памяти MRAM данного типа необходимо использовать ячейки достаточно большого размера. Одним из экспериментальных решений этой проблемы было использование круглых доменов, читаемых и записываемых с помощью эффекта гигантского магнитного сопротивления, но исследования в этом направлении более не проводятся.

Рисунок 3 – Структура ячейки TAS MRAM
Другой подход, переключения режимов, использует многошаговую запись с модифицированной многослойной ячейкой. Модифицированная ячейка содержит в себе искусственный антиферромагнетик, где магнитная ориентация чередуется назад и вперёд через поверхность, с обоими прикреплённым и свободным слоями, составленными из многослойных стеков изолированных тонким «соединяющим слоем». Результирующие слои имеют только два стабильных состояния, которые могут быть переключены из одного в другое выбором времени тока записи в двух линиях так одна немного задерживается, таким образом «поворачивая» поле. Любое напряжение меньшее, чем полный уровень записи фактически увеличивает его сопротивление для переключения. Это значит, что ячейки расположенные вдоль одной из линий записи не будут подвержены эффекту непреднамеренного перемагничивания, позволяя использовать меньшие размеры ячеек.

Рисунок 4 – Базовая перекрёстная архитектура модуля памяти
Новая технология, переноса спинового момента (spin-torque-transfer - STT) или переключение с помощью переноса спина, использует электроны с заданным состоянием спина («поляризованные»), прямо вращая области. Особенно, если электроны текут внутрь слоя, должно измениться их вращение, это способствует вращению и перенесению на ближайший слой. Это уменьшает величину тока, необходимую для записи информации в ячейку памяти, и потребление только при чтении и записи становится примерно одинаковым. Технология STT должна решить проблемы с которыми «классическая» технология MRAM будет сталкиваться при увеличении плотности размещения ячеек памяти и соответствующего увеличения тока необходимого для записи. Поэтому технология STT будет актуальна при использовании технологического процесса 65 нм и менее. Нижняя сторона такая: STT необходимо переключать больше тока через управляющий транзистор, чем обычной MRAM, требующей больший транзистор, и необходимо поддерживать когерентность вращения. В целом, несмотря на это, STT требует намного меньшего тока записи, чем обычная или переключательная MRAM.
Другими возможными путями развития технологии магниторезистивной памяти являются технология термического переключения (TAS - Thermal Assisted Switching) при которой во время процесса записи магнитный туннельный переход быстро нагревается (подобно PRAM) и в остальное время остается стабильным при более низкой температуре, а также технология вертикального транспорта (VMRAM - vertical transport MRAM) в которой ток проходящий через вертикальный столбцы меняет магнитную ориентацию, и такое геометрическое расположение ячеек памяти уменьшает проблему случайного перемагничивания и соответственно может увеличить возможную плотность размещения ячеек.
2. Сравнение с другими типами памяти
2.1. Плотность размещения элементов в микросхеме
Главным фактором, от которого зависит себестоимость производства микросхем памяти, это плотность размещения в ней отдельных ячеек. Чем меньше размер одной ячейки, тем большее их количество может быть размещено на одной микросхеме, и соответственно большее число микросхем может быть произведено за один раз из одной кремниевой пластины. Это улучшает выход годных изделий, и снижает стоимость производства микросхем.
В памяти типа DRAM в качестве элементов памяти используются конденсаторы, проводники переносят ток к ним и от них, и управляющий транзистор - так называемая ячейка «1T/1C».

Рисунок 5 - Сравнение с другими типами памяти
Конденсатор представляет собой две маленькие металлические пластинки, разделённые тонким слоем диэлектрика, он может быть изготовлен таким маленьким, как это позволяет сделать текущее развитие технологического процесса.
Память DRAM имеет наивысшую плотность ячеек из всех доступных на сегодняшний день типов памяти. Это делает её наиболее дешёвой, и она используется в качестве основной оперативной памяти компьютеров.
Своей конструкцией ячейка памяти MRAM похожа на ячейку DRAM, хотя иногда в ней не используется транзистор для записи информации. Однако как упоминалось выше, память MRAM испытывает проблему поле выбора, из-за которой размер ячейки при использовании обычной технологии MRAM ограничен размером 180 нм и более. Используя технологию MRAM с переключением режимов можно достичь гораздо меньшего размера ячейки до того как эффект поле выбора станет проблемой - по видимому около 90 нм. Большинство современных микросхем DRAM памяти имеют такой же размер ячейки.
Хотя это достаточно хорошие характеристики для внедрения в производство, есть перспективы в достижении магниторезистивной памятью размеров 65 нм, аналогично самым передовым устройствам памяти, для этого требуются использовать технологию STT.
2.2. Энергопотребление
Так как конденсаторы, используемые в микросхемах DRAM, со временем теряют свой заряд, микросхемы памяти, использующие их, должны периодически обновлять содержимое всех ячеек, считывая каждую ячейку и перезаписывая её содержимое. Это требует наличия постоянного источника питания, поэтому, как только питание компьютера отключается, память типа DRAM теряет всю хранящуюся информацию. Чем меньше становятся размеры ячейки памяти, тем чаще необходимы циклы обновления, и в связи с этим потребление энергии увеличивается.

Рисунок 6 – Структурная схема MC памяти DRAM
В отличие от DRAM, память MRAM не требует постоянного обновления. Это значит не только то, что память сохраняет записанную в нее информацию при отключенном питании, но и то что при отсутствии операций чтения или записи, энергия вообще не потребляется. Хотя теоретически при чтении информации память MRAM должна потреблять больше энергии, чем DRAM, на практике энергоёмкость чтения у них почти одинаковая. Тем не менее, процесс записи требует от трех до восьми раз больше энергии чем при чтении, эта энергия расходуется на изменение магнитного поля. Хотя точное количество сберегаемой энергии зависит от характера работы - более частая запись потребует больше энергии - в целом ожидается более низкое энергопотребление (до 99 % меньше) в сравнении с DRAM. При применении технологии STT MRAM потребление энергии при записи и чтении примерно одинаковое, и общее потребление энергии еще меньше.
Можно сравнить магниторезистивную память с еще одним конкурирующим типом памяти, с Flash-памятью. Как и магниторезистивная память, флэш-память является энергонезависимой, она не теряет информацию при отключении питания, что делает её очень удобной для замены жёстких дисков в портативных устройствах, таких как MP3-плееры или цифровые камеры. При чтении информации, флэш-память и MRAM имеют схожее энергопотреблении. Однако для записи информации в микросхемах флэш-памяти, необходим мощный импульс напряжения (около 10 В), который накапливается определенное время в накачке заряда, для этого требуется много энергии и времени. Кроме этого импульс тока физически разрушает ячейки памяти, и информация в флэш-память может быть записана ограниченное число раз, прежде чем ячейка памяти выйдет из строя.

Рисунок 7 – Принцип работы TAS MRAM
В отличие от Flash-памяти, микросхемам MRAM требуется энергии для записи ненамного больше, чем для чтения. Не надо увеличивать напряжение, не требуется накачка заряда. Это ведёт к более быстрым операциям, меньшему энергопотреблению, и к отсутствию ограниченного срока службы. Предполагается что, Flash-память будет первым типом микросхем памяти, который будет со временем заменён MRAM.
2.3. Быстродействие
Быстродействие памяти типа DRAM ограничено скоростью, с которой заряд, хранящийся в ячейках, может быть слит (для чтения) или накоплен (для записи). Работа MRAM основана на измерении напряжений, что предпочтительнее, чем работа с токами, так как требуется меньше времени на переходные процессы. Исследователи IBM продемонстрировали устройства MRAM с временем доступа порядка 2 нс, заметно лучше чем даже самые продвинутые DRAM построенные на самых новых технологических процессах. Преимущества по сравнению с Flash-памятью более значительные, время чтения у них похожее, но время записи в тысячи раз меньше.
Только одна современная технология памяти может конкурировать в быстродействии с магниторезистивной памятью. Это статическая память или SRAM. Ячейками SRAM памяти являются триггеры, которые хранят одно из двух состояний так долго, как долго поступает энергия. Каждый триггер состоит из нескольких транзисторов. Так как транзисторы имеют очень низкое потребление энергии, их время переключения очень мало. Но поскольку ячейка памяти SRAM состоит из нескольких транзисторов, обычно четырёх или шести, её площадь больше, чем у ячейки памяти типа DRAM. Это делает память SRAM более дорогой, поэтому она используется только в малых объемах, в качестве особо быстродействующей памяти, например как кэш-память и регистры в большинстве современных моделей центральных процессоров.
Хотя магниторезистивная память не такая быстрая, как память типа SRAM, она достаточно интересна и в этом качестве. Она обладает более высокой плотностью, и разработчики центральных процессоров могли бы в будущем выбирать для использования в качестве кэш-памяти между большим объемом менее быстрой памяти MRAM и меньшим объемом более быстрой памяти типа SRAM. Остаётся увидеть, как она продаётся, как сыграет в будущем.
2.4. Общее сравнение
Магниторезистивная память имеет быстродействие, сравнимое с памятью типа SRAM, такую же плотность ячеек, но меньшее энергопотребление, чем у памяти типа DRAM, она более быстрая и не страдает деградацией по прошествии времени в сравнении с Flash-памятью. Это та комбинация свойств, которая может сделать её «универсальной памятью», способной заменить SRAM, DRAM и EEPROM и Flash. Этим объясняется большое количество направленных на её разработку исследований.

Рисунок 8 – микросхема SRAM памяти
Конечно, на данный момент MRAM ещё не готова для широкого применения. Огромный спрос на рынке Flash-памяти вынуждает производителей к агрессивному внедрению новых технологических процессов. Самые последние фабрики, на которых например изготавливает микросхемы Flash-памяти ёмкостью 16 Гбайт фирма Samsung, используют 50 нм технологический процесс. На более старых технологических линиях изготавливаются микросхемы памяти DDR2 DRAM, для которых используется 90 нм технологический процесс предыдущего поколения.
Магниторезистивная память всё ещё в значительной степени находится «в разработке», и производится с помощью устарелых технологических процессов. Так как спрос на флэш-память в настоящее время превышает предложение, то еще не скоро появится компания, которая решится перевести одну из своих фабрик, с новейшим технологическим процессом на изготовление микросхем магниторезистивной памяти. Но и в этом случае, конструкция магниторезистивной памяти на сегодняшний момент проигрывает Flash-памяти по размерам ячейки, даже при использовании одинаковых технологических процессов.
3. История
1955 - изобретение памяти на магнитных сердечниках, использующей сходный с MRAM, способ чтения и записи информации.
1989 - учёные IBM сделали ряд ключевых открытий о «гигантском магниторезистивном эффекте» в тонкоплёночных структурах.
1995 - Motorola (в дальнейшем Freescale) начинает разработку MRAM.
2000 - IBM и Infeneon установили общую программу развития MRAM.
2002 - NVE объявляет о технологическом обмене с Cypress Semiconductor.
2003 - 128 кбит чип MRAM был представлен, изготовленный по 0,18 мкм технологии.
Июнь - Infineon анонсирует 16-Мбит опытный образец, основанный на 0,18 мкм технологии.
Сентябрь - MRAM становится стандартным продуктом в Freescale, которая начала испытывать MRAM.
Октябрь - Тайваньские разработчики MRAM печатают 1 Мбит элементы на TSMC.
Micron бросает MRAM, обдумывает другие памяти.
Декабрь - TSMC, NEC, Toshiba описывают новые ячейки MRAM.
Renesas Technology разрабатывают высокоскоростную, высоконадёжную технологию MRAM.
Январь - Cypress испытывает MRAM, использует NVE IP.
Март - Cypress продаёт дочернюю компанию MRAM.
Июнь - Honeywell сообщает таблицу данных для 1-Мбит радиационно-устойчивой MRAM, используя 0,15 микрометров технологию.
Август - рекорд MRAM: Ячейка памяти работает на 2 ГГц.

Рисунок 9 - Главное здание компании IBM
Ноябрь - Renesas Technology и Grandis сотрудничают в Разработке 65 нм MRAM, применяя вращательно-крутящее перемещение.
Декабрь - Sony представляет первую лабораторию производящую вращательно- -крутящееся-перемещение MRAM, которая использует вращательно-поляризованный ток через туннельный магниторезистивный слой, чтобы записать данные. Этот метод более энергоэффективен и более расширяем, чем обыкновенная MRAM. C дальнейшими преимуществами в материалах, этот процесс должен позволить плотности, большие, чем те, что возможны в DRAM.
Freescale Semiconductor Inc. анонсирует MRAM, в которой вместо оксида алюминия используется оксид магния, позволяющий делать более тонкий изолирующий туннельный барьер и улучшенное битовое сопротивление в течение цикла записи, таким образом, уменьшая требуемый ток записи.
Февраль - Toshiba и NEC анонсировали 16 Мбит чип MRAM с новой «энерго-разветвляющейся» конструкцией. Они добились частоты перемещения в 200 МБ/с, с временем цикла 34 нс -- лучшая производительность любого чипа MRAM. Они также гордятся наименьшим физическим размером в своём классе -- 78,5 квадратных миллиметров - и низким требованием энергии 1,8 вольт.
Июль - 10 Июля, Austin Texas -- Freescale Semiconductor выводит на рынок 4-Mbit чипы MRAM, по цене приблизительно $25.00 за микросхему.
Ноябрь - компания NEC разработала самую быструю в мире магниторезистивную SRAM-совместимую память, с рабочей частотой 250 МГц.
В японском искусственном спутнике SpriteSat, была применена магниторезистивная память производства Freescale Semiconductor для замены компонентов SRAM и FLASH.
Март - концерн Siemens выбрал в качестве энергонезависимой памяти для новых промышленных панелей оператора, микросхемы MRAM памяти емкостью 4 Mb, производства Everspin technologies.
Июнь -- Samsung и Hynix становятся партнерами по разработке STT-MRAM.
Freescale Semiconductor выделяет весь свой бизнес, связанный с магниторезистивной памятью, в отдельную компанию Everspin.
Февраль - компании NEC и NEC Electronics заявили об успешной демонстрации работающей памяти магниторезистивного типа емкостью 32 Мбит.
Апрель - компания Everspin представила первые в мире коммерчески доступные микросхемы MRAM ёмкостью 16 Mb.
Август - Samsung заявила о приобретении Grandis - поставщика запоминающих устройств на основе памяти STT-RAM.
4. Заключение
В своей работе я раскрыл данную тему. Познакомился с термином магниторезистивная оперативная память.
Познакомился с историей создания магниторезистивной оперативной памяти, а также узнал как оно работает в наше время.
5. Библиографический список
1. «Интернет» свободная энциклопедия Википедия
2. https://ru.wikipedia.org/wiki/
3. Национальный Исследовательский Ядерный Университет (МИФИ)
4. https://nano-e.ucoz.ru