Мы предложили, изготовили и изучили новый дизайн высокоскоростной оптической энергонезависимой памяти. В механизме записи предложенной памяти используется перемагничивание наномагнетика спин-поляризованным фототоком. Экспериментально было показано, что скорость работы этой памяти может быть чрезвычайно высокой выше 1 Тбит/с. Обсуждаются проблемы реализации как высокоскоростной записи, так и высокоскоростного чтения. Память компактна, интегрируема и совместима с существующей полупроводниковой технологией. Если это будет реализовано, это позволит повысить скорость обработки данных и вычислительных технологий.
Ключевые слова: высокоскоростная оптическая память; вращающий момент передачи; гибрид ферромагнетик-металл/полупроводник; наномагнетик; спин-поляризованный ток; высокоскоростной транспорт электронов
1. ВВЕДЕНИЕ
Обработка и передача данных требуют все более высокой скорости работы. Скорость передачи 25,4 ТБит/счерез одно оптическое волокно была продемонстрирована [1]. Однако из-за ограничения скорости существующих электронных компонентов данные передаются с использованием множества каналов на разных оптических частотах. Поскольку каждому каналу нужны отдельные электрические и электрооптические компоненты, такая система сложна, дорога и потребляет много энергии. Благодаря наличию сверхбыстрой оптической энергонезависимой памяти широкополосная оптическая связь может использоваться в более широком диапазоне приложений, и можно ожидать значительного снижения энергопотребления для обработки данных. Высокоскоростная обработка данных, оптические соединения между чипами и оптическая буферная память - вот некоторые из возможных применений высокоскоростной энергонезависимой оптической памяти.
Высокоскоростная энергонезависимая оптическая память является важным компонентом для достижения необходимой высокоскоростной обработки данных. Есть два основных применения этой памяти.
Первым важным применением высокоскоростной памяти является соединение между чипами [2,3]. Его целью является передача данных от одного кремниевого чипа к другому в кратчайшие сроки. В кремниевой электрической памяти, такой как динамическая память с произвольным доступом (DRAM), статическая память с произвольным доступом (SRAM), память с фазовым переходом (PRAM), флэш-память, резистивная память с произвольным доступом (ReRAM) [4] и магниторезистивная случайная память Доступ к памяти (MRAM) [5], является плотным, но электрическая память имеет относительно умеренную скорость работы. Умеренная скорость передачи данных внутри чипа приемлема и не ограничивает высокую скорость общей передачи данных внутри чипа. Это связано с тем, что внутри микросхемы имеется большое количество соединительных линий, и передача данных происходит параллельно. Даже если скорость передачи каждой линии умеренная, общая скорость передачи высокая. Случай межсоединения чип-чип отличается, потому что количество линий соединения между чипами ограничено. Важно передавать данные через каждую линию со значительно большей скоростью. Оптические соединения между чипами используются [2,3] для достижения высокоскоростной передачи данных. Высокоскоростная оптическая буферная память требуется для эффективного использования скоростных возможностей оптических каналов передачи данных. Цель буферной памяти состоит в том, чтобы согласовать параллельную передачу данных внутри микросхемы с последовательной передачей данных между микросхемами. Буферная память не должна быть плотной, но она должна быть очень быстрой.
Другим важным применением предлагаемой высокоскоростной оптической памяти является буферная память для оптического сетевого маршрутизатора. Стоит отметить, что, хотя высокоскоростные волоконно-оптические линии связи широко распространены во всем мире, используется только небольшая часть их высокоскоростной пропускной способности. В настоящее время скорость сети в основном ограничена скоростью сетевых маршрутизаторов. Сетевой маршрутизатор переключает потоки данных между различными узлами в сети. Функция сетевого маршрутизатора заключается в получении пакета данных из одного канала, его сохранении и отправке во второй канал. Поскольку доступность второго канала в основном неизвестна, в маршрутизаторе необходимо использовать энергонезависимую память. Маршрутизаторы из электрических компонентов устанавливаются в современных оптических сетях. Маршрутизаторы, которые могут обрабатывать данные со скоростью до 10 Гбит/с, уже имеются в продаже. В настоящее время прилагаются значительные усилия для изготовления маршрутизаторов, которые могут обрабатывать данные со скоростью 40 Гбит/с. Это сложная задача, потому что требуемая рабочая скорость значительно превышает ограничение скорости большинства электрических компонентов. Следовательно, дальнейшее возможное увеличение скорости работы маршрутизатора, который сделан из электрических компонентов, является сомнительным. Использование высокоскоростной энергонезависимой оптической памяти может быть единственным вариантом для увеличения скорости работы оптического маршрутизатора и, следовательно, для увеличения общей скорости Интернета [6].
Следует отметить, что рабочие функции высокоскоростной оптической памяти отличаются от рабочих функций обычной оперативной памяти. В оперативной памяти чтение и запись одного бита данных могут выполняться в любой ячейке памяти один раз за такт. Напротив, в высокоскоростной оптической памяти пакет импульсов данных считывается или записывается за такт. Импульсы данных в пакете должны быть как можно короче с минимально возможным интервалом между ними. Следует использовать импульсы с шириной и интервалом в несколько пикосекунд или короче. Интервал между событиями чтения и записи пакета больше. Это около нескольких наносекунд. В соответствии с этими функциональными особенностями процесс записи в высокоскоростной оптической памяти делится на два этапа с существенно различными рабочими скоростями (рисунок 1).

Первый шаг называется демультиплексированием. На этом этапе пакет импульсов данных перераспределяется в отдельные ячейки памяти, обеспечивая запоминание только одного импульса для каждой ячейки памяти. Поскольку импульсы данных в пакете очень близки друг к другу, для демультиплексирования требуется максимально возможная скорость работы. Как показано ниже, уникальные высокоскоростные свойства вращения позволяют успешно демультиплексировать для импульсов с периодом до 450 нс. Это соответствует рабочей скорости 2,5 Тбит/с. Второй этап записи - запоминание каждого импульса данных в каждой отдельной ячейке памяти. Этот шаг может занять больше времени. Время второго шага ограничено только интервалом между пакетами данных, который является относительно длительным. В предложенной памяти длительностью второго шага является время перемагничивания наномагнита. Это около 1 нс.
Следует отметить, что высокоскоростная энергонезависимая оптическая память коммерчески недоступна. Даже полная производительность памяти, включая высокоскоростное чтение, демультиплексирование и запись, еще не была продемонстрирована на одном устройстве. В настоящее время переключаемая линия задержки,используется в качестве оптической буферной памяти [6-8]. Очень короткое время хранения, составляющее несколько миллисекунд, является существенным ограничением этой памяти. Другим интересным дизайном высокоскоростной оптической памяти является оптическое ОЗУ [9,10]. Он объединяет высокоскоростной демультиплексор с обычной электрической памятью SRAM [9] или памятью с оптическим резонатором [10]. Принцип действия используемого высокоскоростного демультиплексора основан на насыщающем поглощении в низкотемпературных (LT-) InGaAs/AlGaAs квантовых ямах. Большой размер этой памяти и отсутствие интеграции делают возможность коммерциализации этой памяти сомнительной. Максимальная рабочая скорость демультиплексора на основе насыщаемого поглощения в LT-III-V ограничена временем восстановления поглощения, которое составляет около 20-100 пс. Это время соответствует скорости переключения 10-50 Гбит/с. Оптимизируя структуру абсорбера и используя спин-селективную накачку, была продемонстрирована скорость демультиплексора 1000 Гбит/с [11]. Тем не менее, такая работа за пределами физических ограничений может быть ненадежной, и более низкая скорость работы 40 Гбит/с [9,10] была сообщена только для памяти, в которой используется насыщаемый поглотитель.
Операционная скорость демультиплексора памяти, которая описана в этой статье, экспериментально проверена, чтобы связать 2200 Гбит/с. Скорость записи этой памяти ограничена только временем дефазировки электрона, которое по меньшей мере меньше 450 фс [12].
Эта статья не описывает производительность всех функций памяти, измеренных в одном устройстве памяти. Вместо этого в нем описаны требования, достижения, проблемы и особенности технологии изготовления для каждой конкретной функции предлагаемой высокоскоростной энергонезависимой оптической памяти. Каждая функция памяти была изучена в отдельно изготовленных устройствах.
В этой статье описаны два дизайна памяти. В первом проекте железный наномагнит используется в качестве элемента хранения. Во второй конструкции магнитный туннельный переход (MTJ) используется в качестве хранилища. Оба дизайна очень похожи. Однако у каждого дизайна есть свои преимущества и недостатки. Полная производительность предлагаемой памяти, включая демультиплексирование, высокоскоростное считывание, высокоскоростную спиновую инжекцию и перемагничивание, не была продемонстрирована ни в одном устройстве. Некоторые функции были продемонстрированы в конструкции с наномагнитом, некоторые функции были продемонстрированы в конструкции с MTJ, а некоторые функции еще предстоит продемонстрировать. Технологии изготовления памяти с наномагнитом и MTJ имеют свои особенности и проблемы. Поэтому каждая технология изготовления описывается отдельно.
2. Конструкция памяти, изготовление и принцип записи
Память состоит из микроразмерных ячеек памяти, встроенных в полупроводниковую пластину. Бит данных хранится в каждой ячейке. Каждая ячейка состоит из трех частей: оптического волновода, полупроводникового фотодетектора и наномагнита из ферромагнитного металла. В случае памяти с MTJ вместо одного слоя ферромагнитного металла используются два слоя, которые разделены туннельным барьером. На рисунке 2 показана ячейка памяти прототипа, изготовленного на подложке GaAs. Волновод AlGaAs прозрачен для света А = 800 нм.

Рисунок 2 –Ячейка памяти прототипа, изготовленная на подложке GaAs. Прозрачный волновод AlGaAs используется для доставки оптических импульсов в ячейку памяти
Он используется для доставки оптических импульсов в ячейку памяти. Поверх волновода AlGaAs изготовлен фотоприемник p-i-n-GaAs. Фотодетектор поглощает свет. На верхней части фотоприемника GaAs находится наномагнит Fe. Размер наномагнита достаточно мал, так что он является однодоменным состоянием и имеет два устойчивых направления намагниченности вдоль своей легкой оси. Данные хранятся в виде намагниченного направления в наномагнетике. Кроме того, наномагнит функционирует как верхний контакт для фотодетектора.
Волновод и фотодетектор выращивались методом молекулярно-лучевой эпитаксии (МЛЭ) на подложке из p-GaAs. После атомно-водородной очистки и удаления оксида плакирование Aio.sGao.sAs толщиной 3 мкм; слой и 3-метровый сердцевинный слой из Alo.5Gao.5As выращивались при Tsub = <550 ° C. И сердцевинный, и облицовочный слои волновода были слегка легированы р-образным слоем до примерно 7 × 1016 см-3. Фотодетектор p-i-n-GaAs выращивали при Tsub = 580 ° C и использовали постепенное легирование. Легирование составляет p = h x 1016 см-3 на границе раздела волновода, и оно постепенно уменьшается до 2 e 1C115 см c на протяжении 200 нм. Затем выращивали 5 (00 мкм) нелегированного GaAs, следуя 300 нм n-GaAs (n=3×1017 см-3). В верхней части детектора был выращен контактный слой, легированный дельтой.контактный слой должен создавать наименьший контактный коэффициент между детектором и наномагнитом. Контактный слой состоит из 25 нм nn-GaAs (3 x 1019 см-3) и 12 нм nn-In0.4Ga0.6As (7 x 1019 см). -3). InGaAs выращивали при Tsub = 540 ° C. Рост был 2D-типом. Утолщения InGaAs, концентрация In-ron и концентрация легирования не были оптимизированы, так что небольшое увеличение любого из параметров приводит к изменению z-роста по сравнению с 2D- в 3D-тип.
После выращивания фотодетектора образец был перенесен в камеру распыления без разрыва вакуума. 2 нм Fe и 4 нм защитного слоя Au наносили при tsub = -10 ° C. Нанома с эллипсом 100 × 80 нм была изготовлена с использованием; EB литография и Ar Millmg. «Магнит Fe был вытравлен в точности до поверхности полупроводника. Изоляционный слой S1O2 с длиной волны 65 нм в стороне от наномагнита был изготовлен методом отрыва 7. Nixt, детектор 4 | протравливали и подвергали сухому травлению волновод с глубиной 1,8 мкм (18 мкм). Омический контакт Ti / Pt / Au p-типа изготавливали из бактерии подложки. Образец расщепляли на куски длиной 3 мм.поперек волноводов. Между наномагнитом и задним контактом было приложено обратное напряжение смещения для фотодетектора. Свет от перестраиваемого Ti: сапфирового лазера был соединен в волокно, а от волокна - в волновод. И ТЕ-, и TM-поляризованные моды возбуждались с примерно одинаковой амплитудой. Волоконные пути TE- и TM-поляризованного света были разделены. Фазовый модулятор был установлен на волоконном тракте TM-поляризованного света. Он использовался для регулировки взаимной фазы между TM и TE-моды в волноводе для создания света с круговой поляризацией в точке, где он поглощается детектором.
Для записи данных направление намагниченности должно быть изменено оптическим импульсом. Циркулярно-поляризованный оптический импульс поглощается в полупроводниковом детекторе, создавая спин-поляризованные электроны. Под действием напряжения эти спин-поляризованные электроны вводятся из детектора в наномагнит. Крутящий момент переноса спина является следствием передачи углового момента вращения от спин-поляризованного тока магнитному моменту наномагнита. Если крутящий момент достаточен; намагниченность поворачивается и данные запоминаются. Из-за правила оптического выбора, спин-поляризованные электроны могут быть созданы только с помощью кругового поляризованного оптического импульса. «Линейный поляризованный свет возбуждает одинаковое количество электронов обоих спинов вверх и вниз; следовательно, нет спиновой поляризации neO, ток, вводимый в наномагнит, не подвергается спин-поляризации, и нет вращающего момента.
На рисунке 3 показана интеграция двух ячеек памяти и объясняется принцип высокоскоростной записи. Есть два входа волновода. Один вход для импульсов данных и один вход для тактового импульса. Тактовый импульс Tde используется для выбора записи одного импульса из последовательности импульсов данных. Воляризация данных и импульсов синхроимпульсов являются линейными и взаимно ортогональными. Оптические пути были разделены, поэтому каждая ячейка памяти освещается импульсом данных и тактовым импульсом. Длина волноводов регулируется таким образом, чтобы разность фаз между тактовыми импульсами и импульсами данных составляла лямбда / 4 в каждой ячейке памяти. В первой ячейке памяти тактовый импульс поступил одновременно с первым импульсом данных. Следовательно, эти два импульса объединяются в один импульс с круговой поляризацией. Поскольку только первое пуло циркулярно поляризовано, только этот импульс возбуждает спин-поляризованные электроны, заряжает намагниченность и запоминается. Все остальные импульсы данных линейно поляризованы. они не возбуждают спин-поляризованные электроны, и Чей хорошо влияет на намагниченность. Для второй ячейки памяти тактовый импульс слегка задерживается относительно отделяемых импульсов, и он приходит вместе со вторым вводом данных. Только второй импульс циклически поляризован и может быть запомнен ячейкой вторичной памяти. Следовательно, каждый импульс данных может быть запомнен отдельной ячейкой памяти. Чем ближе импульсы могут быть размещены относительно эфира, тем больше данных будет преобразовано через одну строку, и может быть достигнута быстрая скорость записи памяти. Минимальный интервал между пуизами, при котором импульс может быть записан без какого-либо влияния ближайшего импульса, определяет скорость записи в память.
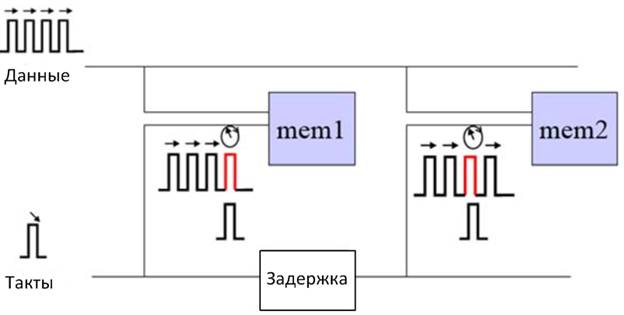
Быстрая скорость демультиплексирования предложенной памяти была экспериментально подтверждена [12]. Пакет из двух импульсов шириной 100 фс с периодом 450 фс был объединен с тактовым импульсом шириной 100 фс и сфокусирован в пленку GaAs. Спиновую поляризацию фотовозбужденных электронов измеряли по керровскому вращению зондирующего импульса. Тактовый импульс и импульсы пакета были линейно кросс-поляризованы. Задержка между тактовым импульсом и пакетом контролировалась. На рисунке 4 показана измеренная спиновая поляризация фотовозбужденных электронов как функция задержки тактового импульса относительно первого импульса пакета. Когда тактовый импульс был задержан так, чтобы он совпадал с первым импульсом пакета, первый импульс становится циркулярно-поляризованным. Только этот импульс возбуждает спин-поляризованные фотоэлектроны и обнаруживается только этот импульс. Второй импульс остается линейно поляризованным и не влияет на запись. Когда тактовый импульс задерживается для совпадения со вторым импульсом, записывается только второй импульс. Важным результатом рисунка 4 является то, что каждый отдельный импульс можно отделить от плотно упакованного пакета оптических импульсов с периодом всего -450 фс.

Рисунок 4 –Спин-поляризация электронов, возбуждаемых половым пучком импульсов и импульсами, как функция задержки импульса
Только выбранный импульс только влияет на спиновую поляризацию. Следующие или предшествующие невыбранные импульсные кубики не влияют на спиновую поляризацию. Когда часы находятся в положении этого первого импульса (0 пс), второй импульс не вызывает р-спин-полярризации. Следовательно, это не влияет на запись. Когда тактовый импульс имеет частоту 450 фс, записывается только второй импульс, но первый импульс не влияет на запись.
Например, в случае, когда задержка 450 фс использует схему пофиг.3, первый и второй импульсы пакета даты сохраняются в каждом элементе памяти отдельно. Намагниченность nTnomxgnet первой ячейки памяти изменяется на противоположную в зависимости от того, существует первый импульс или нет. Уклон или отсутствие второго португальца не влияет на наномагнит первого запоминающего устройства. Аналогично, перемагничивание нанометра второй ячейки молочной железы запускается только вторым импульсом. Наличие или отсутствие первого импульса не влияет на наномагнит второго блока памяти.
Не следует забывать, что причиной описанного высокоскоростного демультиплексирования является не возможность высокоскоростного переключения; поляризации церкулакса, благодаря очень короткому времени релаксации предложенного механизма демультиплексирования. Время релаксации описанного механизма переключения спинов - это время дефазировки электронов, которое очень мало. «Далее объясняется, почему время дефазировки электронов является временем связи описанного механизма демультиплексирования. Когда два линейных поляризованных импульса перекрываются, их объединенная поляризация представляет собой циркулярную поляризацию, и они возбуждают спин-поляризованные эледтроны. Когда импульсы шины разделяются, таким образом, они не перекрываются, т. е. нет циркулярной поляризации и спин-поляризованные электроны не должны возбуждаться. Это не правильно. Например, в эксперименте, показанном на рисунке 4, автокорреляционные измерения показали, что при задержке 225 фс между тактовым импульсом шириной 100 фс и импульсами пакета данных нет никакого перекрытия между любыми двумя импульсами. Это означает, что для этой задержки три линейно-поляризованных импульса без какой-либо компоненты круговой поляризации возбуждают фотоэлектроны.хотя круговой поляризации света нет, тем не менее, создается значительная спиновая поляризация фотоэлектронов (см. рисунок 4). Это можно объяснить следующим образом: Во время дефазировки электрона фотовозбужденные электроны когерентны, они сохраняют свою фазу и спин. Когда электроны возбуждаются двумя импульсами с интервалом, меньшим времени дефазировки электрона, фотовозбужденные электроны взаимодействуют когерентно и могут создавать спин-поляризацию [12]. Следовательно, после освещения первым линейно-поляризованным импульсом материал сохраняет информацию о фазе этого импульса в течение очень крошечного момента 450 фс. Если в течение этого времени второй импульс освещает материал, создается спиновая поляризация, поскольку информация о фазе первого импульса все еще сохраняется в материале. В случае, когда второе время наступило после времени, большего, чем время дефазировки электрона, информация о фазе первого импульса теряется, и спиновая поляризация не может быть создана. Это объясняет сверхбыструю скорость переключения предлагаемого механизма демультиплексирования.
3. Высокоскоростная инжекция фотовозбужденных электронов в наномагнит
Механизм перекодирования предлагаемой памяти состоит из двух этапов (рисунок 1). Как было показано выше, мы успешно проверили сверхвысокое демультиплексирование для предложенного метода записи. Вторым этапом регистрации является перемагничивание наномагнетика спин-поляризованными фотовозбужденными электронами. Этот шаг можно сделать с умеренной скоростью.
Время жизни спина в полупроводнике мало. Для GaAs он не превышает 100 пикосекунд при комнатной температуре. В конструкции предлагаемой памяти короткий оптический импульс возбуждает спин-поляризованные электроны в полупроводниковом фотодетекторе. Под приложенным напряжением фотовозбужденные электроны инжектируются в наномагнит. В случае, когда время инжекции больше, чем время жизни спина, информация о спине теряется внутри полупроводника перед его инжекцией в наномагнит.
Кроме того, при той же энергии оптического импульса амплитуда вводимого тока уменьшается в течение более длительного времени инжекции. Поскольку перемагничивание имеет порог по амплитуде вводимого тока, длительное время инжекции существенно ограничивает возможность перемагничивания светом. Время инжекции короче, чем 100 пикосекунд, является существенным для достижения перемагничивания светом как в отношении времени жизни спина электрона, так и амплитуды инжектируемого тока. Время впрыска должно быть как можно короче. По крайней мере, оно должно быть короче, чем время жизни спина в полупроводнике.
Чтобы проверить и оптимизировать инжекцию фотоэлектронов в наномагнит, мы изготовили упрощенную ячейку памяти по сравнению с рисунком 2. Мы удалили волновод и сделали р-контакт непосредственно в р-области. фотодетектора. За исключением этого упрощения, структура остается такой же, как на рисунке 2. В качестве источника света использовался лазер с фемтосекундным импульсом с шириной импульса 140 фс и частотой повторения импульсов 80 МГц. Лазерный луч фокусировался в пятно диаметром 4 мкм точно сверху наноконтакта (рис. 5б). Поскольку размер наномагнита и его соединительного электрода намного меньше лазерного пятна, фотодетектор поглощает почти весь свет. Временную характеристику p-i-n фотодетекторов измеряли с помощью пробоотборного осциллографа на нагрузочном резисторе 50-0hm, подключенном между наномагнитом и металлическим контактом к слою p-GaAs детектора. Мы обнаружили, что время инжекции сильно зависит от контактного сопротивления между наномагнитом и детектором. Для достижения приемлемо короткого времени впрыска требуется самое низкое контактное сопротивление. Для уменьшения контактного сопротивления мы использовали контактный слой InGaAs, легированный дельтой. Был использован тот же метод изготовления, который был описан в предыдущей главе. Изменяя концентрацию легирования слоя InGaAs, были изготовлены три образца с контактным сопротивлением 7000, 250 и 30 Ом/м2. Все контакты были омическими. На рисунке 5б показана временная эволюция фотовозбужденного тока. Для образца с контактным сопротивлением 30 Ом/м2 время инжекции составляло 80 пс, что меньше времени жизни спина в GaAs. На рисунке 5б это может быть связано; пришел к выводу, что самое низкое сопротивление контакта металл / полупроводник является критическим параметром для оценки этой меры. Оно должно быть ниже 100 Ом/1am2.

а) б)
Рисунок 5 –(а) Экспериментальная установка для измерения времени возбуждения фотоэлементов электронов от детектора наномагнитного резонанса и (б) время эволюции фототока с последующим возбуждением с помощью импульса длительностью 140 наносекунд для образцов с различным сопротивлением без контакта.
Есть еще одна причина, которая может ограничить кратчайшее время впрыска. Размер фотодетектора должен быть больше, чем длина проникновения света в GaAs, которая составляет около 1-2 мкм. Следовательно, длина фотодетектора должна быть не менее 3-4 мкм (рисунок 2). Фотоэлектрон, который находится на краю фотодетектора, должен пройти расстояние около 1-2 мкм, пока не достигнет наномагнетика. Это занимает время, которое может увеличить время впрыска. Чтобы убедиться в этом, мы выполнили эксперимент, показанный на рисунке6. Эффект эволюции фотовозбужденного тока измерен для двух случаев. Сначала измеряли луч света, сфокусированный точно в центре наномагнита, и измеряли время инжекции. Затем луч был перемещен на 6 дм из наномагнита, и время инжекции было измерено снова. Как видно из рисунка 6b, между временными откликами существует задержка в 80 пс.

а) б)
Рисунок 6 –(А) Экспериментальная установка для измерения скорости движения фото--возбуждают электроны при инжекции в наномагнетик; и (б) эволюция во времени фототока в тех случаях, когда луч фокусируется в центре наномагнита (светло-зеленая линия) и 6 мм в сторону (темно-зеленая линия)
Это означает, что фотовозбужденныеэлетроны движутся скорость 75 км/с = 6 м / 80 пс, что близко к скорости насыщения в GaAe. Скорость насыщения - самая быстрая скорость, с которой художественный электрон может двигаться в твердом теле. При более высокой скорости электрон испускает Интенсивно фононы, которые быстро подавляют его. Это имеет место в случае летящего плевания, когда речь идет об ультразвуковой речи.
Для конструкции на рисунке 2 электрон, который фотовозбужден на краю детектора, должен двигаться на 2 мкм, пока не достигнет наномагнита. В случае эффективно низкого значения hcnnad: сопротивление наномагнита составляет всего 26 пс. Это достаточно короткое время, чтобы гарантировать, что введенные фотовозбужденные электроны все еще остаются спин-поляризованными.
4. Механизм считывания
Магнитооптический эффект может быть использован в качестве механизма высокоскоростного считывания. Магнитооптическое считывание может быть достигнуто путем использования эффекта потерь, зависящих от намагниченности. Когда один слой оптического волновода представляет собой ферромагнитный металл и его намагниченность перпендикулярна направлению распространения моды, оптическое поглощение различно для двух противоположных направлений намагниченности [13-16]. Следовательно, такой волновод может функционировать в качестве оптического затвора, когда свет можно включать или выключать путем изменения намагниченности металла. Намагниченность ферромагнитного металла может быть обнаружена по интенсивности проходящего света. На рисунке7 показан свет пропускания в прозрачном волноводе AlGaAs со встроенным Fe-наномагнитом в зависимости от магнитного поля, приложенного перпендикулярно к волноводу.

а) б) в)
Рисунок 7 –Передача в поперечно-магнитном режиме (TM) для встроенного волновода с встроенныммикромагнитом для функции магнитного поля была применена перпендикулярно к волноводу и волноводной плоскости. Длина по наномагнетику (a) 64 м, (b) 8 м и (c) 4 м.
В случае длинного наномагнита отношение включения/выключения является высоким, а отношение сигнал/шум (SNR) низким.ё По мере уменьшения размера наномагнита отношение включения/выключения уменьшается, а ОСШ увеличивается. Трудно прочитать намагниченность наномагнита размером 1 мкм или меньше [17]. Следует отметить, что в волноводе существует только одна мода, и нет других мод, на которые можно было бы рассеять свет. Следовательно, дифракция отсутствует и дифракционный предел отсутствует. Тем не менее, неясно, почему соотношение вкл/выкл резко уменьшается, а ОСШ резко увеличивается, когда размер наномагнита приближается к длине волны света. Возможная причина может заключаться в том, что поверхностный плазмон возбуждается на поверхности ферромагнитного металла [18,19].
5. Память с MTJ электродом
В предыдущей главе обсуждалась конструкция высокоскоростной мемерии, которая сделана из синайного ферромагнитного металла (например, наномагнита в виде иконы). Существует еще один возможный дизайн памяти, где вместо наномагнита используется магнитный туннельный переход (MTJ). Есть достоинства и недостатки такого дизайна. Особенностью памяти с электродом MTJ является ее способность к электрическому и оптическому перекодированию и записи. Благодаря этому свойству, чтение / запись из / в память может осуществляться либо электрическим током, который заставляет pttsibSe обмен данными между памятью и другими электрическими компонентами внутри чипа, либо светом, который обеспечивает обмен данными с другими микросхемами., Следовательно, этот дизайн памяти вполне подходит для соединения чип-чип в качестве высокоскоростной буферной памяти.
Недостатком этой конструкции является то, что запись может осуществляться не только с помощью оптически импульса с круговой поляризацией, но также с помощью импульса с линейной поляризацией. Это затрудняет использование схемы высокоскоростного демультиплексирования, показанной на рисунке 3. В отличие от памяти с наномагнитом, в случае памяти с электродом MTJ существуют дополнительные ограничения по интенсивности импульсов и количеству импульсов в импульсный пакет, который может быть записан.
Направление намагничивания ферромагнитного металла может быть изменено с помощью спинового тока. Релаксация спинового тока в серромагнитном металле вызывает разрыв спирали [20], который может обратить намагниченность металла. Этот эффект используется в качестве метода записи в магнитных запоминающих устройствах с произвольным доступом (MRAM) [5]. В конструкции памяти с MTJ-электродом спиновый ток может генерироваться не только в полупроводниковом детекторе, но и в туннельном переходе. Только циркулярно-поляризованный свет фото-возбуждает спин-поляризованный ток в детекторе. Напротив, импульс любой поляризации может индуцировать спиновый ток и вращающий момент на туннельном барьере. Туннельный барьер сам по себе действует как спиновый поляризатор. Способность перемагничивания как спин-поляризованным, так и спин-неполяризованным фототоками имеет некоторые преимущества и недостатки для памяти с электродом MTJ, которые обсуждаются ниже.
На рисунке 8 показан пример памяти с электродом MTJ. Он состоит из GaAs p-i-n-диода с MTJ-электродом и бокового электрода в непосредственной близости от MTJ-электрода. MTJ состоит из двух ферромагнитных металлов, разделенных туннельным барьером MgO. «Свободный» слой MTJ находится в контакте с фотодиодом GaAs. Верхний слой MTJ - это слой «pin». Фотоиндуцированные электроны могут изменять намагниченность «свободного» слоя, но намагниченность «контактных» слоев должна оставаться неизменной. Направление намагничивания «свободного» и «штыревого» слоев может быть либо плоским, как показано на рисунке 8, либо перпендикулярным плоскости. Удельное сопротивление MTJ зависит от взаимной ориентации намагниченности «свободного» и «штыревого» слоев. «Свободный» слой имеет два противоположных устойчивых направления намагниченности. Данные хранятся в намагниченном направлении в «свободном» слое. Боковой контакт используется для электрической записи и чтения. Между «свободным» слоем MTJ и n-GaAs имеется слой дельта-легированногоnn-InGaAs (который не показан на рисунке 8). Как было объяснено ранее, слой nn-InGaAs используется для достижения наименьшего контактного сопротивления между слоями MTJ и n-GFAS. Дополнительное отличие конструкции рисунка 8 от рисунка 2 состоит в том, что детектор p-i-n встроен в волновод AlGaAs. AlGaAs протравливали до роста детектора.
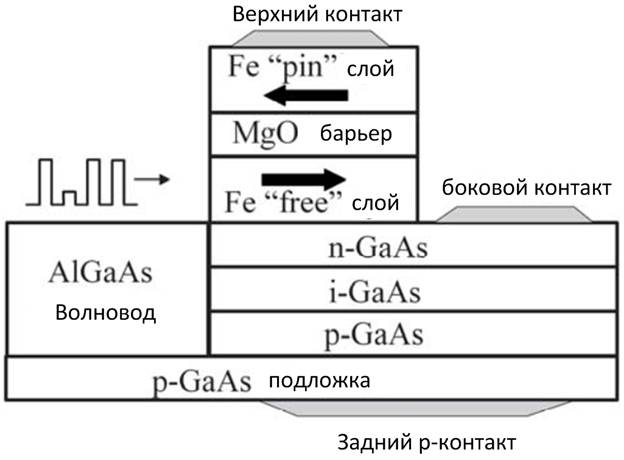
В памяти с электродом MTJ запись и считывание может осуществляться электрическим током. Методы записи и чтения аналогичны тем, которые в настоящее время используются в MRAM [5].
Для электрического считывания напряжение прикладывается между MTJ и боковым контактом. Удельное сопротивление MTJ различно для двух противоположных направлений намагничивания «свободного» слоя по отношению к направлению намагниченности «контактного» слоя. Сохраненные данные воспринимаются токами, протекающими через MTJ.
Для электрической записи между MTJ и боковым контактом подается большее напряжение. Ток заряда, который протекает через туннольный барьер, индуцирует спиновый ток. Релаксация спинового тока вызывает вращающий момент переноса спина [20]. Крутящий момент переноса спина является следствием передачи углового момента вращения от спинового тока. Если ток достаточен, намагниченность «свободного» слоя изменяется на крутящий момент переноса вращения, и данные запоминаются. Изменяя полярность приложенного напряжения, намагниченность «свободного» слоя может быть повернута либо параллельно, либо противоположно намагниченности «контактного» слоя.
Метод оптического считывания для этой памяти основан на управлении оптическим усилением p-i-n-перехода с помощью MTJ-электрода. GaAs-переход p-i-n поглощает свет, когда в p-i-n-переход не подается ток. Когда под прямым смещением вводится ток, поглощение может быть компенсировано и свет может усиливаться из-за стимулированного излучения. Напряжение смещения прикладывается между задним электродом и верхней частью MTJ. Поскольку разное сопротивление MTJ, ток, вводимый в p-i-n-GaAs, различен для противоположных направлений намагничивания «контактного» слоя. Напряжение смещения должно быть оптимизировано таким образом, чтобы для параллельных направлений намагничивания электродов MTJ ток инжекции был достаточным для получения оптического усиления в контактном контакте, а для противоположных направлений намагничивания ток инжекции не должен быть достаточным для создания какого-либо усиление. Следовательно, прямое смещение p-i-n-соединения с MTJ работает как оптический переключатель. Когда намагниченность «свободного» слоя параллельна намагничиванию «контактного» слоя, световой импульс может проходить через переход. Когда намагниченность «свободного» слоя меняется на противоположную, импульс света блокируется.
На рисунке 9 показана IV-характеристика p-i-n-перехода с MTJ-электродом, в котором намагниченность «свободного» слоя параллельна или противоположна намагниченности «контактного» слоя. Данные были рассчитаны на основе измеренных IV характеристик изготовленного наноразмерного MTJ-контакта и микроразмерного p-i-n