Создание щелевой изоляции
2.1) фотолитография «STI»
2.2) анизотропное травление кремния на глубину залегания кармана (3-4 мкм)
2.3) удаление фоторезиста
2.4)фотолитография "n+-охрана под STI"
2.5)имплантация: B, E=80 кэВ, D=1013 см-2.
2.6)удаление фоторезиста.
2.7)отжиг p-охраны: 1000 °С, 65 мин, нейтральная среда – N2.
2.8) заполнение щели с использованием SiO2
Создание р-кармана
3.1)фотолитография «n-карман»
3.2)имплантация: B, Е=80 кэВ, D=5*1012 см-2
3.3)удаление фоторезиста
3.4)отжиг
- диффузия: 1200 оС, 30 мин, окисляющая среда – О2
- диффузия: 1100 оС, 40 мин, нейтральная среда – N2
- удаление всего SiO2 до Si
Увеличение напряжения смыкания канала
- фотолитография «увеличение напряжения смыкания »
- имплантация: Р, Е=400кэВ, D=5*1013
- удаление фоторезиста
Корректировка порогового напряжения
5.1) корректировка Uпор n
- фотолитография «Корректировка порогового напряжения n-МОП-транзистора»
- имплантация: B, Е=30 кэВ, D=2.85*1012 см-2
- удаление фоторезиста
5.2) корректировка Uпор р
- фотолитография «Корректировка порогового напряжения р-МОП-транзистора»
- имплантация: Р, Е=30 кэВ, D=8.55*1011 см-2
-удаление фоторезиста
6. Создание подзатворного SiO2 толщиной 16 нм: 900 оС, 46 мин, среда O2
Создание затворов
7.1) Создание n+-Si*-затвора:
- нанесение n+-поликремния: толщина 0.5 мкм, элемент Р,
концентрация 1020 см-3
- фотолитография "Затворы"
- анизотропное травление поликремния на всю толщину до оксида
- удаление фоторезиста
8. Создание n- LDD областей:
8.1) фотолитография "n-LDD"
8.2) имплантация: As, E=90 кэВ, D=3*1013 см-2
8.3)удаление фоторезиста
9. Создание спейсеров:
- нанесение оксида толщиной 0.25 мкм
- анизотропное травление оксида на 0.25 мкм
- окисление: 850 оС, 20 мин, O2
10.Создание n+- и p+- истоков и стоков транзисторов
10.1)фотолитография "n+-сток, исток, контакт к n-карману"
10.2) имплантация: As, E=135 кэВ, D=5*1015 см-2
10.3) удаление фоторезиста
10.4)фотолитография "p+-сток, исток, контакт к p-карману(подложке)"
10.5)имплантация: B, E=5 кэВ, D=7.5*1014 см-2
10.6)удаление фоторезиста
10.7) отжиг: 900 оС, 9 мин, O2
11. Осаждение изолирующего слоя и его планаризация
Создание контактных окон в изолирующем слое
- фотолитография "Контактные окна"
- анизотропное травление оксида до Si и Si*
- удаление фоторезиста
Создание металлической разводки
- нанесение алюминия
- фотолитография "Контакты:
- анизотропное травление алюминия на всю его толщину
- удаление фоторезиста
Нанесение защитного изолирующего слоя
Маршрутная карта или схема, изображенная в виде последовательных модификаций поперечного сечения КМОП-структуры на этапах изготовления согласно приведенному выше технологическому маршруту, показана на рис.34-40.
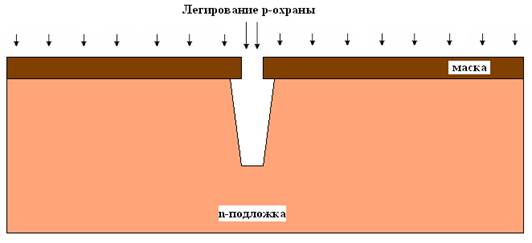
Рисунок 34 − Пункты 1, 2.1-2.5 полного технологического маршрута
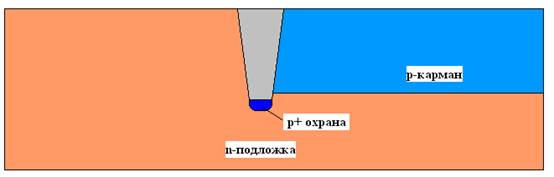
Рисунок 35 − Пункты 2.6 - 2.8, 3 полного технологического маршрута
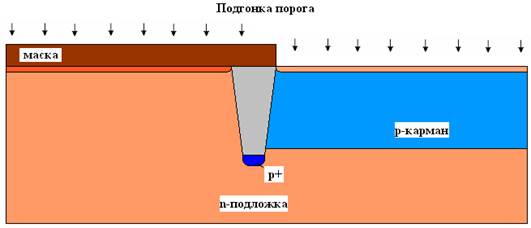
Рисунок 36 − Пункты 4, 5 полного технологического маршрута
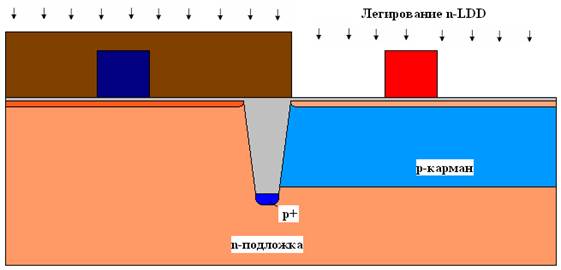
Рисунок 37 − Пункты 6, 7, 8.1,8.2 полного технологического маршрута
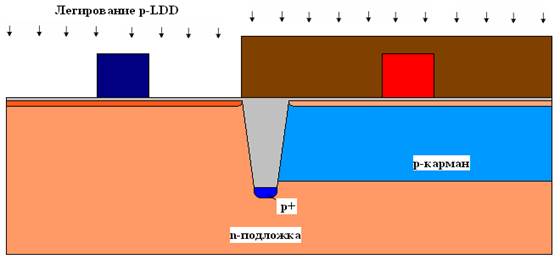
Рисунок 38 − Пункты 8.3 – 8.5 полного технологического маршрута
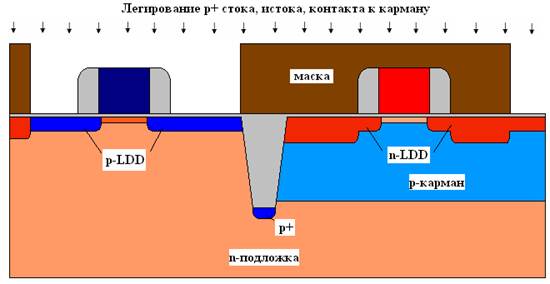
Рисунок 39 − Пункты 8.6, 9, 10.1 – 10.5 полного технологического маршрута
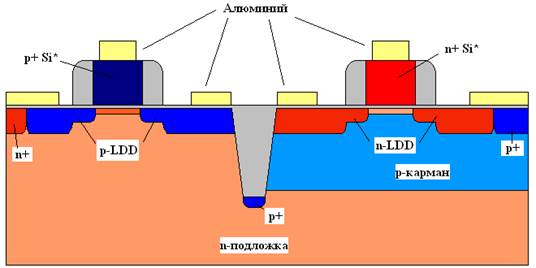
Рисунок 40 − Пункты 10.6 – 10.7, 11, 12, 13 полного технологического маршрута
Первый транзистор.
Пороговое напряжение складывается из трех слагаемых – падениях
напряжений на трех слоях:
 (1)
(1)
Первое слагаемое определяет вклад материала затвора подложки и вычисляется как разность отрезков  и
и  :
:
 (2)
(2)
Как видно из рис.4 для зонной диаграммы n- канального транзистора  вычисляется как:
вычисляется как:
 (3)
(3)
Для сильнолегированного  - затвора
- затвора  типа уровень Ферми практически совпадает с границей запрещенной зоны
типа уровень Ферми практически совпадает с границей запрещенной зоны  и можно считать, что
и можно считать, что  равен половине ширины запрещенной зоны:
равен половине ширины запрещенной зоны:  .
.
Встроенный потенциал подложки n- и p-канального транзистора для кремния при T=300 К зависит от концентрации примеси в подложке  и вычисляется как:
и вычисляется как:
 (4)
(4)

Второе слагаемое описывает падение напряжения на оксидном слое:
 ; (5)
; (5)
 (6)
(6)
 (7)
(7)
 («+» для p-канала, «-» для n- канала)
(«+» для p-канала, «-» для n- канала)
 ; (8)
; (8)
 ; (9)
; (9)
Падение порогового напряжения на оксиде для n- канального транзистора:

Определив все три составляющие порогового напряжения для n-и p- транзисторов получим:

Второй транзистор
Пороговое напряжение складывается из трех слагаемых – падениях
напряжений на трех слоях:
 (1)
(1)
Первое слагаемое определяет вклад материала затвора подложки и вычисляется как разность отрезков  и
и  :
:
 (2)
(2)
Как видно из рис.4 для зонной диаграммы n- канального транзистора  вычисляется как:
вычисляется как:
 (3)
(3)
Для сильнолегированного  - затвора
- затвора  типа уровень Ферми практически совпадает с границей запрещенной зоны
типа уровень Ферми практически совпадает с границей запрещенной зоны  и можно считать, что
и можно считать, что  равен половине ширины запрещенной зоны:
равен половине ширины запрещенной зоны:  .
.
Встроенный потенциал подложки n- и p-канального транзистора для кремния при T=300 К зависит от концентрации примеси в подложке  и вычисляется как:
и вычисляется как:
 (4)
(4)

Второе слагаемое описывает падение напряжения на оксидном слое:
 ; (5)
; (5)
 (6)
(6)
 (7)
(7)
 («+» для p-канала, «-» для n- канала)
(«+» для p-канала, «-» для n- канала)
 ; (8)
; (8)
 ; (9)
; (9)
Падение порогового напряжения на оксиде для n- канального транзистора:

Определив все три составляющие порогового напряжения для n-и p- транзисторов получим:
