Электронно-дырочный переход
Электрические переходы
Работа большинства полупроводниковых приборов основана на использовании электрического перехода. Электрический переход в полупроводнике – это граничный слой между двумя областями, физические характеристики которых существенно различаются.
Переходы между двумя областями полупроводника с различным типом электропроводности называют электронно-дырочными или p-n -переходами. Бывают симметричные и несимметричные p-n -переходы. В симметричных переходах концентрация электронов в полупроводнике n- типа nn и концентрация дырок в проводнике p -типа рp равны, т.е. nn = рp. Другими словами, концентрация основных носителей зарядов по обе стороны симметричного p-n -перехода равны. На практике используются, как правило, несимметричные переходы, в которых концентрация, например, электронов в полупроводнике n -типа больше концентрации дырок в полупроводнике p -типа, т.е. nn > рp, при этом различие в концентрациях может составлять 100 – 1000 раз. Низкоомная область, сильно легированная примесями (например, n- область в случае перехода nn > pp), называется эмиттером; высокоомная, слаболегированная (p -область в случае перехода nn > pp), – базой. Для случая, когда концентрация дырок в полупроводнике p -типа больше концентрации электронов в полупроводнике n -типа, т.е. pp > nn, эмиттером будет p -область, а базой n -область.
В зависимости от характера распределения примесей, обеспечивающих требуемый тип электропроводности в областях, различают два типа переходов: резкий (ступенчатый) и плавный (линейный). В резком переходе концентрация примесей на границе раздела областей изменится на расстоянии, соизмеримом с диффузионной длиной, в плавном – на расстоянии, значительно большей диффузионной длины. Лучшими выпрямительными (вентильными) свойствами обладают резкие p-n -переходы, которые и используют для получения диодов и транзисторов. Резкий p-n -переход соответствует сплавным переходам, плавный распространяется на переходы, полученные методом диффузии или методом выращивания из расплава.
В зависимости от площади p-n -переходы разделяются на точечные и плоскостные. Плоскостные переходы в зависимости от метода их изготовления бывают сплавными, диффузионными, эпитаксиальными и т.п.
Переходы между двумя областями с одним типом электропроводности (n - или p -типом), отличающиеся концентрацией примесей и соответственно значением удельной проводимости, называют изотипными переходами: электронно - электронными (n+-n -переход) или дырочно - дырочными (p+-p -переход). Термином n+ - обозначают область с концентрацией электронов, большей n концентрации, а p+ - – область с концентрацией дырок, большей p; следовательно, слои n+ -, p+ - имеют меньшее удельное сопротивление, поэтому большую удельную проводимость.
Переходы между двумя полупроводниковыми материалами, имеющими различную ширину зоны, называют гетеропереходами. Если одна из областей, образующих переход, является металлом, то такие переходы называют переходом металл - полупроводник, которые могут обладать вентильными свойствами или омическими.
4.2. Образование и свойства p-n -перехода
Электронно-дырочный переход (сокращенно p-n -переход) является основным элементом полупроводниковых диодов, транзисторов и интегральных схем. Он находится на границе между двумя областями полупроводника, одна из которых имеет электронную (n), а другая – дырочную (p) электрические проводимости, т.е. соответственно n -или p -области. Однако его нельзя создать простым соприкосновением полупроводниковых пластин n -или p -типов, так как при этом неизбежен промежуточный слой воздуха, окислов или поверхностных загрязнений. Переход создается в кристалле полупроводника с помощью технологических процессов (например, сплавления, диффузии), в результате которых граница раздела между областями p - и n -типов находится внутри полупроводникового монокристалла.
На рис. 4.1 условно показан кристалл, одна часть объема которого имеет дырочную электропроводность, а другая – электронную.
До установления термодинамического равновесия между p - и n -областями и в отсутствие внешнего электрического поля в таком переходе протекают следующие физические процессы. Поскольку концентрация дырок в p -области гораздо выше их концентрации в n -области, то дырки из p -области диффундируют в n -область.
Однако, как только дырки попадают в n -область, они начинают рекомбинировать с электронами, основными носителями зарядов в n -области, и их концентрация по мере углубления быстро убывает. Аналогично электроны из n -области диффундируют в p -область. Таким образом, в p-n -переходе возникает ток диффузии
Iдиф = Iр диф + In диф,
направление которого совпадает с направлением диффузии дырок. Если бы дырки и электроны являлись нейтральными частицами, то их взаимная диффузия привела бы к полному выравниванию концентрации дырок и электронов по всему объему кристалла, и p-n -переход, как таковой, отсутствовал бы.
Встречная диффузия подвижных носителей заряда приводит к появлению в n -области нескомпенсированных положительных зарядов ионов донорной примеси, а в p -области - отрицательных зарядов ионов акцепторной примеси, связанных с кристаллической решеткой полупроводника (рис. 4.1, б).

|
Рис. 4.1. Идеальный плоскостной p-n -переход:
а – отдельные p - и n -полупроводники;
б – схематическое изображение идеального плоскостного p-n -перехода;
в – распределение плотности объемных зарядов;
г – распределение потенциала;
  д – распределение электронов проводимости и дырок;
+, – – ионы; «+», «–» – дырки и электроны д – распределение электронов проводимости и дырок;
+, – – ионы; «+», «–» – дырки и электроны
|
Распределение объемной плотности указанных зарядов rоб показано на рис. 4.1, в. Таким образом, на границе областей образуются два слоя равных, но противоположных по знаку зарядов. Образовавшаяся область пространственных зарядов (ОПЗ) и представляет собой p-n -переход. Его ширина обычно равна dp-n = 10–3 – 10–4 мм. Объемные (пространственные) заряды в переходе образуют электрическое поле, направленное от положительно заряженных доноров к отрицательно заряженным акцепторам, т.е. от n -области к p -области. Между p - и n -областями устанавливается разность потенциалов Uк, зависящая от материала и уровня легирования. Например, Uк для германиевых p-n -переходов составляет 0,3 ÷ 0,4 В, а для кремниевых 0,7 ÷ 0,8 В.
Так как электрическое поле неподвижных зарядов p-n -перехода при термодинамическом равновесном состоянии препятствует диффузии основных носителей заряда в соседнюю область, то считают, что между p - и n -областями устанавливается потенциальный барьер φо, распределение потенциала которого вдоль структуры p-n -перехода показано на рис. 4.1, г.
Высоту потенциального барьера φо (т.е. контактную разность потенциалов Uк) можно определить, используя разность работ выхода ep и en соответственно для полупроводников p - и n -типа.
 ,
,
где q – элементарный заряд.
Образовавшийся потенциальный барьер высотой φо препятствует движению основных носителей заряда через него. Но в полупроводнике определенного типа наряду с основными носителями всегда имеются неосновные носители (например, для полупроводника p -типа неосновными носителями будут электроны). Электрическое поле напряженностью Ео = φо / dp-n, во-первых, выталкивает из перехода подвижные носители заряда в «свою область», т.е. электроны в n -область, дырки в p -область; во-вторых, способствует переходу неосновных носителей из толщи полупроводника в соседнюю область (электронов из p -области в n -область, дырок из n -области в p -область), т.е. является ускоряющим для неосновных носителей заряда. В поле напряженностью Ео происходит дрейф неосновных носителей, т.е. возникают дрейфовые токи электронов и дырок.
Ток, создаваемый неосновными носителями, называется тепловым, или дрейфовым. Он состоит, как и диффузионный ток, из двух составляющих: электронной I 0 n и дырочной I 0 p.
 .
.
Тепловой ток не зависит от величины напряжения на p-n -переходе, т.е. является током насыщения неосновных носителей, и имеет малую величину. По своему направлению тепловой ток противоположен току диффузии, поэтому общий ток p - n -перехода равен Ip-n = Iдиф – I 0, считая положительным (прямым) направлением тока направление диффузионного тока.
При разомкнутом (или замкнутом) p-n -переходе в условиях термодинамического равновесия и в отсутствие внешнего поля полный ток через электронно-дырочный переход равен нулю
 ,
,
т.е. ток диффузии становится равным по абсолютному значению тепловому току: Iдиф = I 0.
Основные носители заряда при встречной диффузии рекомбинируют в приконтактных областях p-n -перехода, что приводит к образованию в этом месте обедненного подвижными носителями заряда слоя, который обладает малой удельной проводимостью (как беспримесный или собственный полупроводник) и поэтому называется обедненным или запирающим слоем х3 (рис. 4.1, д).
Например, если в создаваемых p-n -переход участках кремния концентрация основных носителей nnо и ppо составляет 1016 см–3, а неосновных pnо и npо – порядка 1010 см–3, то в плоскости контакта концентрация основных носителей nnо и ppо снижается до ni = pi = 1013 см–3, т.е. оказывается на три порядка ниже, чем вдали от перехода.
Ширину p-n -перехода можно определить из выражения
 ,
,
где e0 – диэлектрическая постоянная воздуха; e – относительная диэлектрическая проницаемость полупроводника; ND ≈ n, NA ≈ p – концентрация донорной и акцепторной примесей соответственно; е – заряд электрона.
Обычно концентрация примесей в одной области перехода в 100 – 1000 раз больше, чем в другой (несимметричный p-n -переход). В этом случае ширина части перехода, расположенная в области с малой концентрацией примеси, оказывается в 100 – 1000 раз больше ширины той части перехода, которая расположена в области с большей концентрацией примеси. Тогда выражение для несимметричной структуры перехода, например, когда NA >> ND, упрощается
 .
.
Взаимная рекомбинация подвижных носителей заряда в p-n -переходе происходит с такой скоростью, что в любой точке по объему p-n -перехода будет соблюдаться примерное равенство: pn ≈ ni2. Такое состояние полупроводника называют равновесным. Ранее было сказано, что при равновесном состоянии полный ток через p-n -переход равен нулю.
4.3. Прямое включение p-n -перехода
Неравновесным состоянием p-n -перехода называют состояние, когда токи диффузии и дрейфа через переход неуравновешенны. Оно возникает, если к переходу приложить внешнее напряжение, которое понизит или повысит потенциальный барьер по сравнению с его величиной φ0 в равновесном состоянии.

|
| Рис. 4.2. Прямое включение p-n- перехода |
Если к p-n -переходу приложить внешнее поле, то равновесное состояние нарушится. Считается, что p-n -переход включен в прямом направлении, когда внешнее напряжение U приложено плюсом к p -области, а минусом к n -области. Напряжение U почти полностью будет падать на p-n -переходе, сопротивление которого во много раз выше сопротивлений областей полупроводников p - и n -типа. В переходе появится дополнительное внешнее электрическое поле Е, не совпадающее с направлением поля Е 0 перехода, что приведет к уменьшению суммарной напряженности электрического поля перехода, а это в свою очередь вызовет уменьшение ширины запирающего слоя d’p-n, т.е. d’p-n < dp-n, где dp-n – ширина p-n -перехода в равновесном состоянии, и высоты потенциального барьера:
U’ = Uк – U. Уменьшение высоты потенциального барьера вызывает рост диффузионных токов основных носителей и некоторое снижение дрейфовых (тепловых) токов неосновных носителей (рис. 4.2).
Зависимость тока диффузии от прямого напряжения имеет экcпоненциальный характер
 ;
;
 ,
,
где Inо, Ipо – диффузионный ток электронов из n -области и дырок из p -области при U = 0. При комнатной температуре (e / kT) = 39 (1/В), поэтому экспоненциальная зависимость очень сильная. Тогда общий ток диффузии будет равен
 ,
,
где Iдиф о = Inо + Iро.
Так как только внутреннее электрическое поле перехода способствует перемещению неосновных носителей заряда в соседнюю область, то тепловой ток, образуемый этими носителями, не зависит от напряжения, приложенного к p-n -переходу.
Полный ток через p-n -переход, называемый прямым током, равен разности диффузионного и теплового токов, так как они имеют противоположные направления
 .
.
Так как Iдиф = Iо при U = 0, поэтому
 ,
,
где Iо – тепловой ток.
Физический процесс введения носителей заряда через p-n -переход в область, где они являются неосновными носителями, за счет снижения потенциального барьера, называется инжекцией. Неосновные носители заряда инжектируются в основном из высоколегированного (низкоомного) слоя в низколегированный (высокоомный).
Инжектирующий слой с относительно малым удельным сопротивлением называют эмиттером, а слой, в который инжектируются неосновные для него носители – базой.
4.4. Обратное включение p-n- перехода
Считается, что p-n -переход включен в обратном направлении, когда внешнее напряжение U приложено плюсом к n -области, минусом к p -области. При этом электрическое поле, создаваемое внешним источником, совпадает с внутренним полем p-n -перехода. В этом случае поля складываются и потенциальный барьер между p - и n -областями возрастает. Теперь он становится равным U’ = Uк + U (рис. 4.3.)
Движение основных носителей через p-n -переход уменьшится за счет их оттягивания от приконтактных слоев вглубь полупроводника, и при некотором значении U совсем прекратится. Ширина p-n -перехода станет больше, т.е.  . Такое воздействие на p-n -переход называется обратным смещением.
. Такое воздействие на p-n -переход называется обратным смещением.
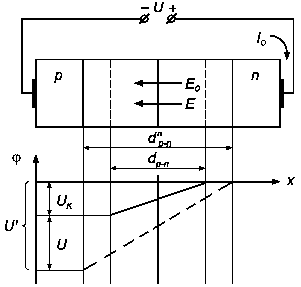
|
| Рис. 4.3. Обратное включение p-n- перехода |
При обратном смещении по мере его увеличения остается все меньше подвижных носителей, способных преодолеть возросший потенциальный барьер, поэтому диффузный ток как электронов и дырок, так и полный ток через переход стремится к нулю, что описывается экспоненциальной зависимостью
 .
.
При этом ток будет обусловлен в основном движением неосновных носителей, которые, попав в поле перехода, будут им захватываться и переноситься через p-n- переход.
Полный ток через p-n- переход при обратном включении будет равен
 .
.
Таким образом, и в этом случае тепловой ток, вызванный движением неосновных носителей заряда, остается постоянным, а диффузный ток основных носителей уменьшается по экспоненциальному закону.
В общем случае, т.е. при любом включении p-n- перехода, полный ток равен выражению
 , (4.1)
, (4.1)
где внешнее напряжение U берется со знаком «плюс» при прямом включении и со знаком «минус» при обратном включении.
Это уравнение идеализированного p-n- перехода, на основе которого определяются вольтамперные характеристики полупроводниковых приборов.
Ток тепловой Iо называют обратным током смещения или просто обратным током. Величина тока Iо, обусловленная дрейфом неосновных носителей через переход, определяется площадью перехода S, степенью легирования материала (npо и pnо) и параметрами полупроводника (D и L)

или с учетом того, что t = L2/D,
 .
.
При определенной температуре ток Iо – величина постоянная, зависящая только от концентрации неосновных носителей npо и pnо.
4.5. Вольт-амперная характеристика p-n- перехода
Зависимость тока через p-n- переход от приложенного напряжения I = f(U), соответствующая формуле (4.1), есть теоретическая вольт-амперная характеристика (ВАХ) p-n- перехода (рис. 4.4).
При подаче на p-n- переход обратного напряжения ток I быстро достигает значения, равного Iо, и затем при повышении обратного напряжения остается практически постоянным. Например, при U < 0 ток I = – Iо, если (|U|e/kT) << 1, т.е. если | U | > (3 ¸ 4) kT/e. При нормальной температуре kT/e » 0,025 B, поэтому это условие выполняется уже при | U | > 0,1 B.
Так как неосновных носителей в областях p и n мало, то при обратном включении ток I, обусловленный только неосновными носителями, мал.
При подаче на p-n- переход прямого напряжения ток I с увеличением U возрастает по экспоненте и уже при U > 0,1 – 0,2 В может превышать значение Iо на много порядков. Так как основных носителей в областях p и n много, то при прямом включении обусловленный основными носителями ток будет большим.
Вольтамперная характеристика p-n- перехода существенно зависит от температуры перехода. При увеличении температуры растет концентрация неосновных носителей и резко возрастает обратный ток перехода Iо. В идеальных германиевых p-n- переходах при увеличении температуры на каждые 10 оC обратный ток удваивается. И хотя в кремниевых переходах эта зависимость еще большая, но абсолютные значения Iо у кремниевых переходов значительно меньше.
Зависимость прямой ветви ВАХ от температуры по формуле (4.1) определяется изменением теплового тока Iо и показателем экспоненты. При малом прямом смещении прямой ток p-n- перехода возрастает с увеличением температуры из-за увеличения обратного тока Iо. При больших напряжениях, т.е. при больших прямых токах, основную роль играет проводимость полупроводника, которая уменьшается с увеличением температуры, поэтому прямые ветви ВАХ изменяются относительно мало.
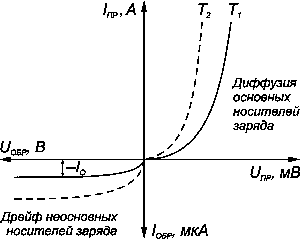
|
| Рис. 4.4. Вольтамперная характеристика p-n-перехода: ——— зависимость при нормальной температуре Т1; – – – – зависимость при повышенной температуре Т2; Т2 > Т1 |
От идеального p-n- перехода реальный переход будет отличаться следующим:
1. Реальный переход имеет конечные размеры и поэтому по некоторому контуру выходит на поверхность полупроводника. Это означает, что в реальном переходе необходимо рассматривать влияние процессов на поверхности полупроводника на его свойства.
2. При рассмотрении идеального перехода не учитывалось, что при приложении внешнего напряжения часть его падает в объеме полупроводника за пределами p-n- перехода.
В реальных переходах обратный ток состоит из нескольких слагаемых. В первую очередь к тепловому току Iо могут добавляться токи утечки и канальные токи.
Токи утечки являются следствием проводимости по поверхности. Например, ничтожно малое количество воды, попадающее на поверхность реального кристалла, создает проводимость, возникают токи утечки при обратном включении и наблюдается нестабильность обратного тока во времени. В процессе изготовления полупроводниковых приборов применяют специальные меры, чтобы значительно уменьшить величину тока утечки и его влияние на параметры.
Кроме воды на реальной поверхности полупроводникового кристалла могут адсорбироваться другие вещества, создавая заряды обоих знаков. Например, пары ацетона и воды на поверхности германия образуют положительный заряд, а кислород, хлор – отрицательный.
Отрицательные заряды на поверхности, например n- области p-n- перехода, притягивают дырки из объема полупроводника и отталкивают электроны, т.е. в приповерхностной области образуется слой, где концентрация дырок превышает концентрацию электронов. Этот слой, называемый инверсным, с n- областью образует дополнительный p-n- переход. Такие инверсные слои вблизи поверхности называют каналами, а токи через образованный p-n- переход – канальными.
С образованием канала увеличивается площадь перехода S, возрастают токи диффузии и дрейфа. Образование каналов приводит к увеличению теплового тока p-n- перехода при его обратном включении.
ВАХ p-n- перехода при прямом включении можно условно разделить на три участка в соответствии с величиной протекающего через переход тока. На участке малых токов реальная характеристика I = f(U), расположенная несколько ниже теоретической (идеальной), рост тока I с увеличением U замедлен из-за рекомбинации дырок и электронов в реальном p-n- переходе. На участке средних токов реальная и теоретическая характеристики практически совпадают, так как ток инжекции значительно превышает канальный ток и ток рекомбинации. На участке больших токов реальная кривая расположена ниже теоретической, так как существенно увеличивается падение напряжения в объеме полупроводника. Формула для вольт-амперной характеристики в этом случае приобретает вид
 ,
,
где ir – величина напряжения, падающая на сопротивлении объема полупроводника.
Действие сопротивления объема полупроводника, включенного последовательно с сопротивлением перехода, проявляется в том, что прямая ветвь ВАХ при больших токах описывается уже не экспоненциально, а близко к линейному закону.
4.6. Явление пробоя p-n- перехода
Практика показывает, что имеется предел повышения запирающего напряжения на переходе. Этот предел определяется пробоем p-n- перехода. Пробой p-n- перехода проявляется в резком увеличении тока, протекающего в обратном направлении, которое возникает при достижении критического значения подаваемого напряжения. Пробой p-n- перехода связан с увеличением числа носителей заряда в переходе.
Механизм пробоя в объеме p-n- перехода и величина напряжения пробоя Uпроб зависят от ширины перехода dp-n, которая определяется концентрацией примесей N в полупроводнике, и от напряженности поля в переходе. При том же напряжении на переходе напряженность поля в переходе будет тем больше, чем выше концентрация примесей в полупроводнике.
Ширина для резкого p-n- перехода определяется как
 ,
,
а для плавного p-n- перехода как
 .
.
Соответственно максимальная напряженность поля резкого перехода будет в 2 раза выше средней напряженности поля, а для плавного перехода – в 1,5 раза.
В настоящее время различают четыре разновидности пробоя p-n- перехода:
▪ лавинный пробой, или пробой за счет ударной ионизации;
▪ тепловой пробой за счет кумулятивного разогрева перехода;
▪ туннельный пробой;
▪ поверхностный пробой.
Лавинный пробой вызывается ударной ионизацией, которая происходит тогда, когда напряженность электрического поля, вызванная обратным напряжением, достаточно велика, что характерно для резкого p-n- перехода, когда концентрация в одной из областей существенно превосходит концентрацию в другой области.
При обратном включении перехода напряженность электрического поля Е в переходе оказывается достаточной, чтобы сообщить неосновным носителям, входящим в переход, такую энергию, что при соударении с атомами ионизируют их с образованием пары электрон–дырка. Вновь появившиеся носители заряда ускоряются электрическим полем и в свою очередь могут вызвать ионизацию следующего атома и т.д. В переходе получается лавинное умножение числа носителей, так что число носителей (например, электронов n), уходящих из перехода, становится значительно больше числа носителей no, поступающих в переход.
Отношение n / no = M называется коэффициентом лавинного умножения носителей, который показывает, во сколько раз лавинный ток, протекающий через p-n- переход, больше обратного тока: Iл = MIобр. Коэффициент лавинного умножения зависит от величины приложенного к переходу напряжения:
 ,
,
где m – некоторая постоянная для данного полупроводника, например, для кремния p -типа m = 3, а для n -типа m = 5.
Напряжение лавинного пробоя Uпроб.л. зависит от материала полупроводника, его удельного сопротивления r и типа перехода:
 ,
,
где А и В – некоторые постоянные коэффициенты, зависящие от типа полупроводникового материала.
Например, для кремниевых сплавных переходов эти соотношения равны: Uпроб.л. = 86 r 0,64 для электронного типа, и Uпроб.л. = 23 r 0,75 для дырочного типа.
Напряжение лавинного пробоя Uпроб.л. с повышением температуры увеличивается (рис. 4.5), так как с ростом температуры увеличивается число столкновений носителей с атомами решетки, но при этом средняя длина свободного пробега уменьшается, поэтому для приобретения достаточной для ударной ионизации энергии носителями тока при повышенной температуре необходимо более сильное электрическое поле.
Тепловой пробой возникает в результате разогрева p-n- перехода, когда количество теплоты, выделяемое током в переходе, больше количества теплоты, отводимой от него. Тепловой пробой характерен для плавных (широких) p-n- переходов, в которых напряженность электрического поля меньше напряженности электрического поля в резких переходах.
Обратный ток, протекающий через переход и обусловленный неосновными носителями, разогревает переход. При этом происходит тепловое возбуждение валентных электронов

|
| Рис. 4.5. Зависимость лавинного пробивного напряжения от температуры |
и переход их в зону проводимости. Если выделяемое в переходе тепло превышает отводимое от перехода, то температура перехода начинает повышаться, что вызывает дальнейшее увеличение обратного тока, вследствие чего переход еще более разогревается и т.д. В итоге ток через p-n- переход лавинообразно увеличивается, и наступает тепловой пробой. Получается положительная тепловая обратная связь, называемая еще кумулятивным разогревом перехода. Явление теплового пробоя необратимое, т.к. происходит разрушение структуры полупроводника, и p-n- переход может выйти из строя.
Напряжение теплового пробоя Uпроб.т. зависит от температуры окружающей среды, обратного тока и условий отвода тепла. С увеличением температуры Т напряжение теплового пробоя уменьшается (рис. 4.6).
В узких (тонких) p-n- переходах даже при значительной напряженности поля носители заряда не успевают за время, которое они находятся в поле перехода, приобрести достаточную для разрыва связи энергию. Для таких переходов будет характерен туннельный пробой. Такие переходы получаются при больших концентрациях примесей в полупроводниках (порядка 1019 – 1020 см–3) и имеют ширину перехода порядка 0,01 – 0,02 мкм.
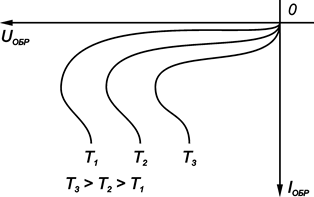
|
| Рис. 4.6. Зависимость теплового пробоя от температуры |
В основе туннельного пробоя лежит туннельный эффект, суть которого заключается в прохождении («просачивании») электронов сквозь очень узкий потенциальный барьер, высота которого больше, чем энергия электронов. При этом напряженность электрического поля в переходе должна быть достаточно высокой (более 105 В/см). При такой напряженности энергетические зоны искривляются настолько, что энергия электронов валентной зоны полупроводника p -типа становится такой же, как и энергия свободных электронов зоны проводимости полупроводника n -типа. В результате происходит переход электронов «по горизонтали» из области p -типа в область n -типа, т.е. возникает туннельный ток. Практически начало туннельного пробоя оценивается по десятикратному превышению туннельного тока над обратным.
Вид обратной характеристики p-n- перехода при туннельном пробое аналогичен виду лавинного пробоя. Эксперименты показали, что туннельный пробой наблюдается у германиевых и кремниевых как сплавных, так и диффузных переходов при удельных сопротивлениях менее 0,1 Ом·см. Напряжение туннельного пробоя составляет при этом менее 2 В для германиевых и менее 5 В для кремниевых переходов. Пробивное напряжение свыше 5 В для германиевых и свыше 7 В для кремниевых переходов соответствуют лавинному пробою; промежуточные значения соответствуют одновременному существованию обоих видов прибоя.
Вероятность туннельного перехода электронов из валентной зоны полупроводника p -типа в зону проводимости полупроводника n -типа зависит от ширины запрещенной зоны DE. При увеличении температуры ширина запрещенной зоны уменьшается, переход сужается (т.е. dp-n уменьшается), ток, обусловленный туннельным эффектом, увеличивается, поэтому напряжение пробоя снижается.
Явление поверхностного пробоя заключается в следующем. Поверхностный заряд, который практически всегда имеется на поверхности полупроводника в месте выхода p-n- перехода на поверхность, может повышать или понижать напряженность поля в переходе, искажая картину поля идеального p-n- перехода. Это приведет к увеличению или уменьшению ширины перехода в области выхода перехода на поверхность полупроводника. Выше указывалось, что ширина перехода определяется в основном той областью полупроводника, которая имеет большее удельное сопротивление, т.е. высокоомной областью.
 Если знак поверхностного заряда противоположен знаку основных носителей в высокоомной области, то напряженность поля у поверхности будет выше, переход у поверхности будет ýже и пробой на поверхности произойдет при меньшем напряжении, чем без учета поверхностного эффекта. Уменьшение диэлектрической проницаемости среды у поверхности полупроводника усиливает этот эффект.
Если знак поверхностного заряда противоположен знаку основных носителей в высокоомной области, то напряженность поля у поверхности будет выше, переход у поверхности будет ýже и пробой на поверхности произойдет при меньшем напряжении, чем без учета поверхностного эффекта. Уменьшение диэлектрической проницаемости среды у поверхности полупроводника усиливает этот эффект.
Практика показала, что для германия в воздухе значение напряжения поверхностного пробоя может быть в 5 и более раз меньше, чем для объемного пробоя. Для уменьшения возможности поверхностного пробоя в полупроводниковых приборах применяют защитные покрытия с высоким значением диэлектрической проницаемости.
4.7. Емкости p-n- перехода
Емкостные свойства p-n- перехода обусловлены наличием по обе стороны от границы электрических зарядов, которые созданы ионами примесей, а также подвижными носителями заряда, находящимися вблизи границы перехода.
Емкость p-n- перехода подразделяют на две составляющие: барьерную, отражающую перераспределение зарядов в p-n- переходе, и диффузионную, отражающую перераспределение зарядов вблизи p-n- перехода.
Электронно-дырочный переход имеет двойной электрический слой: с одной стороны из положительно заряженных доноров, а с другой – из отрицательно заряженных акцепторов. Этот двойной электрический слой, расположенный между p- и n- областями, подобен заряженным обкладкам конденсатора с той лишь разницей, что у обычного конденсатора заряд сосредоточен на обкладках, а у p-n- перехода он расположен по объему в двойном электрическом слое (запирающем слое), обладающим диэлектрическими свойствами. Эту емкость называют барьерной (или зарядовой) емкостью p-n- перехода. Ее можно определить по формуле плоского конденсатора
 ,
,
где e – относительная диэлектрическая проницаемость полупроводника; eо – диэлектрическая постоянная воздуха (Ф/м); Sp-n – площадь p-n- перехода (м2); dp-n – ширина p-n- перехода (м).
Величину С для резкого перехода при приложении к переходу напряжения U можно определить из приближенного выражения:
 .
.
С увеличением приложенного обратного напряжения U барьерная емкость уменьшается, так как увеличивается ширина перехода dp-n (рис. 4.7). При подключении к p-n- переходу прямого напряжения барьерная емкость увеличивается вследствие уменьшения dp-n. Однако в этом случае приращение зарядов за счет их инжекции играет большую роль, и емкость p-n- перехода определяется в основном диффузионной составляющей емкости.
Если изменять прямое напряжение Uпр на p-n- переходе, то заряд в обеих областях перехода будет существенно меняться. При увеличении прямого напряжения на переходе Uпр увеличивается взаимная диффузия основных носителей через переход, следовательно, растет и прямой ток через переход In, и при этом растет, например, заряд дырок в базе на величину DQp = Cд·DUпр, где DUпр – прямое падение напряжения на переходе, Сд – коэффициент пропорциональности, называемый диффузной емкостью p-n- перехода. Появление Сд связано с процессом диффузии неосновных носителей в базе.
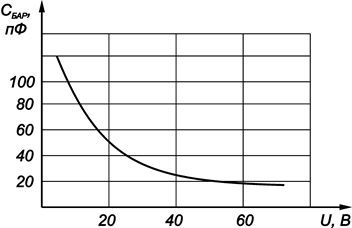
|
| Рис. 4.7. Зависимость барьерной емкости p-n- перехода от обратного напряжения |
Диффузионная емкость отражает изменение напряжения на переходе, обусловленное изменением заряда в базе. Аналогичный процесс происходит и в эмиттере с зарядом электронов. Поэтому
 .
.
Диффузионная емкость
 .
.
Н<