Этот случай соответствует условиям, когда в тонком приповерхностном слое создана избыточная концентрация примеси С0, количество которой непрерывно уменьшается в процессе термообработки, тогда как концентрация примеси на глубине постепенно увеличивается.
Граничные условия в этом случае можно представить в виде
С (x,0) = С0 при t=0, x = 0;
С(x,t) = 0 при t ¹ 0, x ®¥.
При этом решение уравнения диффузии имеет вид функции Гаусса
 . (3.9)
. (3.9)
Изменение поверхностной концентрации зависит как от температуры процесса, так и от его продолжительности:

Глубина залегания p-n перехода при диффузии в подложку с концентрацией примесей СB определяется аналогично (3.8):
 .
.
В планарной технологии традиционно процесс диффузии проводят в две стадии, когда на первой, более короткой, осуществляют диффузию из бесконечного источника либо другим способом формируют сильно легированный поверхностный слой, а на второй стадии, более высокотемпературной, проводят отжиг структуры для перераспределения примеси в заданном объеме. В такой традиционной ситуации D2t2 >> D1t1 и тонкий слой, созданный на первой стадии, можно считать ограниченным источником примеси. При этом количество атомов примеси, введенное на первой стадии, останется неизменным и
 .
.
С учетом (3.9)
 . (3.10)
. (3.10)
Если учесть, что для большинства структур величина СВ в 103 – 105 раз ниже поверхностной концентрации, можно с точностью до 10 % оценить глубину залегания p-n перехода по приближенной формуле
 .
.
РАСЧЁТНАЯ ЧАСТЬ
Задание. С учетом возможности минимального разрешения ф/л, оценить площадь скрытого слоя необходимого для нормальной работы БПТ. Выбрать материал маски, способ её получения и необходимую толщину. Рассчитать процесс ионного легирования и процесс диффузии примеси во время постимлантационного отжига в окислительной атмосфере. Рассчитать высоту ступеньки над скрытым слоем и остальной пластиной.
Расчёт параметров биполярного транзистора
С учетом минимального разрешения фотолитографии  , оценим площадь скрытого слоя необходимого для нормальной работы биполярного транзистора.
, оценим площадь скрытого слоя необходимого для нормальной работы биполярного транзистора.
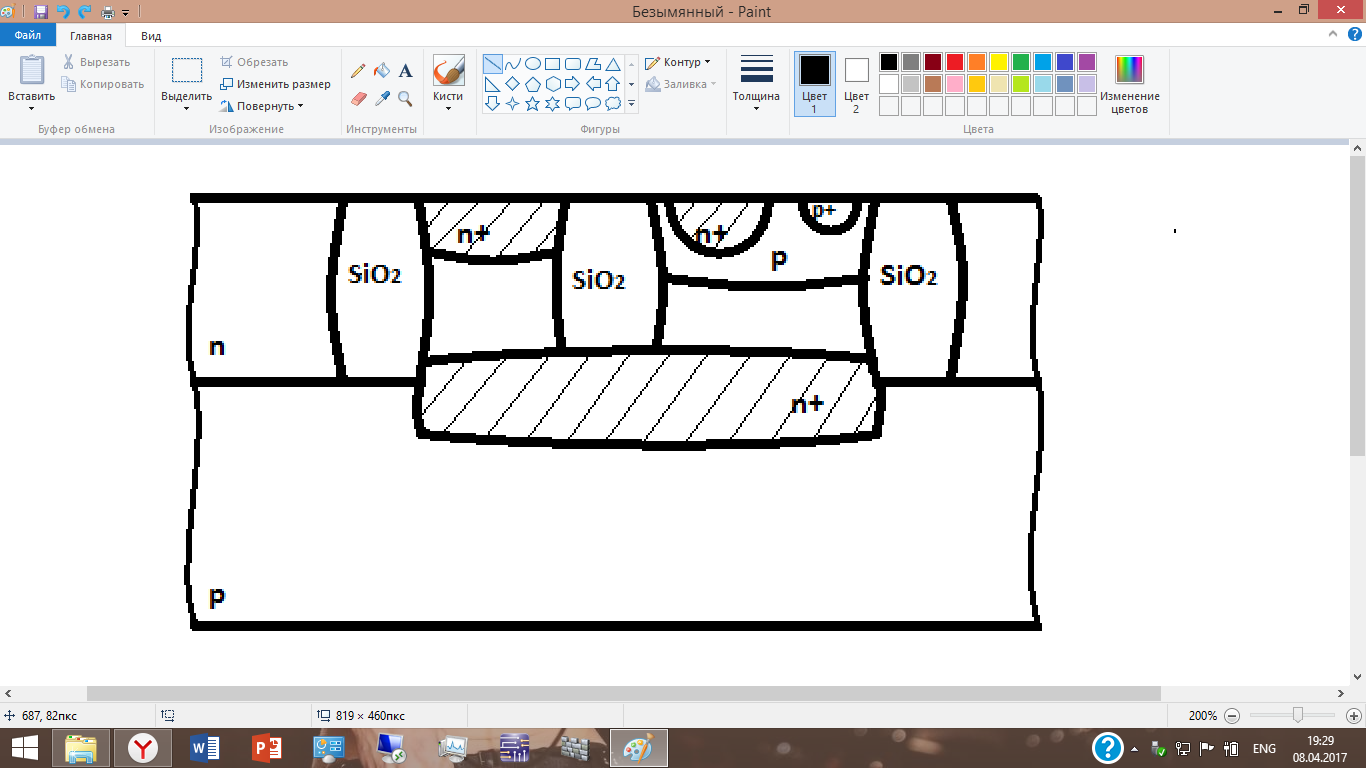
Рис 2.1.1. – Вид биполярного транзистора сбоку в разрезе.

Рис 2.1.2 – Вид биполярного транзистора сверху с размерами каждой составляющей.
Из рисунка 2 видно, что площадь скрытого слоя данного биполярного транзистора: 
Маска.
Нанесение маски проводится методом термического окисление кремния в влажном кислороде.
Толщины маски h=700нм будет достаточно, чтобы выдержать последующие температурные условия процесса диффузии.
Для установки оптимального процесса выберем температуру, при которой будет проводиться окисление, равной 1000 С°.
| Т, С° | А, мкм | В, мкм2/ч | А/В, мкм/ч | τ, ч |
| 0,48 | 0,314 | 0,664 | 0,37 |
 ;
;
Выразим время процесса:

Рассчитаем для нашего процесса:

Рассчитаем необходимую толщину слоя кремния на образования 700 нм Si02:

Для нашего процесса:

Ионное легирование.
Для получения скрытого слоя выбран мышьяк (As).
Необходимое поверхностное сопротивление скрытого слоя  , толщина слоя
, толщина слоя  , следовательно, объемное удельное сопротивление
, следовательно, объемное удельное сопротивление

Подложка КДБ-10, значит проводимость р-типа с удельным сопротивление 10 Ом∙см, следовательно, по Кривым Ирвина этим условиям соответствует концентрация основной примеси
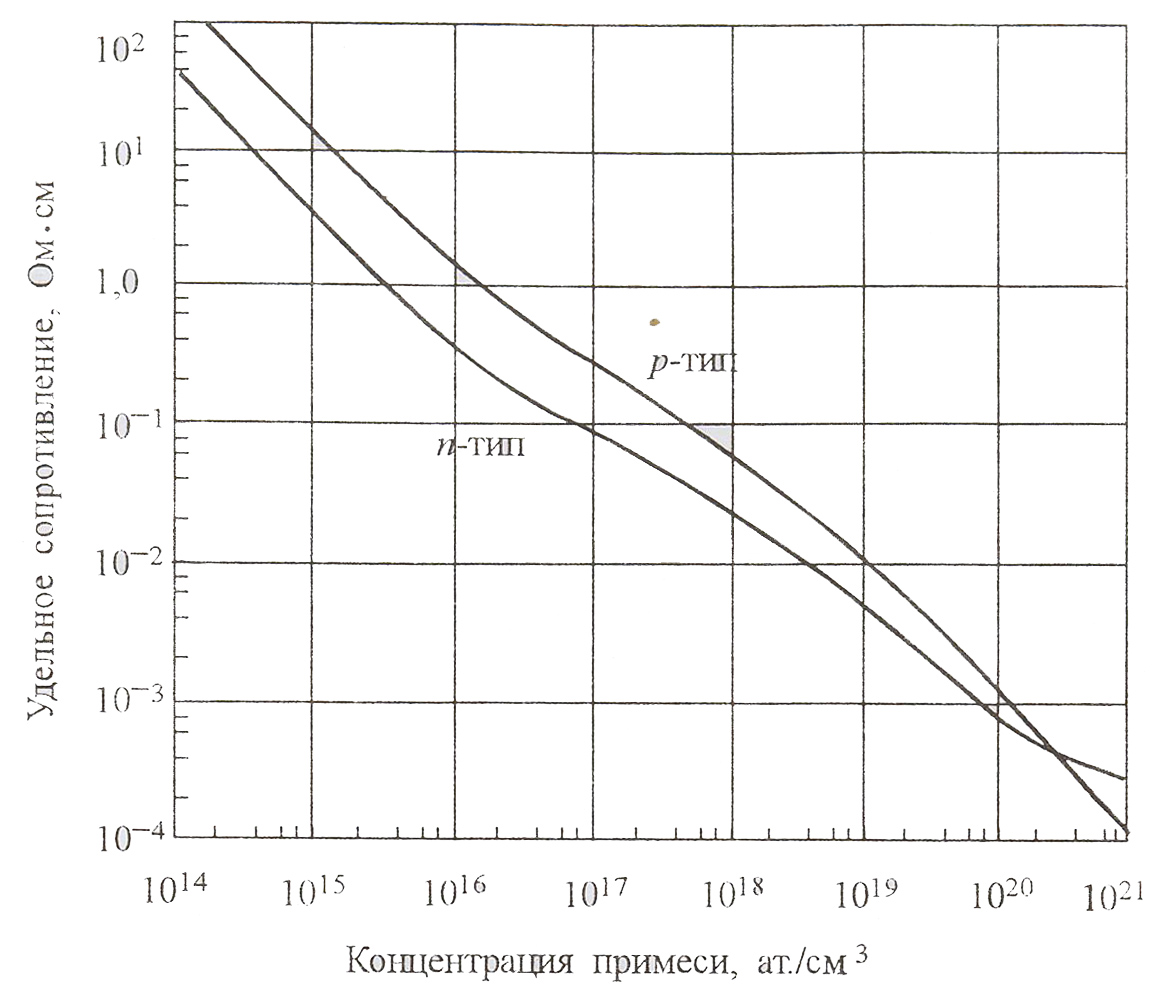
Рис. 2.3.1 – Зависимость удельного сопротивления от концентрации легирующих примесей при комнатной температуре.


Необходимая вводимая концентрация As:

| Примесь | СE | CR | k |
| Мышьяк, As | 4,8*10-6 | 1,7*105 | 0,12 |


Рис. 2.3.2 – График зависимости дозы от энергии.
Значения с, d берутся из таблицы при известном параметре энергии ε:

| e | с | d |
| 0,03–0,1 | 0,23 | 0,1 |
| 0,1–7,5 | 0,46 | 0,3 |
| 7,5–40 | 0,32 | –2,45 |

Потери энергии на упругие соударения составляет:


где Z1 и Z2 – порядковые номера атомов мишени и подложки соответственно.

где A1 и A2 – атомные массы мишени и подложки соответственно.
С i - собственная концентрация атомов в полупроводниковой мишени
(5×1022 см-3);

Средняя потеря на одно столкновение

Среднее число упругих соударений

Средний угол рассеивания иона в системе центра масс:

а средний угол рассеивания

Величина полного пробега f составит

Значение полного пробега определится как

С учетом поправочной функции f рассчитывают величину проецированного пробега,


Следовательно, 
Профиль распределения примеси:

Глубина залегания p-n-перехода:

Диффузия.
Для As в Si: коэффициент диффузии  , энергия активации
, энергия активации 
При Т = 1200 С°:

Максимум концентрации внедренной примеси на глубине  составит
составит



Процесс диффузии происходит в атмосфере сухого кислорода, поэтому рассчитаем оксид, образовавшийся за это время:
| Т, С° | А, мкм | В, мкм2/ч | А/В, мкм/ч | τ, ч |
| 0,040 | 0,045 | 1,12 | 0,027 |
 ;
;
При использовании модели термического окисления Дилла-Гроува, она работает для размеров оксидов не более 2мкм, следовательно, берем предельное значение оксида:

Значение скорость формирования оксида над скрытым слоем в 2 раза выше, чем над остальной пластиной:

Разница между толщинами этих оксидов будет по величине равна высоте ступеньки:

СПИСОК ЛИТЕРАТУРЫ
1. Громов Д.Г., Редичев Е.Н. – Учебно – методическая разработка для самостоятельной работы студентов по курсу «Технологические процессы микроэлектроники».
2. Торгонский Л.А. – Проектирование интегральных микросхем и микропроцессоров: Учебное пособие. В 3-х разделах. / Раздел 1 — Томск: ТУСУР, 2011 г. — 254 с.
3. Айзикович А.А., – Расчёт параметров модели Дила-Гроува окисления кремния. / А.А. Айзикович, Ю.П Демаков. // Вестник Самарского государственного аэрокосмического университета. – 2011. – №7(31). – С. 64-68.