Удельные сопротивления кремния и германия даны в табл. 2.2 для температуры 300°К или 27°С. что является нормальной лабораторной температурой. При нагреве окружающей среды первоначальная энергия электронов в ковалентных связях возрастает и может стать достаточной, чтобы порвать эти связи. Электроны становятся носителями заряда и оставляют после себя дырки, которые тоже становятся носителями заряда. Это называется термогенерацией электронно-дырочных паp. В действительности электрон в кристалле хаотично движется короткое время, а затем занимает место какой-либо дырки. Тем временем возникают другие электронно-дырочные пары, так что при любой температуре концентрация носителей заряда равновесна. При увеличении температуры окружающей среды возрастает число электронов с энергией, достаточной для преодоления ковалентных связей, и процесс термогенерации электронно-дырочных пар нарастает очень быстро. Экспериментальные данные показывают, что удельная электропроводность германия или кремния удваивается при увеличении температуры от нормальной (300°К) на каждые 10°С.
Примесные полупроводники
Свойства собственных полупроводников могут быть значительно улучшены, если в кремниевую кристаллическую решетку ввести небольшое количество примеси, называемой легирующей. Существует два типа легирующих примесей: донорные атомы, которые образуют кремний или германий n -типа проводимости, и акцепторные атомы, которые образуют р -тип проводимости.
Донорная примесь является элементом с пятью электронами в валентной зоне, например мышьяк или сурьма. Кристаллическая решетка с введенным пятивалентным донорным атомом показана на рис. 2.6. Из рисунка видно, что четыре из пяти валентных электронов примеси образуют ковалентные связи с соседними атомами кремния, пятый электрон становится свободным. При донорном легировании кремния почти все носители являются

Рис 2.6. Легирование донорной примесью
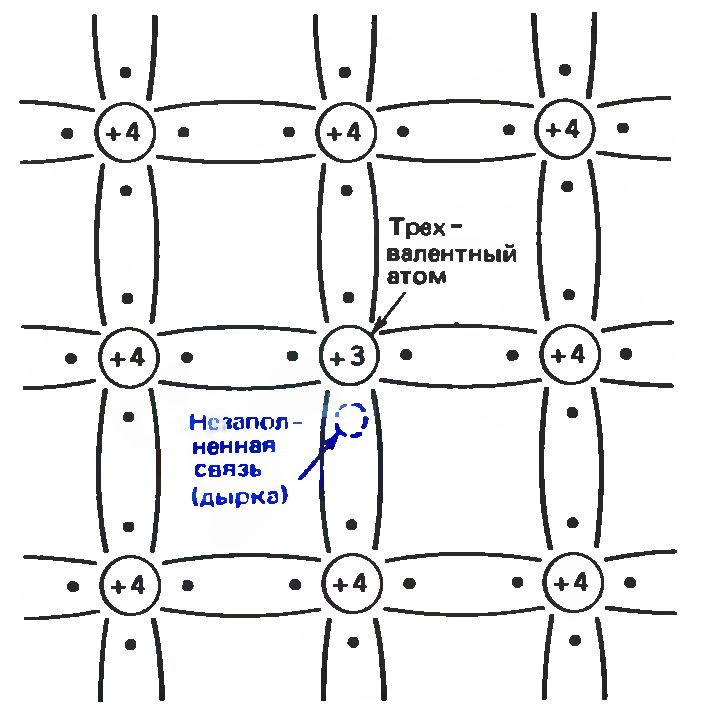
Рис 2.7. Легирование акцепторной примесью
электронами, или отрицательными зарядами, и такой кремний называется кремнием n -типа. Необходимо заметить, что хотя количество добавок очень незначительно, оно оказывает существенное влияние на характеристики кремния. Добавка одного лишь примесного атома на каждые сто миллионов (108) атомов кремния уменьшает удельное сопротивление кремния в 24 000 раз, т.е. от 230000 до 9,6 Ом см, и превращает кремний из диэлектрика в проводник.
Кремний или германий могут быть также легированы акцепторными атомами, такими, как бор, галлий или индий. Эти элементы имеют по три электрона в валентной зоне. Как видно из рис. 2.7, три валентных электрона акцепторной примеси формируют ковалентные связи с соседними атомами кремния, а на месте недостающего электрона образуется дырка в ковалентной связи. Таким образом, в кремнии, легированном акцепторными атомами, преобладают дырки, и его называют кремнием p -типа.
Необходимо отмстить, что в целом кремний и р -. и n -типа электрически нейтрален, т.е. число протонов и электронов в обоих случаях равно. В кремнии n -типа свободные электроны уравновешиваются ядрами, содержащими пять протонов. Аналогично и для кремния р -типа.
Диоды
От греческого di – дважды, двойной – двухэлектродный прибор, обладает различной проводимостью в зависимости от направления электрического тока: высокой для токов прямого направления и низкой для токов обратного направления. Условное изображение диода приведено на рис. 2.8.


Рис. 2.8 Условное изображение диода
Полупроводниковый диод - это полупроводниковый прибор с одним выпрямляющим электрическим переходом и двумя выводами, в котором используется тот или иной эффект выпрямляющего перехода. В качестве выпрямляющего электрического перехода используется электронно-дырочный (р-п) переход, разделяющий р - и п - области кристаллов полупроводника (рис. 2.9). К р - и п- областям кристалла привариваются или припаивается металлические выводы, и вся система заключается в металлический, металлокерамический, стеклянный или пластмассовый корпус. Одна из полупроводниковых областей кристалла, имеющая более высокую концентрацию примесей (следовательно, и основных носителей заряда), называется эмиттером, а другая, с меньшей концентрацией, базой. Если эммитером является р- область, для которой основными носителями заряда служит дырки рр, а базой п- область (основными носителями заряда являются электроны пп), то выполняется условие рр » пп. (пп обозначает количество электронов в п- области, где они являются основными носителями заряда; пр - количество электронов в области дырочной проводимости).
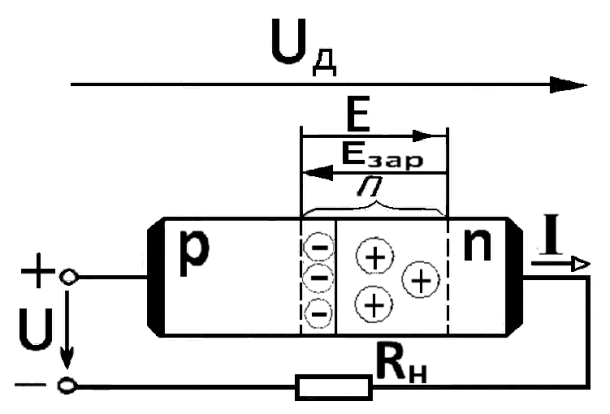
Рис. 2.9. Схема включения полупроводникового прибора и пространственное распределение объемных зарядов р-п перехода
Принцип работы диода. Рассмотрим случай, когда внешнее напряжение на выводах диода отсутствует. Тогда в результате встречной диффузии дырок (из р - в п - область) и электронов (из п- в р - область) в объеме полупроводникового кристалла, расположенного вблизи границы раздела двух областей с различной проводимостью, заряды неподвижных ионов примесей окажется нескомпенсированными (акцепторов для р -области и доноров – для п -области). Эти заряды создадут по обе стороны раздела полупроводникового кристалла область объемного заряда (иногда называют областью пространственного заряд - ОПЗ). Диффузия – движение свободных носителей заряда под действием их градиента концентрации, то есть под действием сил, возникающих из-за их неравномерного распределения по объему проводника.
Для сохранения электрической нейтральности полупроводниковой структуры количество диффундируемых через p-n -переход основных носителей заряда из одной области должно равняться количеству диффундируемых носителей заряда из другой области. С учетом того, что концентрация электронов в базе пп значительно меньше концентрации дырок рр в эмиттере, область объемного заряда со стороны базы будет больше, чем со стороны эмиттера. Образованный в результате диффузии объемный заряд создает электрическое поле с напряженностью Е зар,препятствующее дальнейшей встречной основных носителей заряда. Таким образом, на границе р-п – перехода образуется контактная разность потенциалов, численно характеризующаяся высотой потенциального барьера. Диффузия практически прекращается, когда энергия носителей заряда будет недостаточна, чтобы преодолеть созданную высоту потенциального барьера.
Если к выводам приложить прямое напряжение (см. рис.2.9), создаваемое электрическое поле Е будет компенсировать поле Е зар. В область базы (по мере возрастания напряжения U) будут водиться (инжектировать) все большее количество дырок или неосновных носителей заряда для области базы, которые образуют прямой ток диода. Дрейф - движение носителей заряда под действием электрического поля. Встречной инжекцией электронов в область эмиттера можно пренебречь, учитывая, что их концентрация низкая. Если к выводам диода приложить обратное напряжение (-U), создаваемое им электрическое поле совпадает по направлению с полем перехода Е зар, что повышает потенциальный барьер и препятствует переходу основных носителей заряда в соседнюю область. Однако суммарная напряженность электрических полей способствует извлечению или экстракции неосновных носителей заряда, то есть электронов из р- области в п- область, и дырок из п- области в р- область, которые образуют обратный ток.
Количество неосновных носителей заряда значительно изменяется из-за изменения температуры, возрастая с её повышением. Поэтому обратный ток p-n – перехода, образованный за счёт неосновных носителей, называют тепловым I 0. Температурное изменение тока определяется известной зависимостью
 (2.1)
(2.1)
где I 0 - значение теплового тока при комнатной температуре T 0 = 300°K;
∆T - значение приращения температуры, соответствующее удвоение значение теплового тока. Значение ∆T зависит от материала полупроводника и составляет примерно 10°К для германия и 7°К для кремния.
Вольт-амперная характеристика (ВАХ) диода описывается выражением
 (2.2)
(2.2)
где U Д - напряжение на p-n - переходе;
 - тепловой потенциал, равной контактной разности φk потенциалов на границе p-n - перехода при отсутствии внешнего напряжения (при T=300°K
- тепловой потенциал, равной контактной разности φk потенциалов на границе p-n - перехода при отсутствии внешнего напряжения (при T=300°K  ;
;
k - постоянная Больцмана, равна 8,617343·10-5 эВ/К;
Т - абсолютная температура;
q - заряд электрона 1,6 · 10-19 эВ.
При отрицательных напряжениях порядка 0,1… 0,2 В экспоненциальной составляющей, по сравнению с единицей, можно пренебречь (е-4 ≈0,02); при положительных напряжениях, превышающих 0,1В, можно пренебречь 1 в формуле (2.2), поскольку е4 ≈54,6; поэтому вольт-амперная характеристика описываемая этим выражением, будет иметь вид (рис.2.10).

Рис.2.10 Статическая вольт-амперная характеристика идеального диода.
По мере возрастания положительного напряжения на p-n - переходе прямой ток диода резко возрастает, поэтому незначительное изменение прямого напряжения приводит к значительному изменению тока, что затрудняет задание требуемое значение прямого тока с помощью напряжения. Поэтому для p-n - перехода характерен режим заданного прямого тока. Следует отметить, что приведенная вольт-амперная характеристика является идеальной ВАХ для p-n – перехода. Она не учитывает рекомбинационно-генерационных процессов, происходящих в объеме и на поверхности p-n -перехода, считая его бесконечно тонким и длинным. Реальный переход не является бесконечно тонким и поэтому при обратном напряжении происходит генерация пар электрон-дырка, образующих ток генерации I ген. Причём с увеличением обратного напряжения растет толщина p-n - перехода (эффект Эрли), а, следовательно, и количество генерируемых пар. Вот почему с возрастанием обратного напряжения одновременно возрастает и обратный ток.
Эффект Эрли заключается в том, что при увеличении модуля обратного напряжения, приложенного к p-n -переходу, увеличивается область, обеднённая подвижными носителями заряда: электронами и дырками, в результате чего толщина p-n – перехода возрастает.
Протяженность реального p-n - перехода также не бесконечна. Поверхность полупроводникового кристалла характеризуется нарушением кристаллической решетки и различными загрязнениями, что обуславливает рекомбинационно-генерационные процессы на поверхности p-n -перехода и приводит появление дополнительного тока - тока утечки I ут. Таким образом, обратный ток реального диода равен следующему значению I обр = I 0 + I ген + I ут .
При нарушениях технологического процесса, когда появляется возможность попадания различных загрязнений на поверхность полупроводникового диода, ток утечки иногда составляет основную часть обратного тока диода, значительно превышая ток генерации и тепловой ток и даже шунтирует p-n -переход. Относительная доля этих токов (теплового и генерации) в обратном токе зависит от типа исходного полупроводникового материала. Так, для германия I ген/ I 0<<1. Для кремния ток генерации больше теплового тока в 1000 раз (I ген/ I 0≈1000).
Ток утечки также зависит от типа применяемого полупроводникового материала. Для германиевых диодов он всегда меньше суммы тока генерации и теплового тока I ут < I 0 + I ген. Для некоторых типов кремниевых диодов наоборот ток утечки больше только генерации и теплового потока I ут > I 0 + I ген. С учетом сказанного приближённо можно сказать, что для германиевых диодов I обр = I 0 обратный ток примерно равен тепловому. Поэтому он в большей степени подвержен температурным изменениям и превышает значение обратных токов кремниевых диодов на несколько порядков. Для кремниевых диодов обратный ток равен сумме токов утечки и тока генерации I обр = I ген + I ут. Реальные обратные токи германиевых диодов, для которых ток утечки на 7…8 порядков больше, чем для кремниевых, отличается от обратных токов кремниевых диодов примерно на 3 порядка.

Рис. 2.11. Статическая характеристика реального диода
Вольт-амперная характеристика реального диода имеет вид, приведенный на рис. 2.11. Из неё следует, что при определенном значении обратного напряжения U обр= U проб начинается лавинообразный процесс нарастания обратного тока, соответствующиё электрическому пробою p-n - перехода (отрезок А-В на рис.2.11). Если в этот момент ток не ограничить, то электрический пробой переходит в тепловой (участок вольт-амперной характеристики после точки В). Такой процесс нарастания обратного тока характерен для кремниевых диодов, для германиевых диодов при увеличении обратного напряжения тепловой пробой p-n - перехода наступает практически одновременно с началом лавинообразный процесс нарастания обратного тока. Электрический пробой обратим, то есть после уменьшения обратного напряжения работа диода соответствует пологому участку ВАХ. Тепловой пробой необратим, так разрушает переход безвозвратно.
Тепловой пробой обусловлен ростом числа носителей в p-n - переходе. При некотором значении пробивного напряжения мощность, выделяющаяся в диоде P Д = U обр I обр, не успевает отводится от перехода, что ведет к увеличению температуры. И, следовательно, росту обратного тока и дальнейшему повышению температуры. Возникает положительная обратная связь и переход вследствие перегрева разрушается. Нетрудно видеть, что напряжение теплового пробоя сильно зависит от обратного тока I обр и условий охлаждения прибора. Так как для диодов, изготовленных на основе германия, обратный ток больше, чем на основе кремния, то для первых вероятности теплового пробоя выше, чем для вторых. Поэтому максимальная рабочая температура окружающей среды и, следовательно, переходы для кремниевых диодов выше, чем для германиевых (соответственно 75… 90°С против 150… 200°С).
Прямая ветвь реального диода (рис.2.3) также отличается от вольт-амперной характеристики идеального p-n -перехода. Это объясняется тем, что выражение (2.2) не учитывает влияние объемного сопротивление базы диода R Б при больших уровнях инжекции. Действительно, концентрации основных носителей заряда в области базы, как уже отмечалось выше, значительно меньше, чем в области эмиттера, что выражается в существенном различии сопротивления этих областей (R Б >> R Э). Значение сопротивления R Б зависит от типа диода и может изменяться от десятых долей до нескольких десятков Ом. Наличие существенного объемного сопротивления базы приводит к неравенству значений напряжения на выводах диода U Ди на его электронно-дырочном переходе U БЭ. Эта разница тем выше, чем большие прямой ток диода, ибо U БЭ= U Д - IR Б. И в тоже время аналитическое выражение для характеристики идеального p-n -перехода (2.2) не учитывает падение напряжения в области базы, равное IR Б, и подразумевает, что напряжение на диоде U = U Д равняется значению падения напряжение между базой и эмиттером U БЭ. Подставив в выражение (2.2) реальное значение U БЭ и пренебрегая единицей для больших уровня инжекции, получим уравнение описывающее прямую реального диода, уравнение Эберса-Молла
 ,
,
или

При I >> I обр, что соответствует большим уровням инжекции, слагаемым с логарифмом можно пренебречь. Тогда прямая ветвь вольт-амперной характеристики реального диода описывается линейной зависимостью U = IR Б. Этот участок в ВАХ называется омическим участком прямой ветви. Строго говоря, сопротивление базы  не остается постоянным при изменении прямого тока диода. Сопротивление базы зависит от плотности тока, и связанного с ним повышение концентрации избыточных неосновных носителей в базе приводит уменьшение его сопротивления R Б. Явление уменьшения сопротивления базовой области полупроводникового прибора вследствие инжекции в нее неосновных носителей из прямо смещенного р-п - перехода называется модуляцией сопротивление базы. Совместное влияние сопротивления R Б и модуляции этого сопротивления приводит к сохранению экспоненциального характера ВАХ в области больших токов. Однако линейность ВАХ реальных диодов в области больших токов для большинства случаев является допустимой аппроксимацией.
не остается постоянным при изменении прямого тока диода. Сопротивление базы зависит от плотности тока, и связанного с ним повышение концентрации избыточных неосновных носителей в базе приводит уменьшение его сопротивления R Б. Явление уменьшения сопротивления базовой области полупроводникового прибора вследствие инжекции в нее неосновных носителей из прямо смещенного р-п - перехода называется модуляцией сопротивление базы. Совместное влияние сопротивления R Б и модуляции этого сопротивления приводит к сохранению экспоненциального характера ВАХ в области больших токов. Однако линейность ВАХ реальных диодов в области больших токов для большинства случаев является допустимой аппроксимацией.
Прямой ток диода также зависит от температуры, возрастая с её повышением, хотя в значительно меньшей степени, чем обратный ток. Характер изменения прямой ветви ВАХ при изменении температуры показан на рис.2.11 штриховой линией. При расчете падения напряжения на прямо-смещенном полупроводниковом диоде можно полагать, что значение прямого падения напряжения уменьшается примерно на 2…2,5 мВ при изменении температуры примерно на 1°К. То есть, U (T) – U (T0)= - (2,0…2,5)(T-T0)/1000.
Для оценки температурной зависимости прямой ветви ВАХ диода служит температурный коэффициент напряжения (ТКН), К-1.
ТКН = ∆U/(U∆T). (2.3)
Этот коэффициент показывает относительное изменение прямого напряжения за счет изменения температуры на 1°К при некотором значении тока.
Наиболее часто диоды используют в схемах источников питания для выпрямления переменного напряжения. Типовыми являются следующие варианты (рис. 2.12).
В схемах Тр – трансформатор, преобразует сетевое напряжение. Однофазный трансформатор может быть заменен многофазным. Если выходное напряжение низкое, то в бытовых маломощных случаях трансформатор выполняет одновременно роль гальванической развязки, защищающей людей от случайного прикосновения к высокому напряжению сети. Развязка неидеальная, но всё-таки хоть как-то защищает. Первая схема рисунка 2.12 а) осуществляет однополупериодное выпрямление, вторая б) – двухполупериодное, третья в) – мостовое, двухполупериодное выпрямление, четвертая г) – двухполупериодное выпрямление со средней точкой.
Диоды бывают низкочастотными, среднечастотными и высокочастотными. Все цепи (рис.2.12), выполненные с низкочастотными диодами, не могут быть использованы в высокочастотных цепях, так как вследствие инерционности процессов запирания (закрывания) диоды проводят ток как в прямом, так и в обратном направлениях.
Инженерным (оценочным) критерием при выборе диодов является соотношение, при котором время закрывания (запирания) не превышает сотую часть полупериода приложенного напряжения.
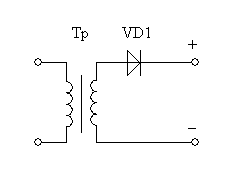
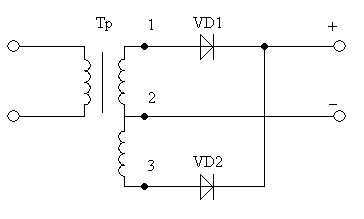
а) б)
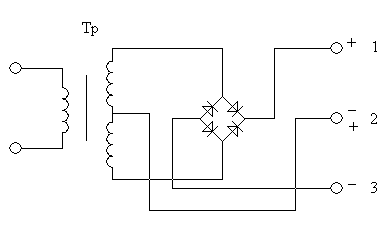
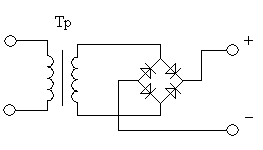
в) г)
Рис. 2.12. Схемы диодных выпрямителей: а – однополупериодная, б – двухполупериодная, в – мостовая со средней точкой, г – мостовая
Сопротивление и емкость диода.
Полупроводниковый диод характеризуется статическим и дифференциальным (динамическим) сопротивлением, легко определяемым по ВАХ диода (рис.2.11). Дифференциальное сопротивление (r Д) численно равно отношению бесконечно малого приращения напряжения к соответствующему приращению тока в заданном режиме работы диода и может быть определено графически как котангенс угла между касательной в рассматриваемой рабочей точке ВАХ диода и осью абсцисс (штриховая линия на рис.2.11 с углом наклона β).
 (2.4)
(2.4)
где ∆ U и ∆ I – конечные приращения напряжения и тока вблизи рабочей точки Е;
m U и m I - масштабы осей напряжения и тока соответственно.
Статическое сопротивление R ст численно равно отношению напряжения на элементе U Е к протекающему через него току I Е (рис.2.11). Это сопротивление равно котангенсу угла наклона прямой, проведенной из начала координат через заданную рабочую точку ВАХ, к оси абсцисс:
 (2.5)
(2.5)
В зависимости от того, на каком участке ВАХ расположена заданная рабочая точка, значение R ст может быть меньше, равно или больше значения r Д. Однако R ст всегда положительно, в то время как r Д может быть и отрицательным (например, в туннельном диоде или тиристоре).
При работе на высоких частотах и в импульсных режимах работы начинает играть роль и емкость диода С Д, измеряемая между выводами диода при заданных значениях напряжения и частоты. Эта емкость включает в себя емкость перехода С пер, образованную диффузионной (С диф), зарядной (барьерной С зар) емкостями, и емкость корпуса прибора С к
С Д = С диф + С зар + С к.
Диффузионная емкость возникает в приконтактном слое р-п – перехода за счет изменения количества диффундируемых дырок и электронов, то есть за счет изменения заряда, вызванного изменением прямого напряжения. Как и любая емкость, она может быть представлена в как изменение заряда ∆Q, соотнесенное к вызвавшему его изменению напряжения ∆U
С диф= ∆Q/∆U. (2.6)
Зависимость С диф от значения прямого тока имеет вид:
 (2.7)
(2.7)
где τр – время жизни дырок в базе диода п -типа.
Диффузионная емкость будет тем больше, чем больше прямой ток через переходи и чем больше время жизни неосновных носителей заряда для области базы диода. Из выражения (2.7) следует, что емкость обращается в нуль при равенстве прямого и обратного тока I обр = - I пр.
Особенностью диффузионной емкости является то, что она представляет собой до некоторой степени фиктивную емкость. Наличие этой емкости не связано, например, с протеканием токов смещения через переход. Однако это замечание касается только физического содержания диффузионной емкости. На внешних зажимах полупроводникового диода эта емкость будет давать емкостной фазовый сдвиг между током и напряжением.
Зарядная емкость возникает при обратном напряжении на переходе и обусловлена изменением в нем объемного заряда. Как видно из рис. 2.8, область объемного (пространственного) заряда представляет собой двойной слой противоположных по знаку неподвижных объемных зарядов. Этот двойной слой можно уподобить обкладкам простого конденсатора, заряженного до некоторого потенциала ψк= Е зар. Когда приложено внешнее запирающее напряжение, разность потенциалов между электронной и дырочной областями полупроводника увеличивается, что приводит к увеличению объемных зарядов в электронной и дырочной областях полупроводника. Так как объемные заряды остаются неподвижными, связанными с кристаллической решеткой ионами атомов доноров и акцепторов, то увеличение объемного заряда может быть связано только с расширением области объемного заряда в основном в сторону области слаболегированного полупроводника (базы). Другими словами, при повышении запирающего напряжения, приложенного к переходу, увеличивается область, обедненная подвижными носителями заряда – электронами или дырками. Отношение изменения объемного заряда ∆Q зар к вызвавшему его изменению запирающего напряжения ∆U обр будет равно величине зарядной или барьерной емкости. Барьерная емкость будет тем больше, чем больше концентрация подвижных носителей заряда (а, следовательно, чем тоньше слой области объемного заряда) и чем меньше напряжение на переходе.
Таким образом, значение емкости диода определяется режимом его работы. При прямом напряжении СД=Сдиф + Ск, при обратном напряжении СД = Сзар + Ск.
С учетом рассмотренных сопротивлений и емкостей частотные свойства диода можно анализировать с помощью его эквивалентной схемы, приведенной на рис.2.13, где R пер – сопротивление р-п – перехода. При прямом смещении перехода R пер составляет десятые доли Ома, и поэтому шунтирующим действием диффузионной емкости можно пренебречь.
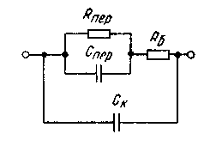
Рис.2.13 Схема замещения полупроводникового диода
Совокупность всех этих элементов схемы образует общее сопротивление диода в комплексной форме
Z Д = R Д + jX Д.
Частотные свойства диода во многом определяются процессами накопления и рассасывания неосновных носителей заряда для области базы. Поэтому, с точки зрения повышения быстродействия, диод должен изготовляться так, чтобы по возможности ускорить процессы изменения объемного заряда неосновных носителей в области базы или вообще исключить их. Последнего можно добиться при использовании так называемого выпрямительного перехода Шоттки (рис.2.14).
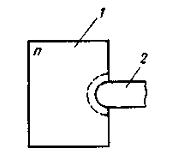
Рис.2.14.Структура точечного диода: 1 – полупроводник, 2- металлический контакт
Этот переход образуется контактом «металл – полупроводник». Соответствующим выбором материала можно добиться того, что высота потенциального барьера для электронов и дырок в месте контакта будет различной. В результате этого (при прямом смещении) прямой ток диода образуется только за счет движения основных носителей заряда. Неосновные носители заряда из-за высокого потенциального барьера практически не могут перейти из металла в полупроводник. Так, например, при контакте п - полупроводника с металлом ток образуется только за счет движения электронов из полупроводника в металл, а процесс движения дырок из металла в полупроводник отсутствует. Таким образом, в полупроводнике не создается объемный заряд неосновных для него носителей. Отсюда вытекает, что диоды, выполненные на основе перехода Шоттки (диоды Шоттки), обладают большим быстродействием, чем диоды с р-п – переходом.
Диоды Шоттки образуют контакты металлической поверхности с полупроводником. В месте контакта возникает обедненные носителями заряда слои полупроводника, которые называются запорными, образуют барьер Шоттки. Диоды с барьером Шоттки отличаются от диодов с p-n переходом по следующим параметрам:
· более низкое прямое падение напряжения;
· более низкое обратное напряжение;
· более высокий ток утечки;
· почти полностью отсутствует заряд обратного восстановления.
Таким образом, общие отличия: диоды Шоттки обладают высокой частотностью в сравнении с обычными диодами с p-n переходом, но малыми напряжениями и токами. В среднем, диоды Шоттки позволяют уменьшить потери мощности на 10-15 %, прямое падение напряжения 0,4-0,6 вольт (вместо 0,7-1 вольт), частота свыше 200 КГц, ток до 30 ампер.
К специальным типам диодов относят приборы, в которых используют особые свойства p-n переходов: управляемая полупроводниковая емкость - варикапы, варакторы (от слова ёмкость – «capacity », «кап»- конденсатор, «вари» - переменный); зеннеровский и лавинный пробой – стабилитроны; туннельный эффект - туннельные и обращенные диоды; фотоэффект – фотодиоды; фотонная рекомбинация носителей зарядов - светодиоды.
Варикапы – это полупроводниковые диоды, но в связи с тем, что на границе запирающего слоя располагаются положительные и отрицательные заряды, то диоды можно представлять как конденсаторы, емкость которых изменяется под воздействием приложенного напряжения.
Схемное изображение варикапа приведено на рисунке 2.15,а.
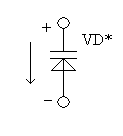
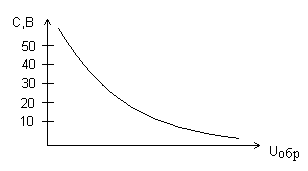
а) б)
Рис. 2.15. Схемное изображение варикапа а) и его характеристика б)
На рис.2.15, б) показана типовая зависимость величины емкости от приложенного напряжения.
Условное обозначение варикапа состоит из пяти элементов. Первый элемент обозначает материал, из которого изготовлен прибор (К - кремний). Второй элемент обозначает принадлежность диода к подклассу варикапов (В – варикап). Третий элемент – цифра, определяющая назначение варикапа(1 – для подстроечных варикапов, 2 – для умножительных варикапов). Четвертый элемент – порядковый номер разработки. Пятый элемент соответствует разбраковке по параметрам. Например, на рис.2.15,б изображена характеристика варикапа КВ117А.
Основными параметрами варикапа являются: его начальная емкость С0, добротность – QС, коэффициент перекрытия по емкости KC. Добротность варикапа определяется отношением реактивной мощности Q к мощности рассеивания P.
Коэффициент перекрытия по емкости определяется как отношение максимальной емкости Сmax варикапа к его минимальной емкости Сmin. Кроме этого, часто указывают температурный коэффициент емкости варикапа αс=ΔС/ΔТ, и предельную частоту fпред, при которой добротность QС равна 1. Добротность варикапа увеличивается с увеличением обратного напряжения и с уменьшением рабочей частоты. Графики зависимости емкости варикапа КВ117А от частоты и обратного напряжения приведены ниже.
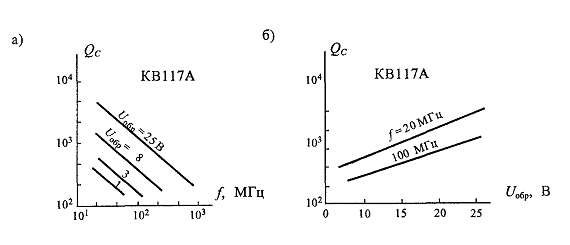
Рис. 2.16. Графики зависимости добротности варикапа от частоты и обратного напряжения
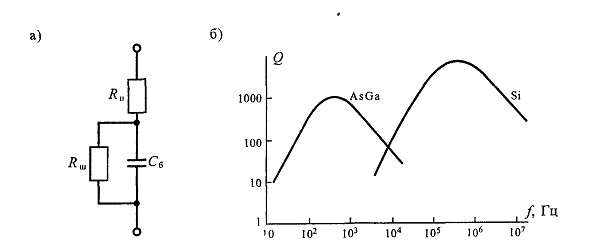
Рис.2.17. Эквивалентная схема замещения и зависимость добротности от частоты f
Варикапы находят применение в различных электронных схемах: модуляторах, параметрических усилителях и генераторах, генераторах с электронной настройкой, перестраиваемых резонансных контурах и т.д. На рис.2.18 приведена схема резонансного контура с электронной настройкой при помощи постоянного напряжения U п.
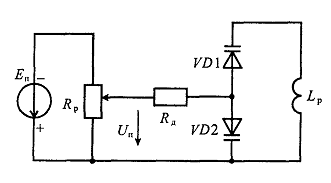
Рис. 2.18. Схема резонансного контура с электронной перестройкой при помощи варикапов
Напряжение перестройки подается в среднюю точку двух встречно последовательно включенных варикапов VD 1 и VD 2через дополнительный резистор R Д. Такое включение варикапов позволяет увеличить крутизну перестройки и устраняет необходимость применения разделительного конденсатора. Специально для таких схем промышленностью выпускались сдвоенные варикапы типов КВС111 или КВС120.
Стабилитроны.
Стабилитроны – это полупроводниковые приборы, работающие в режиме лавинного пробоя. При обратном смещении полупроводникового диода возникает лавинный пробой p-n - перехода. В этом случае в широком диапазоне изменения тока через диод напряжение на нем меняется незначительно. Для ограничения тока через стабилитрон последовательно с ним включают резистор. Если в режиме пробоя мощность, расходуемая на нем, не превышает предельно допустимую, то в таком режиме стабилитрон может работать неограниченно долго.
Напряжение стабилизации стабилитронов зависит от температуры. На типовых характеристиках (рис. 2.19) штриховой линией показано перемещение характеристик при увеличении температуры. Очевидно, что повышение температуры увеличивает напряжение лавинного пробоя при UСТ > 5В и уменьшает его при UСТ < 5В. Иначе говоря, стабилитроны с напряжением стабилизации больше 5 В имеют положительный температурный коэффициент напряжения (ТКН), а если UСТ < 5В – отрицательный. При UСТ =6…5 В ТКН близок к нулю.
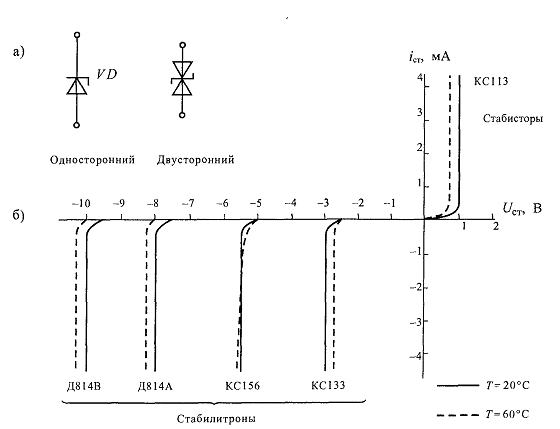
Рис.2.19. Схематическое изображение стабилитрона (а) и его вольт-амперные характеристики (б)
Иногда для стабилизации напряжения используют прямое падение напряжения на диоде. Такие приборы в отличие от стабилитронов называют стабисторами. В области прямого смещения перехода напряжение на нем имеет значение 0,7… 2 В и мало зависит от тока. В связи с этим стабисторы
позволяют стабилизировать только малые напряжения (не более 2 В). Для ограничения тока через стабистор последовательно с ним включают резистор. В отличие от стабилитронов при увеличении температуры напряжение на стабисторе уменьшается, так как прямое напряжение на диоде имеет отрицательный ТКН. Ниже приведены схемы включения стабилитрона (а) и стабистора (б).
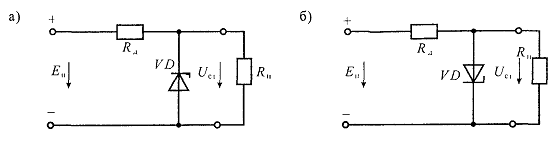
Рис. 2.20. Схемы включения стабилитрона (а) и стабистора (б)
Приведенный выше характер температурной зависимости напряжения стабилитронов обусловлен различным видом пробоя в них. В широких переходах при напряженности поля 5·104 В/см имеет место лавинный пробой. Такой пробой при напряжении на переходе более 6 В имеет положительный ТКН.
На узких переходах при большой напряженности электрического поля (более 1,4·106 В/см) наблюдается пробой, называемый зенеровским. Такой пробой имеет место при низком напряжении на переходе (менее 5 В) и характеризуется отрицательным ТКН. При напряжении на переходе от 5 до 6 В одновременно существуют два типа пробоя, поэтому температурный коэффициент близок к нулю. На рис.2.21 приведен график зависимости ТКН от напряжения стабилизации.
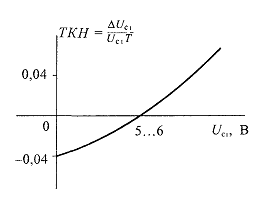
Рис. 2.21. Зависимость температурного коэффициента от напряжения стабилизации
Основными параметрами стабилитронов являются:
напряжение стабилизации U ст;
температурный коэффициент стабилизации ТКНСТ;
допустимый ток через стабилитрон I CT ДОП;
дифференциальное сопротивление стабилитрона r СТ.
Кроме того, для импульсных стабилитронов нормируется время включения стабилитрона, а для двусторонних стабилитронов нормируется несимметричность напряжений стабилизации Δ U СТ= U СТ1 – U СТ2.
Дифференциальное сопротивление пробоя – это параметр, который характеризует наклон ВАХ в области пробоя. На рис. 2.22 приведена линеаризованная характеристика стабилитрона (а), с помощью которой можно определить его дифференциальное сопротивление и построить схему замещения (б).

Рис. 2.22. Линеаризованная характеристика стабилитрона (а) и схема замещения (б)
Выходное сопротивление стабилизатора зависит от напряжения на входе U ВХ, сопротивления нагрузки R Н, сопротивления ограничения тока R 1, а также параметров стабилитрона U СТ и r ст.
Условное обозначение стабилитрона включает: материал полупроводника (К