Министерство образования республики Беларусь
Учреждение образования
«Гродненский Государственный университет имени Янки Купалы»
ФИЗИко-технический ФАКУЛЬТЕТ
КАФЕДРА ЛАЗЕРНОЙ ФИЗИКИ И СПЕКТРОСКОПИИ
Методические указания к лабораторной работе
ИЗУЧЕНИЕ ХАРАКТЕРИСТИК ПОЛУПРОВОДНИКОВЫХ ЛАЗЕРОВ И СВЕТОДИОДОВ
Лабораторная работа по курсу «Твердотельные лазеры»
Гродно 2006
ЛАБОРАТОРНАЯ РАБОТА
«Изучение характеристик полупроводниковых лазеров и светодиодов»
Цель работы: Провести сравнительный анализ электрических, оптических и спектральных характеристик импульсного и непрерывного полупроводниковых лазеров, а также светоизлучающего диода.
Краткая теория
Для полупроводников, также как и для других твердых тел, нельзя говорить об энергетических уровнях отдельных атомов, а необходимо рассматривать энергетические характеристики кристаллов в целом. Особенностью полупроводниковых лазеров является инверсия на переходах между состояниями в электронных энергетических зонах полупроводникового кристалла. Зоны возникают из-за расщепления уровней энергии валентных электронов атомов, образующих кристаллическую решетку, в сильном внутрикристаллическом поле собственных атомов кристалла.
Принцип действия полупроводникового лазера можно рассмотреть с помощью рис.1, на котором показана схема энергетических уровней полупроводникового кристалла.

а б
Рис. 1. Уровни энергии в полупроводнике
Заштрихованные области соответствуют полностью заполненным энергетическим состояниям. Fc и Fv — энергии квазиуровней Ферми.
Валентная зона и зона проводимости состоят из большого числа близкорасположенных энергетических состояний. Согласно принципу Паули, в каждом энергетическом состоянии может находиться не более одного электрона. Вероятность заполнения f(E] любого состояния определяется статистикой Ферми-Дирака:
f(E) = {1+ exp[(E-F)/kT]}-1, (1)
где Е — энергия собственного состояния, F — энергия уровня Ферми, k — постоянная Больцмана, Т — абсолютная температура.
Уровень Ферми представляет собой границу между полностью заполненными и полностью незаполненными уровнями при Т = 0 К. Когда Т стремится к нулю, то f = 1 при Е < F и f = 0 при Е > F.
В невырожденных полупроводниках уровень Ферми расположен внутри запрещенной зоны. Значит, при Т = 0 К валентная зона будет полностью заполненной, а зона проводимости — полностью пустой. При Т > 0 К уровню Ферми соответствует уровень, вероятность заполнения которого f(E) = 1/2.
Предположим для простоты, что полупроводник находится при Т = О К (рис.1, а). Если теперь электроны каким-либо образом будут переведены из валентной зоны в зону проводимости, то внутри этой зоны они за очень короткое время (~ 10~13 с) перейдут на ее самый нижний уровень. Быстрота внутризонной релаксации объясняется тем, что уровни в зоне расположены так близко друг к другу, что фактически сливаются в зону. Все электроны вблизи максимума валентной зоны также перейдут на самые нижние из незанятых уровней, так что верхушка валентной зоны будет заполнена дырками. Значит, между «дном» валентной зоны и «потолком» зоны проводимости возникает инверсия населенностей (рис. 1,6). Далее электроны переходят обратно из зоны проводимости в валентную зону, т.е. рекомбинируют с дырками, испуская при этом фотон (рекомбинационное излучение). При наличии подходящего резонатора и выполнении пороговых условий вынужденное рекомбинационное излучение приведет к лазерной генерации. Рекомбинация может не сопровождаться излучением, а приводить к нагреванию решетки (образованию фононов) или увеличению кинетической энергии свободных носителей (рекомбинация Оже).
Определим условие, необходимое для получения генерации в полупроводнике с неравновесным распределением носителей. Рассмотрим случай, когда из валентной зоны в зону проводимости заброшено много электронов. Поскольку внутризонные переходы имеют значительно большую скорость, чем межзонные, внутри каждой зоны сразу установится тепловое равновесие, но будет нарушено равновесие между электронами и дырками.
Поэтому вместо уровня Ферми вводятся два квазиуровня Ферми: Fc — для электронов и Fv — для дырок и можно лишь по отдельности говорить о вероятностях заполнения для валентной зоны fv и для зоны проводимости fc. Вероятности определяются аналогично (1) выражениями:
fv(E) = {1 + ехр [(Е - Fv)/kT]}-1, (2)
fc(E) = {1 + ехр [(Е - Fc)/kT]-1. (3)
Значения fv и fc зависят от количества электронов, заброшенных при накачке в зону проводимости. Чем больше этих электронов, тем выше Fc и ниже Fv.
Использование понятия квазиуровней Ферми сильно упрощает рассмотрение полупроводникового лазера, поскольку для каждой зоны необходима одна величина, описывающая вероятность заполнения большого числа участвующих в генерации уровней.
Условием для возникновения усиления является преобладание вынужденного испускания фотонов над их поглощением (для компенсации потерь в резонаторе). Эти процессы пропорциональны произведению числа фотонов в резонаторе q на коэффициент Эйнштейна В для рассматриваемого перехода. Скорость вынужденного излучения пропорциональна произведению вероятностей населенности верхнего уровня и отсутствия населенности нижнего уровня. Скорость поглощения пропорциональна произведению вероятностей населенности нижнего уровня и отсутствия населенности верхнего уровня.
Тогда для получения вынужденного излучения необходимо выполнение следующего условия:
Bq [fc(1-fv)-fv(1-fc)]>0 (4)
Из этого неравенства следует, что fc > fv. С учетом (2) и (3):
ехр [(Е2 - Fc)/kT] < ехр [(Е1 - Fv)/kT], (5)
где Ei и E2 — энергии верхнего и нижнего уровня соответственно. Отсюда FC—FV > Е2 — E1. Так как Е2 — E1= hν, то условие существования инверсии имеет вид:
FC-FV> hv. (6)
При межзонных переходах минимальная энергия излучения фотона равна ширине запрещенной зоны, поэтому условие (6) можно записать как:
FC-FV> Eg. (7)
Это условие нетрудно получить также из рис. 1,6 качественным путем.
Условие (6) определяет минимальное расстояние между квазиуровнями Ферми, при котором в полупроводнике может возникнуть инверсия населенностей. Если электронный квазиуровень Ферми лежит в зоне проводимости, а дырочный — в валентной зоне, то расстояние между ними больше ширины запрещенной зоны, и в полупроводнике возникает инверсия населенностей.
Накачку полупрводниковых лазеров можно производить внешним пучком электронов или пучком от другого лазера для поперечного возбуждения в объеме полупроводника. Но наиболее удобным методом возбуждения является использование полупроводника в виде диода, в котором возбуждение происходит за счет тока, протекающего в прямом направлении. В этом случае инверсия населенностей достигается в узкой (< 1 мкм) полоске между р- и n -областями перехода.
Можно выделить два основных типа полупроводниковых лазерных диодов:
лазер на гомопереходе;
лазер на двойном гетеропереходе (ДГ-лазер).
ДГ-лазеры позволяют осуществить непрерывную генерацию при комнатной температуре и потому широко применяются.
В лазерах на гомопереходе накачка осуществляется в р-п переходе, выполненном из одного полупроводникового материала (например, GaAs). р- и n -области являются вырожденными полупроводниками, т.е. концентрации акцепторов и доноров в них столь велики (~ 1018 1/см3), что уровень Ферми для р -области попадает в валентную зону, а уровень Ферми для n -области — в зону проводимости. Когда переход сформирован, а напряжение не прикладывается, оба уровня Ферми имеют одинаковые энергии (см. рис. 2,а).

а б
Рис.2. Гомогенный р-п переход
Когда прикладывается напряжение V, два уровня Ферми становятся разделенными промежутком ΔF = eV. Значит, если диод смещен в прямом направлении, зонная структура примет вид рис.2,б. Видно, что в запирающем слое перехода возникает инверсия населенностей. При прямом смещении в запирающий слой инжектируются электроны из зоны проводимости n -типа и дырки из валентной зоны р -типа. Так как ΔF ~ Еg, то V ~ Еg. Для GaAs V ~1.5 В.
На рис. 3 приведена типичная конструкция GaAs-лазера с широким р — n -гомопереходом. Видно, что диод имеет небольшие размеры. Чтобы обеспечить необходимую для генерации обратную связь, две плоскости делают параллельными друг другу посредством скалывания вдоль кристаллографических плоскостей. GaAs имеет большой показатель преломления (п = 3.6), поэтому на сколы обычно не наносят отражающие покрытия. Две другие грани кристалла делаются скошенными, чтобы между ними не возникла генерация.
Толщина активной области в направлении перпендикулярном к р — п-переходу составляет ~ 1 мкм. Но из-за дифракции поперечный размер лазерного пучка в этом направлении значительно больше толщины активной области (~ 5 мкм). Т.е. лазерный пучок далеко проиникает в р - и n -области, где испытывает сильное поглощение. Поэтому пороговая плотность тока при комнатной температуре в лазере на гомопереходе высока (~ 105 А/см2), и лазер не может работать в непрерывном режиме при комнатной температуре. Для уменьшения пороговой плотности тока необходимо понижать рабочую температуру, что накладывает ограничения на применение таких лазеров.

Рис.3 Типичный GaAs-лазер с широким р-п гомопереходом
ДГ-лазеры свободны от этих ограничений. На рис.4 приведена схема лазерной структуры с двойным гетеропереходом в GaAs.
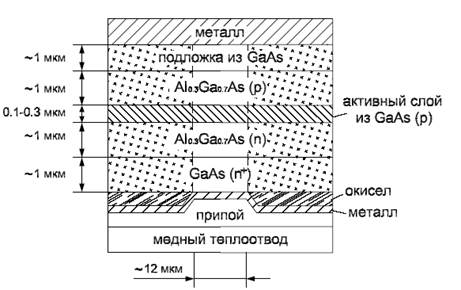
Рис.4 Схема полупроводникового ДГ-лазера.
Активная зона GaAs р -типа заключена между двумя горизонтально расположенными слоями AlGaAs, показатель преломления для которых ниже, чем для GaAs. Т.е. активная зона приобретает свойства ступенчатого световода, торцы которого ограничены с обеих сторон зеркальными гранями, получающимися при сколе кристалла. Чтобы в активной области обеспечить высокую концентрацию носителей, заполненные точками на рис.4 участки объема делают плохо проводящими с помощью бомбардировки их протонами. В такой структуре пороговую плотность тока при комнатной температуре можно уменьшить на два порядка (до ~ 103 А/см2). Таким образом, становится возможной работа в непрерывном режиме при комнатной температуре.
При токе инжекции, превышающем пороговый Iп, вдоль активного слоя возникает генерация стимулированного излучения. До этого тока существует только слабое спонтанное излучение — большая часть его поглощается в толще полупроводника, т.к. оно не носит направленный характер. Поэтому типичная зависимость выходного излучения в ДГ-лазере носит пороговый характер (рис. 5). Пороговый ток обычно составляет 50-150 мА.

Рис.5 Зависимость мощности излучения от тока
Длина волны излучения ДГ-лазера на GaAs (λ = 0.85 мкм) попадает в первое окно пропускания в оптическом волокне. Разрабатываются ДГ-лазеры, работающие на λ = 1.3 мкм и λ = 1.55 мкм, где наблюдаются два других минимума потерь оптического волокна (второе и третье окна пропускания), в которых потери существенно меньше. Для получения света с такими длинами волн используют соединения InP, GalnAsP.

Рис.6 ДГ-лазер с полосковой геометрией.
На рис. 6 приведена одна из практических конструкций ДГ-лазера. Эта полосковая конструкция имеет ряд преимуществ. Из-за малой площади полоски мал пороговый ток, и область усиления в плоскости перехода также мала. Сужение области усиления позволяет удерживать пучок в основной поперечной моде при ширине полоски < 10 мкм.
В обычном лазерном диоде генерируется одновременно несколько мод (см. рис.7): 10-20 на λ = 0.85 мкм и 5-6 на λ = 1.3 мкм. Спектральная ширина каждой моды ~ 0.2 нм (80 ГГц) при общей ширине полосы 1.2 ТГц.

Рис.7 Спектры излучения многомодовых лазерных диодов.
Используя специальные конструкции с селективными и со связанными отражателями (рис.8), можно выделить одну моду, обеспечив одночастотный монохроматический режим работы лазера.

Рис.8. Одномодовые лазеры: а — РБЗ-лазер; б — РОС-лазер; в — двухрезонаторный С3-лазер.
Селективное отражение определенной длины волны достигается в РБЗ-лазерах (с распределенными брэгговскими зеркалами), где по обеим сторонам активной области формируется гофрированный слой с избирательным коэффициентом отражения в зависимости от λ (рис.8,а). Гофр может быть нанесен на саму активную область (рис. 8,6) — распределенная обратная связь (РОС-лазер). В конструкции С3-лазера (рис.8,в) соединены два резонатора различной длины. Генерация возникает только на той λ, которая образует собственную моду для обоих резонаторов. Одномодовые лазеры обеспечивают наибольшую пропускную способность ВОЛС (волоконно оптическая линия связи).
Значительно более дешевыми и простыми в изготовлении являются светоизлучающие диоды (СИД). В СИД используется спонтанное, а не вынужденное излучение при рекомбинации электронов и дырок, инжектируемых в область р — п перехода. Путем изменения тока инжекции можно менять интенсивность света на выходе прибора, т.е. простыми средствами осуществлять оптическую модуляцию (прямая модуляция), что является одной из главных причин широкого использования СИД (как и полупроводниковых лазеров) в системах связи.
В СИД часто применяется структура с гомопереходами, т.к. нет необходимости достижения инверсии, что упрощает конструкцию и снижает стоимость. В СИД излучение выводится наружу обычно в направлении, перпендикулярном плоскости перехода через одну из областей р или п. Эта область полупроводника делается тонкой, чтобы уменьшить толщину поглощающего слоя полупроводника, через который должно пройти генерируемое в активном слое излучение. Применяются также СИД с выводом излучения параллельно поверхности р — п перехода через боковую грань прибора. Это уменьшает размеры сечения пучка и повышает эффективность вывода света. СИД мало чувствительны к перегрузкам, обладают хорошей линейной зависимостью между выходной мощностью излучения и током инжекции (рис.5). Спектр излучения СИД представляет собой гладкую кривую; ширина спектра 50-100 нм, типичный ток инжекции 50-200 мА, выходная мощность 1-5 мВт.
Ход работы
Исследование импульсного лазера
1) Подготовить полупроводниковый лазер ПКГ-КТ-1 к работе. Для этого необходимо выбрать режим работы генератора импульсов тока лазера с помощью тумблера РЕЖИМ РАБОТЫ. В случае внешнего запуска установить тумблер в положение ЖДУЩИЙ. Подсоединить выход генератора импульсов с помощью кабеля с разъемом ВНЕШНИЙ ЗАПУСК на задней стенке генератора импульсов тока лазера. При этом для запуска используются импульсы отрицательной полярности амплитудой до 4 В, длительностью 1 мкс при частоте 1-2 кГц.
В случае внутреннего запуска установить тумблер в положение АВТОКОЛЕБАТЕЛЬНЫЙ. Соединить с помощью кабелей блок питания и блок генератора импульсов тока. Проверить заземление приборов. С помощью тумблера СЕТЬ включить лазер.
2) Изучить зависимость амплитуды импульса генерации от длины волны при различных уровнях накачки. Для этого подключить ФЭУ к осциллографу, включить блок питания ФЭУ и подать на него напряжение 1300 В. Включить осциллограф. Получить генерацию и, наблюдая за ее импульсом на экране осциллографа, проследить за изменением амплитуды при вращении барабана монохроматора. Получить зависимости амплитуды импульса генерации от длины волны для 5-6 значений напряжения на выходном каскаде генератора импульсов тока в 25-70 В. При этом входную и выходную щели монохроматора в процессе измерений оставлять неизменными и равными не более 30 мкм. Чувствительность осциллографа должна быть не хуже 0.1 В/см.
Построить графики зависимостей амплитуды импульса генерации от длины волны. Определить ширину линии излучения на уровне половинной интенсивности.
3) Изучить зависимость амплитуды импульса генерации от напряжения на выходном каскаде генератора импульсов тока. Напряжение изменять в пределах от 20 до 70 В. При изменении напряжения длину волны генерации с помощью барабана монохроматора устанавливать по максимальному уровню выходного излучения. Построить график зависимости амплитуды импульса генерации от напряжения.
4) Определить длительность импульса генерации при напряжении на выходном каскаде генератора импульсов тока 60 В.