Раздел 2. Биполярные структуры
Межэлементная изоляция

Рис. 2-0 Топология ячейки n-p-n транзистора с размерами 55х100 условных микрометров в составе ИМС; вид в плане и в разрезе
Создание межэлементной изоляции в ИМС на основе
обратно-смещенного p-n перехода
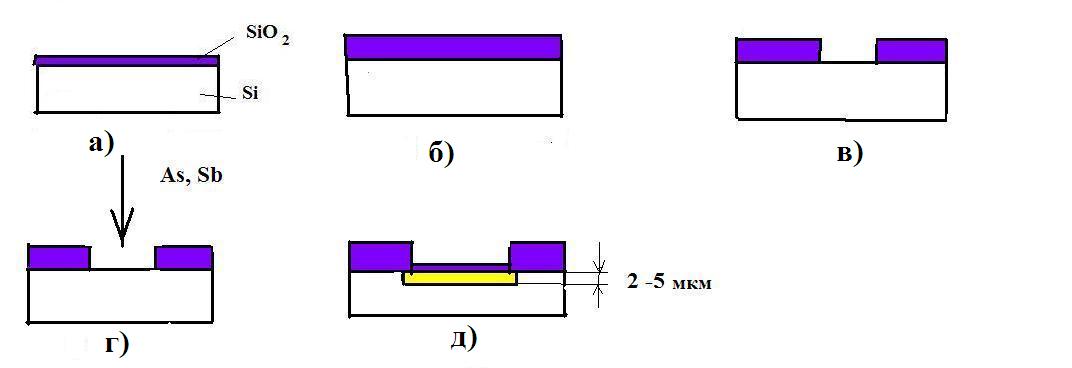
Рис. 2.1. Операции по созданию скрытого слоя. а) – исходная пластина Si после очистки, отмывки, сушки; б) – пластина с выращенным термическим окислом; в) – вскрытие окон; г) – диффузия (либо ионная имплантация) примеси для создания скрытого слоя; д) – готовая пластина с легированным n+ слоем
 .
.
Рис. 2.2. Пластина исходного Si p-типа (1) со скрытым слоем n+ (2) и эпитаксиальным n- слоем (3). По эпитаксиальному слою выращивается защитный слой SiO2 (4)

Рис. 2.3. Вскрытие окон и проведение диффузии бора для создания изолирующих областей. 1- подложка, 2- скрытый слой, 3 – эпитаксиальный слой, 4- диоксид кремния

Рис. 2.4. Формирование базовой области (6) n-p-n транзистора: вскрытие окна и поведение диффузии бора. 1 – исходная пластина Si p-типа; 2 – скрытый диффузионный n+ слой; 3 – эпитаксиальный n слой; 4 – слой диоксида кремния; 5 – изолирующие р-области; 6 – базовая область n-p-n транзистора

Рис. 2.5. Вскрытие окон, формирование эмиттерной области и области контакта коллектора. 1 – исходная пластина Si p-типа; 2 – скрытый диффузионный n+слой; 3 – эпитаксиальный слой n-типа; 4 – защитный слой диоксида кремния; 5 – диффузионные изолирующие р-области; 6 – базовая область n-p-n транзистора; 7 – область эмиттера n-типа; 8 – низкоомная область формирования контакта к коллектору

Рис. 2.6. Структура интегрального эпитаксиально-планарного n-p-n транзистора: 1 – изолирующая область, 2 – эпитаксиальный слой, 3 – скрытый слой, 4 – базовая область, 5 – эмиттерная область, 6 – коллекторная приконтактная область. Штриховкой выделена область протекания эмиттерно-колекторного тока

Рис. Э.4/1 (2.34).
Рис. 2.6-1. Доп. Структура n-p-n транзистора с двумя коллекторными областями. Операции по созданию скрытого слоя. 1) – исходная пластина Si, поступившая с фабрики, после очистки, отмывки и сушки; 2) – пластина с выращенным термическим окислом для литографии; 3) – вскрытие окон; 4) – диффузия (либо ионная имплантация) примеси для создания скрытого слоя; 5) – готовая пластина с легированным n+ слоем толщиной 2 – 5 мкм. 6) – выращивание эпитаксиального слоя поверх скрытого (смещение топологического рисунка при эпитаксии см. на рис. 2.6-3. Доп. 7) – создание изолирующих, эмиттерных, базовой и коллекторных областей проводится согласно рис. 2.3 – 2.6

Рис. 2.6-2. Доп. Смещение топологического рисунка при проведении операции эпитаксии. А – исходный топологический рисунок в виде прямоугольника перед проведением эпитаксии (слева) и его изменение после проведения технологической операции: смещение на расстояние L и искажение (см. справа). Б - поперечный разрез сечения стандартной эпитаксиальной структуры, используемой при производстве ИМС. Образование ступеньки в области скрытого слоя обусловлено различными скоростями окисления сильно легированного n+ скрытого слоя и низкоомного р-слоя подложки

Рис. 2.9. Схема включения паразитного р-п-р транзистора

Рис. 2.10. Структура транзистора с диэлектрической изоляцией

Рис. 2.11. Трехмерное изображение n-p-n транзистора с совмещенной изоляцией
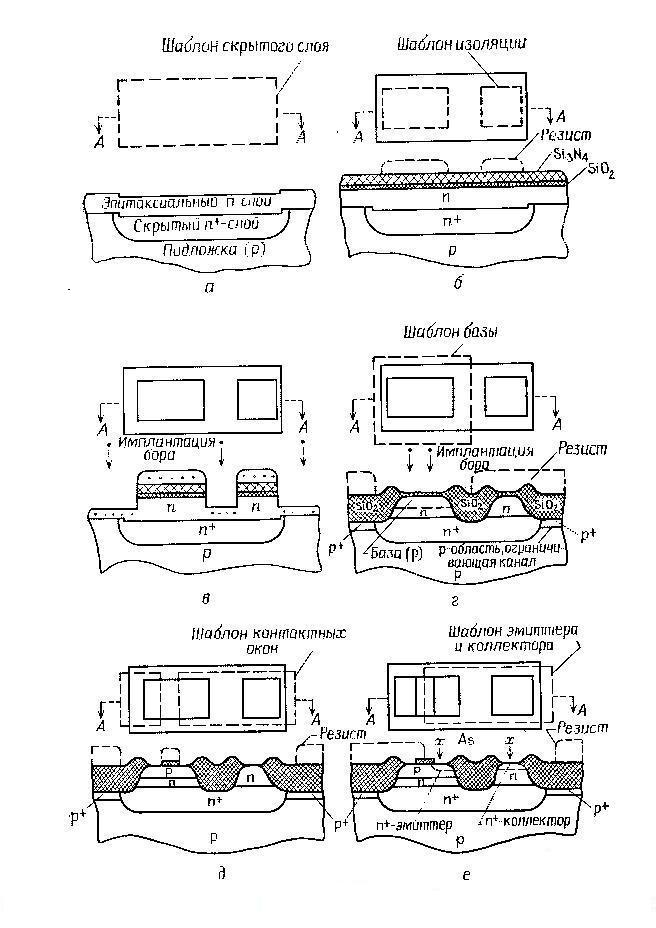
Рис. 2.12 а. Стандартный технологический процесс: создание скрытого слоя, образование ступеньки при травлении (разные скорости травления n+-слоя и р-подложки), выращивание эпитаксиального n-слоя.
Рис. 2.12 б. Окисление структуры, нанесение по окислу нитрида кремния(препятствует дальнейшему окислению нижележащего кремния). Определение границ будущих изолирующих областей. Над будущими активными областями прибора литографией формируются островки из резиста.

Рис.2.12 в. В областях, где отсутствует защитный слой резиста, проводят травление: сначала травится пленка нитрида кремния, затем SiO2, после чего вытравливается эпитаксиальный слой ровно на половину своей толщины. В вытравленные области проводится имплантация ионов бора (увеличивается концентрация дырок, что исключает в дальнейшем образование канала инверсной проводимости из-за существования в окисле встроенного положительного заряда).
Рис.2.12 г. Удаляется резист, проводится операция окисления структуры. Окисел растет только над теми областями, где отсутствует защитная пленка Si3N4. Режим выбирается таким, что незащищенная эпитаксиальная пленка окисляется на оставшуюся половину своей толщины, выращенный окисел «разрезает» эпитаксиальный слой и окружает диэлектрической изоляцией структуру с будущим прибором. При выращивании окисла ионы бора диффундируют в подложку, образуя р+-слой ограничителей каналов проводимости. После окисления вытравливается пленка Si3N4, слой окисла остается.
Существенно то, что все высокотемпературные операции по созданию изоляции проводились до создания активных областей прибора, которые, что немаловажно, были все время закрыты защитным окислом.
Имплантацией бора в левой части структуры (левая n-эпитаксиальная область) формируется р-база транзистора, правая n-эпитаксиальная область перед имплантацией бора закрывается резистом.

Рис. 2.12 д. С помощью шаблонов (масок) формируются контактные окна: в середине над областью р-базы оставляется полоска из окисла, закрытая сверху резистом, слева и справа от разделительной полоски окисел вытравливается, над правой, коллекторной областью прибора, окисел стравливается полностью. Также резистом защищаются области толстого диэлектрика ограничителей канала проводимости.
Рис. 2.12.е. Резистом закрывается область, расположенная слева от разделительной полоски над базой прибора, здесь будет сформирован контакт к базовой области. Имплантацией ионов As+ формируется ´n+-область эмиттера (правее разделительной полоски, расположенной в середине базы). Одновременно формируется контакт к коллекторной области (правый n-эпитаксиальный слой в структуре, ниже которого расположен n+ скрытый транспортный слой).
На следующем этапе формируется контакт к р-базе транзистора: в защитном слое окисла слева вскрывается окно и наносятся силицид металла (Ni, Co), затем Аl, который с р-Si образует омический контакт.
Существенным в данной структуре является то, что разделение между эмиттерной и базовой областями определяется не этапом совмещения масок, а заданным минимальным расстоянием между металлическими контактами, что позволяет уменьшить площадь транзистора и снизить сопротивление базы. Перед нанесением слоя металлизации и формированием рисунка межсоединений (пленка алюминия с предварительно наносимым подслоем силицида титана) на поверхность структуры наносится пленка нитрида кремния для защиты от ионов натрия.
В данном варианте соседние элементы ИМС изолированы по периметру областями диоксида кремния, а снизу – обратно-смещенным р-n переходом.
(См. рис. 2.11)
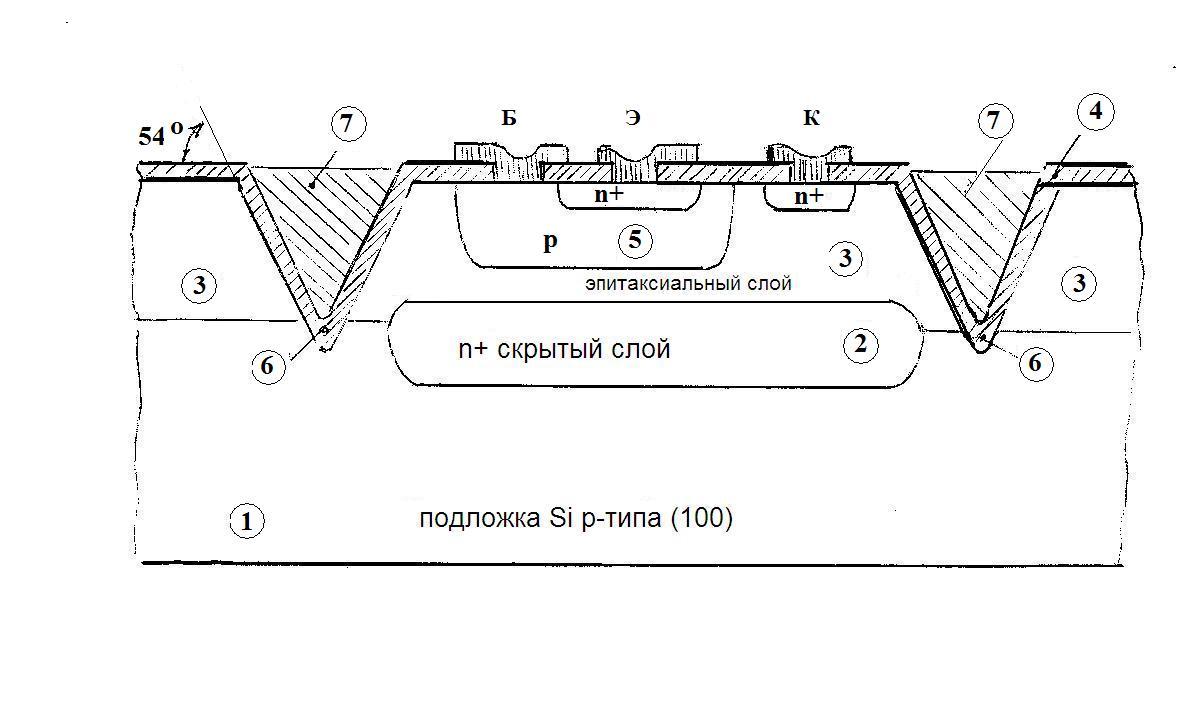
Рис. 2.13. Изоляция элементов ИМС V-образными канавками. 1 – кремниевая пластина p-типа проводимости с ориентацией (100); 2 – скрытый n+ слой; 3 – эпитаксиальный n слой; 4 – защитная пленка диоксида кремния на поверхности пластины; 5 – базовая область n-p-n транзистора; 6 – термически выращенный слой SiO2 на боковых поверхностях канавок; 7 – поликристаллический кремний, заполняющий канавки для выравнивания лицевой поверхности пластины кремния

Рис. 2.14. Схема установки реактивного ионного травления. 1 – кварцевый реактор; 2 – подложки кремния; 3 – ВЧ генератор с частотой 13,56 МГц, либо 30 кГц; 4 – подача смеси инертного (аргона) и реактивного газа; 5 – к системе откачки реактора; 6 – область ВЧ разряда

Рис. 2.15. Травление монокристаллического кремния с воздействием УФ облучения
. 
Рис. 2.16. Формирование U-образной канавки (щелевая изоляция). 1 – подложка р-типа; 2 – скрытый n+ слой; 3 – эпитаксиальный n-слой; 4 – защитный поверхностный слой нитрида кремния с алюминиевой светозащитной маской; 5 – вытравленная канавка; 6 – термически выращенный на боковой поверхности канавки диоксид кремния

Рис. 2.17. Формирование V-образной канавки. (1) – подложка р-типа с ориентацией (100); (2) – скрытый n-слой; (3) – эпитаксиальный n-слой; (4) – защитный поверхностный слой; (5) – вытравленная канавка; 6 – термически выращенный на поверхности канавки окисел; (7) – поликристаллический кремний, выравнивающий лицевую поверхность

Рис. 2.19. Схема включения n-p-n транзистора в активном режиме

Рис. 2.20. Используемые на практике схемы включения транзистора. а) – с общим эмиттером, б) с общей базой, в) с общим коллектором

Рис. 2.21. Выходные характеристики транзистора, включенного по схеме c ОЭ

Рис. 2.22. Схема инвертора (а) и выбор рабочей точки на семействе выходных характеристик (б)

Рис. 2.23. Эмиттерно-связанный логический элемент с переключением токов

Рис. 2.24. Диаграмма, поясняющая работу токового зеркала

Рис. 2.25. Принципиальная схема ЭСЛ-вентиля ИЛИ/ИЛИ-НЕ

Рис. 2.30. Эквивалентная схема структуры И2Л. а – с p-n-p транзистором, б – p-n-p транзистор заменен источником тока

Рис. 2.30-2. Взаимное расположение активных областей транзисторов
p-n-p и n-p-n проводимостей, соединенных согласно эквивалентной схеме И2Л структуры, представленной на рис. 2.30

 в)
в)
Рис. 2.31. Базовый вентиль И2Л логики. Вид сверху (а), и поперечное сечение структуры (б). Цветом выделены совмещенные области горизонтального, p-n-p и вертикального n-p-n транзисторов

Рис. 2.32. Варианты топологии, обеспечивающие различные скорости переключения. а – коллектор К1 срабатывает раньше, чем коллектор К2; б – коллектор К1 и К2 срабатывают одновременно; в – конфигурация с максимальным быстродействием

Рис. 2.35. Структура горизонтального p-n-p транзистора. Изготавливается в едином технологическом цикле с интегральными n-p-n транзисторами на подложке р-типа, скрытым n+- и эпитаксиальным слоями

Рис. 2.37. Структура подложечного p-n-р транзистора

а) б) в)
Рис. 2.40. Структура (а), эквивалентная электрическая схема (б) и условное обозначение (в) транзистора с диодом Шотки

Рис. 2.41. Временная диаграмма, отражающая изменение напряжения на коллекторе транзистора с диодом Шоттки (а) и обычного n-p-n транзистора (б)

Рис. 2.42. Структуры интегральных диодов а) закорочен БК переход, б) закорочен БЭ переход, в) закорочен ЭК переход, г)используется Б-Э переход, д) используется Б-К переход
Таблица 2.1
Параметры интегральных диодов
| Параметры | Вариант включения переходов | ||||
| БК–Э | БЭ–К | Б–ЭК | Б–Э | Б–К | |
| Uпр, В | 7…8 | 40…50 | 7…8 | 7…8 | 40…50 |
| Iобр, нА | 0,5…1,0 | 15…30 | 20…40 | 0,5…1,0 | 15…30 |
| Cд, пФ | 0,5 | 0,7 | 1,2 | 0,5 | 0,7 |
| Cо, пФ | 1,2 | ||||
| tв, нс |
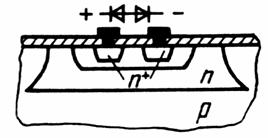
Рис. 2.43. Вертикальная структура интегрального стабилитрона на основе двух переходов