Барьерная (или зарядная) емкость обусловлена нескомпенсированным зарядом ионизированных атомов примеси, сосредоточенными по обе стороны от границы перехода. Запирающий слой выступает как диэлектрик конденсатора. Эти объемные заряды создают электрическое поле перехода. При увеличении обратного напряжения область пространственного заряда и сам заряд увеличиваются, причем непропорционально. Эта емкость использована в варикапах.
Барьерная емкость составляет десятки - сотни пикофарад и определяется как
 , и равна
, и равна  , где Sпер – площадь перехода
, где Sпер – площадь перехода
При прямом напряжении, кроме барьерной емкости, существует диффузионная емкость. Диффузионная емкость характеризует накопление подвижных носителей зарядов в p - и n - областях при прямом напряжении на переходе, когда носители зарядов в большом количестве диффундируют (инжектируют) через пониженный потенциальный барьер и, не успев рекомбинировать, накапливаются в p - и n - областях.
Диффузионная емкость значительно больше барьерной Сдиф>1000pF.
При прямом напряжении на переходе общая емкость определяется в основном диффузионной емкостью, а при обратном напряжении – барьерной.

Рисунок 9 - Зависимость емкости p-n-перехода от приложенного напряжения
При прямом включении есть диффузная емкость Сдиф=Тр/φТ, где Тр– время жизни неосновных носителей. Не зависит от U.  .
.
ϕ O = ϕ M − ϕ Π {\displaystyle \phi _{O}=\phi _{M}-\phi _{\Pi }}
Когда в 1949 году был создан первый транзистор, физика твердого тела стала необходимым технологическим инструментом. Твердотельные приборы не только радикально изменили электронику, но и привели к качественным сдвигам в человеческом обществе – к технологической революции. Она началась с того, что специалисты стали задумываться, как уменьшить размеры транзисторов и сделать сложные электронные устройства, такие, как ЭВМ, более компактными. Сегодня с помощью изощренных технологических приемов на одном квадратном миллиметре кремниевого кристалла формируется несколько миллионов элементов – транзисторов, конденсаторов, сопротивлений. Иными словами, размеры отдельных элементов стали много меньше микрона – тысячной доли миллиметра.
И вот тогда на передний план выдвинулись проблемы физики поверхности. По мере того, как кремниевая пластинка – «чип», который служит основным элементом современных ЭВМ, становился все миниатюрнее, отношение его поверхности к объему быстро возрастало. Поэтому поверхность чипа, а не его объем стала играть определяющую роль и при выполнении им логических функций, и при взаимодействии с другими элементами.
 Поверхностные состояния образуются не только на границе между твердым телом и вакуумом. Поверхность раздела может быть внутренней, например, разграничивающей два разных полупроводниковых кристалла. Такую поверхность стали называть гетеропереходом, а пару разделяемых ею полупроводников – гетероструктурой.
Поверхностные состояния образуются не только на границе между твердым телом и вакуумом. Поверхность раздела может быть внутренней, например, разграничивающей два разных полупроводниковых кристалла. Такую поверхность стали называть гетеропереходом, а пару разделяемых ею полупроводников – гетероструктурой.
Под гетеропереходом понимается контакт двух различных по химическому составу полупроводников, при котором кристаллическая решетка одного материала без нарушения периодичности переходит в решетку другого материала.
Рис. Схема энергетических состояний в кристалле, ограниченном поверхностью
Гетеропереходы,представляющие контакт двух разнородных полупроводников с различной шириной запрещенной зоны и различной степенью легирования, получили практическое применение в светодиодах, лазерах, фотодиодах, полевых и биполярных транзисторах, что позволяет улучшить их специфические свойства, значительно увеличить их рабочие частоты в сверхвысокочастотных (СВЧ) аналоговых и сверхскоростных цифровых ИС. Наиболее освоенными являются гетеропереходы между твердыми растворами полупроводниковых соединений AlxGa1-xAs-GaAs, GaAsxP1-x-GaAs, GaAsxP1-x-GaP, GaxIn 1-x As-InP и др. Используя для создания гетеропереходов материалы с высокой подвижностью электронов (например, InGaAs/lnAIAs), удается создавать приборы, которые уже переступают знаковый рубеж 1 ТГц https://www.club155.ru/heterojunction-materials
Свойства полупроводниковых материалов при T = 300 K
| Полу-провод-ник | Ширина запрещенной зоны, эВ | Постоянная решетки,Å | Подвижность электронов, см2/В∙см | Подвижность дырок, см2/В∙см | Максимальная скорость дрейфа электронов |
| InSb | 0,17 | 6,48 | > 5∙107 | ||
| PbTe | 0,32 | 6,46 | - | ||
| InAs | 0,35 | 6,06 | 3,5∙107 | ||
| PbS | 0,41 | 5,94 | - | ||
| Ge | 0,66 | 5,65 | 0,6∙107 | ||
| α-InN | 0,69 | a = 3,55 c = 5,7 | 4,1∙107 | ||
| β-InN | 0,6 | 4,98 | - | - | - |
| GaSb | 0,73 | 6,1 | 2,5∙107 | ||
| Si | 1,12 | 5,43 | 1,0∙107 | ||
| InP | 1,34 | 5,87 | 2,7∙107 | ||
| GaAs | 1,42 | 5,65 | 1,9∙107 | ||
| AlSb | 1,63 | 6,14 | - | ||
| Se | 1,74 | a = 4,36 c = 4,96 | - | - | - |
| AlAs | 2,15 | 5,66 | - | ||
| GaP | 2,27 | 5,45 | - |
При создании электронных приборов на основе гетеропереходов в первую очередь добиваются того, чтобы в кристаллической решетке из двух материалов, составляющих гетеропереход, не было дефектов. Для этого необходимо, чтобы два материала имели идентичную кристаллическую структуру и близкие периоды решеток. В этом случае структура получается без напряжений. Дополнительным ограничением выступает необходимость согласования коэффициентов термического расширения используемых материалов с тем, чтобы обеспечить стабильность кристаллической структуры гетероперехода в требуемом рабочем диапазоне температур. Для создания гетероперехода необходимо подбирать подходящие пары.
Барье́р Шо́ттки (Schottky barrier)) — потенциальный барьер, образующийся в приконтактном слое полупроводника, граничащего с металлом, равный разности энергий, затрачиваемых на удаление электрона из твёрдого тела или жидкости в вакуум, другой металл или полупроводник.
При сближении полупроводника n -типа с металлом, имеющим большую, чем у полупроводника, энергию отрыва электрона ϕ {\displaystyle \phi }φм, металл заряжается отрицательно, а полупроводник — положительно, так как электронам легче перейти из полупроводника в металл, чем обратно. Напротив, при сближении полупроводника p -типа с металлом, обладающим меньшей ϕ {\displaystyle \phi }энергией отрыва электрона, металл заряжается положительно, а полупроводник — отрицательно. При установлении равновесия между металлом и полупроводником возникает контактная разность потенциалов: Uk = (φм – φп)/e, где e – заряд электрона. Из-за большой электропроводности металла электрическое поле в него не проникает, и разность потенциалов U k {\displaystyle U_{k}} Uк создается в приповерхностном слое полупроводника.
Барьер Шоттки обладает выпрямляющими свойствами. Ток через него при наложении внешнего электрического поля создается почти целиком основными носителями заряда, что означает отсутствие явления инжекции, накопления и рассасывания зарядов.
В компактной форме ВАХ записывается в виде:  ,
,
где υ 0– тепловая скорость электронов, n s– поверхностная концентрация в полупроводнике на границе с металлом, VG –контактная разность потенциалов
На рисунке 2.7 приведена вольт‑амперная характеристика барьера Шоттки, имеющая ярко выраженный несимметричный вид. В области прямых смещений ток экспоненциально сильно растёт с ростом приложенного напряжения. В области обратных смещений ток от напряжения не зависит. В обоих случаях, при прямом и обратном смещении, ток в барьере Шоттки обусловлен основными носителями – электронами, что означает отсутствие явления инжекции, накопления и рассасывания зарядов. Контакты металл — полупроводник с барьером Шоттки широко используются в сверхвысокочастотных детекторах, транзисторах и фотодиодах.


Рис. 2.7. Вольт-амперная характеристика барьера Шоттки
Когда планарно-эпитаксиальный транзистор находится в режиме насыщения, в базовой и высокоомной коллекторной областях накапливается заряд неосновных носителей. При подаче запирающего импульса базового тока неосновные носители рассасываются в течение некоторого времени за счет вытекания в базовый и коллекторный контакты и рекомбинации. Это время, необходимое для рассасывания неосновных носителей заряда, составляет 10—100 нc и является серьезным ограничением при разработке быстродействующих ИМС.
Диод Шоттки в интегральном исполнении представляет собой контакт металла с высокоомным полупроводником n-типа, в качестве которого используется коллекторная область транзистора. При соответствующей очистке поверхности полупроводника на границе полупроводник — металл возникает обедненный слой и образуется барьер Шоттки. Такой контакт обладает выпрямляющими свойствами и работает как диод. По сравнению с диодом на р-n-переходе диод Шоттки характеризуется низкими значениями падения напряжения в открытом состоянии (около 0,35—0,45 В) и временем выключения, которое обычно не превышает 0,1 нc.
При включении диода Шоттки параллельно коллекторному переходу транзистора ограничивается степень насыщения транзистора. При интегральном исполнении транзистор и диод составляют единую структуру, которую называют транзистором с барьером Шоттки.

Основные технологические процессы изготовления p-n -переходов
Электронно-дырочные переходы в зависимости от технологии изготовления разделяются на точечные, сплавные, диффузионные, эпитаксиальные, планарные и другие.
Точечные переходы
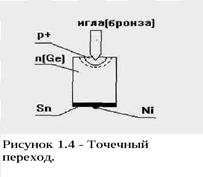

К полированной и протравленной пластине монокристаллического полупроводника n-типа подводят иглу, например из бериллиевой бронзы с острием 20-30 мкм. Затем через контакт пропускают кратковременные мощные импульсы тока. Место контакта разогревается до температуры плавления материала зонда, и медь легко диффундирует внутрь полупроводника образуя под зондом небольшую по объему область p-типа. Электронно-дырочный переход образуется в результате диффузии акцепторной примеси из расплава зонда и возникновения под ним области p-типа в кристаллической решетке полупроводника n-типа. Точечные переходы использовались в первых РЛС.
Сплавные переходы получают выплавлением примеси в монокристалл полупроводника (рис. 1.5.). Монокристалл германия n-типа распиливают на пластины толщиной 200-400 мкм и затем после травления и полировки разрезают на кристаллы площадью в два-три миллиметра и больше. На кристаллы, помещенные в графитовые кассеты, накладывают таблетку акцепторного материала, чаще всего индия. Затем кассета помещается в вакуумную печь, в которой таблетка индия и слой германия под ней расплавляются. Нагрев прекращается и при охлаждении германий кристаллизуется, образуя под слоем индия слой p-типа. Застывшая часть индия представляет собой омический (невыпрямляющий) контакт, на нижнюю часть пластины наносят слой олова, который служит омическим контактом к германию n-типа. К индию и олову припаивают выводы обычно из никелевой проволочки.
Диффузионные переходы получают диффузией примесного вещества в исходную полупроводниковую пластинку (рис. 1.6.).
При планарном методе диффузии переходы получают, используя изолирующий слой, препятствующий диффузии примесей. На поверхности кремния n-типа выращивается тонкий (около 3 мкм) слой двуокиси кремния SiO2(рис. 1.6.). Фотолитографическим методом в определенных местах окисла получают «окна», через которые диффундирующие примеси проникают в n-слой, образуя переход.
Методы диффузии обеспечивают получение плавных p-n переходов и используются при изготовлении интегральных микросхем.

Эпитаксиальные переходы образуются ориентированным формированием слоя монокристаллического полупроводника на исходном монокристалле-подложке (рис. 1.7.).

1 – p-n-переход; 2 – p-область; 3 – слой высокоомного полупроводника; 4 – подложка.
Рисунок 1.8 - Эпитаксиальный переход, образованный по планарно-эпитаксиальному методу.
Для проведения эпитаксии необходимо создавать условия для конденсации атомов осаждаемого вещества на поверхности подложки. Конденсация происходит перенасыщением пара или жидкого раствора, а также при испарении осаждаемого вещества в вакууме в специальных реакторах. При наращивании плёнки с проводимостью противоположной подложке, образуется p-n-переход.
При изготовлении интегральных схем широко используют планарно-эпитаксиальный метод, в котором путём наращивания на подложку 4 из низкоомного кремния наносят тонкий слой 3 высокоомного полупроводника, повторяющего структуру подложки. Этот слой, называемый эпитаксиальным, покрывают плотной защитной пленкой SiO2 толщиной 1 мкм (рис. 1.8.). В плёнке протравливают «окно», через которое путем диффузии бора или алюминия создается p-n-переход, выход которого на поверхность оказывается сразу же надежно защищенным пленкой окисла.
Ионное легирование и молекулярно-лучевая эпитаксия - методы формирования p-n-переходов. Ионное легирование заключается в бомбардировке ионами примеси нагретой полупроводниковой пластины, находящейся в вакууме. Ионы предварительно разгоняются до определенной скорости и, внедряясь в пластину полупроводника, играют роль донорных или акцепторных примесей.
Оксидное маскирование обеспечивает проникновение примеси только в определенные участки пластины, защитив от них остальную ее поверхность. В полупроводниковых структурах на основе кремния в качестве маски используется диоксид кремния SiO2, который является хорошим изолятором и обладает по сравнению с чистым кремнием значительно меньшей скоростью диффузии в него примесей. Для получения пленки оксида кремниевую пластину нагревают до 900—1200 º С в атмосфере кислорода. После охлаждения участки полупроводника, которые должны подвергаться воздействию примесей, освобождают от пленки окисла травлением.
Фотолитография - э то процесс получения на поверхности пленки оксида необходимого рисунка расположения окон. Оксидную пленку покрывают фоторезистом (светочувствительным слоем) и экспонируют (засвечивают) ультрафиолетовыми лучами через маску, на которой выполнен рисунок в виде прозрачных и непрозрачных участков. Участки фоторезиста, подвергнувшиеся освещению, оказываются нерастворимыми, а с неосвещенных участков фоторезист удаляют растворителем. Травление пленки диоксида кремния производят плавиковой кислотой, в результате в оксидной пленке образуются окна, через которые производится диффузия, эпитаксиальное наращивание или ионное легирование.