Технологический процесс изготовления FinFET-транзистора предусматривает формирование методами фотолитографии плавника- вставки толщиной 20 нм и высотой 180 нм. Области стока-истока изготовляются с помощью ионной имплантации под углом 45о с четырех сторон пластины. Также создаются транзисторы с длиной канала порядка 30 нм. Пороговое напряжение транзистора составляет порядка 0.1 В, управляющий ток не превышает 60 нА/мкм. Пороговое напряжение насыщения составляет 0,15 В при рабочем токе 55 нА/мкм и токе утечки 7 нА/мкм. Сверху плавника канал не возникает, т.к. там находятся технологические 50 нм окисла кремния плюс 50 нм нитрида кремния (см. ниже рис 3.6).
Одной из разновидностей FinFET-транзистора является конструкция, представленная на рис. 3.6. В этой конструкции с длиной канала менее 20 нм размеры кремниевой вставки задаются промежутками между поликремниевыми затворами. Области истока-стока формируются в процессе фотолитографии.
Структура затвора состоит из термически выращенной пленки оксинитрида толщиной 2,4 нм и SiGe толщиной 400 нм. Затворы длиной Lзатв, формируют каналы, которые индуцируются напряжением та затворах вдоль обеих сторон.
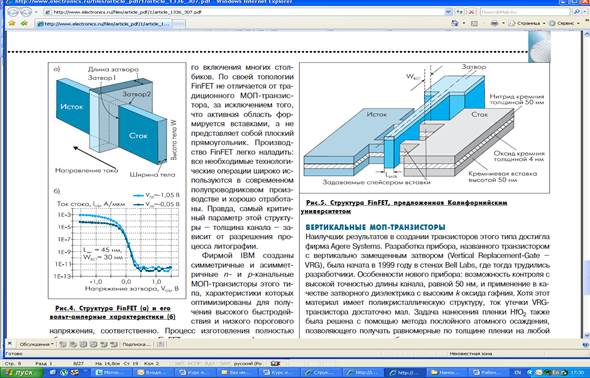
Рис. 3.6. Структура FinFET-транзистора с двойным затвором SiGe: 1— нитрид кремния толщиной 50 нм; 2 — оксид кремния толщиной 50 нм; 3 - кремниевая вставка толщиной 50 нм; 4 — задаваемые спейсером вставки.

Рис. 3.5. ВАХ FinFET- транзистора: Lзат — длина затвора; а — ширина тела; W - высота тела.
Предложена модифицированная FinFET-структура. В ней полевой транзистор с двойным затвором объединен со структурой КНИ МОП-транзистора с одним затвором. Прибор получил название (Invertered-TFET или ITFET) — полевой транзистор опрокинутой Т-образной формы. По сравнению с обычным FinFET он занимает меньшую площадь кристалла и эффективен для ячеек памяти СОЗУ.
Транзистор с тройным затвором (Tri-Gate transistor) (рис. 3.7) предложен конструкторами нанотранзисторов фирмы Intel. Особенностью такой конструкции является трехмерная структура, представляющая собой "микробрусок", который с трех сторон облегают изолятор и проводник затвора. Подобная структура позволяет посылать электрические сигналы как по верхней части "бруска", так и по обеим его вертикальным сторонам. "Микробрусок" превращается в исток (сток) за пределами затвора. Увеличенная таким образом площадь, доступная для прохождения сигнала, дает возможность пропускать на 20% больше тока по сравнению с традиционной планарной конструкцией, занимающей аналогичную площадь. Подобная технология позволяет создавать транзисторы, которые работают на частотах переключения порядка терагерц и обладают способностью к масштабированию.
Тройной затвор строится на сверхтонком слое полностью обедненного кремния. В результате обеспечиваются малый ток утечки, высокое быстродействие в процессах переключения и значительно сокращается потребляемая мощность.Он имеет наращенные сток и исток, позволяющие избежать роста сопротивления при уменьшении размеров транзистора. Кроме того, в новом транзисторе может использоваться диэлектрик High K, дополнительно снижающий ток утечки затвора.
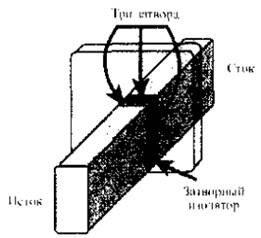
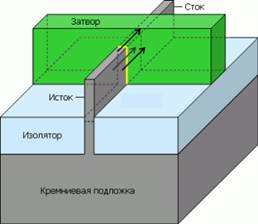
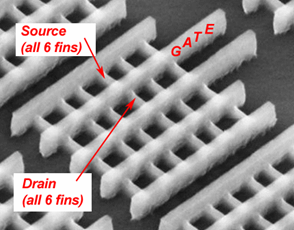
|
Рис. 3.7 Структура TriGate транзистора.
Чтобы обеспечить условия полного обеднения подложки носителями, необходимо подобрать соответствующее соотношение ширины и высоты тела транзистора — кремниевой вставки. Оптимальным считается равенство ширины и высоты тела-вставки и длины затвора транзистора. Удалось создать р- и п -канальные транзисторы с длиной затвора 60 нм. Новый прибор превосходит транзисторы с размерами 65 нм по мощности переключения на 35%, а также по времени выхода в режим насыщения.
Рассмотренные альтернативные транзисторные структуры позволяют надеяться на дальнейшее развитие микроэлектроники, а также на становление наноэлектронных схемотехнических вычислительных устройств и систем. В частности, на основе FinFET-транзисторов энергозависимая flash-память емкостью 32 Гбит. Компания Intel планирует освоить микросхемы на базе этих структур с топологическими нормами 32 нм.
Обратим внимание на любопытный факт. Первые транзисторы, созданные шесть десятилетий назад, имели трехмерную структуру. Их вытесняли планарные транзисторы, позволившие получить высокую степень интеграции. Трехзатворные транзисторы вернули разработчиков снова в мир трехмерной микроэлектроники. Хотя изготовление трехмерных транзисторных структур является весьма сложным технологическим процессом, затраты не повлияют на стоимость интегральных схем.
3. Гетеротранзистор представляет собой транзистор, содержащий один или несколько гетеропереходов.
Зонные диаграммы гетеропереходов имеют разрывы зон, которые можно использовать для ограничения движения носителей заряда в направлении, перпендикулярном плоскости гетероперехода. В гетеропереходах носители заряда ведут себя по-разному в зависимости от направления движения, поэтому в направлении, перпендикулярном слою, энергетический спектр носителей заряда имеет дискретный характер, и имеет место размерное квантование. В двух других направлениях спектр носит непрерывный характер, и сохраняется зонная структура.
Технология полупроводниковых гетероструктур позволяет создавать системы с пониженной размерностью. Если движение носителей заряда ограничено в одном направлении, то формируется квантовая яма, в которой образуется двумерный электронный газ. Если ограничение движения носителей происходит в двух направлениях, то формируется квантовая нить. Нуль-мерная квантовая точка формируется в случае ограничения движения носителей по трем направлениям.
На рисунке представлена конструкция полевого гетеротранзистора на основе AlGaAs-GaAs.
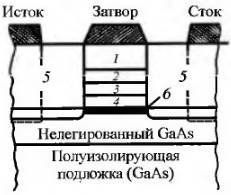
Рисунок - Схема полевого гетеротранзистора: 1 - варизонный слой; 2, 4 - нелегированный слой; 3 - слой n-; 5 - область ионного легирования n-типа; 6 - 2D-электроны с высокой подвижностью
Структура гетеротранзистора выращена методом молекулярно-лучевой эпитаксии по технологии самосовмещения. В 2D-слое имеются подвижные электроны с эквивалентными значениями подвижности 6500 см^2/(B*c) при 300 К и 120000 см^2/(В*с) при 77 К. Соответствующие значения поверхностной плотности электронов составили 5,4*10^11 см^(-2) и 7,8*10^11 см^(-2) соответственно. Технология формирования такой структуры включила в себя формирование затвора с барьером Шоттки на основе силицида металла, ионную имплантацию, отжиг, формирование омических контактов.
Понижение размерности повышает роль межэлектронных взаимодействий. В двумерном электронном газе, в частности, наблюдается целочисленный и дробный квантовые эффекты Холла. Обнаружены квазичастицы с электрическим зарядом, равным одной трети заряда электрона. В одномерных проводниках наблюдается квантование проводимости в отсутствие магнитного поля, возникает элементарные возбуждения с дробным электрическим зарядом.
Различают несколько видов гетеротранзисторов.
4. 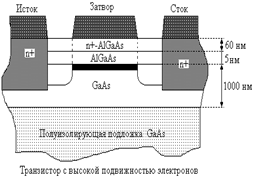 Требование высокой проводимости канала транзистора для обеспечения быстродействия связано с высокой степенью легирования примесью. Повышение степени легирования области канала необходимо и при масштабировании транзисторов с целью повышения степени интеграции и быстродействия, а также снижения энергии переключения. Однако, повышение концентрации примеси приводит к снижению подвижности электронов вследствие их рассеянии на ионах примеси. Поскольку подвижность в значительной степени определяет время пролета канала, то требование увеличения подвижности при одновременном повышении степени легирования является противоречивым.
Требование высокой проводимости канала транзистора для обеспечения быстродействия связано с высокой степенью легирования примесью. Повышение степени легирования области канала необходимо и при масштабировании транзисторов с целью повышения степени интеграции и быстродействия, а также снижения энергии переключения. Однако, повышение концентрации примеси приводит к снижению подвижности электронов вследствие их рассеянии на ионах примеси. Поскольку подвижность в значительной степени определяет время пролета канала, то требование увеличения подвижности при одновременном повышении степени легирования является противоречивым.
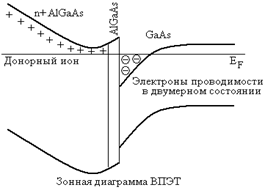 Преодолеть это противоречие удалось в гетероструктурных полевых транзисторах Шоттки. На рисунке приведено схематическое изображение транзистора на основе многослойной структуры AlGaAS – GaAs. Такой транзистор получил название - транзистор с высокой подвижностью электронов - ВПЭТ
Преодолеть это противоречие удалось в гетероструктурных полевых транзисторах Шоттки. На рисунке приведено схематическое изображение транзистора на основе многослойной структуры AlGaAS – GaAs. Такой транзистор получил название - транзистор с высокой подвижностью электронов - ВПЭТ
Основной принцип повышения быстродействия ВПЭТ состоит в пространственном разделении подвижных носителей заряда и породивших их примесных атомов.
Пусть имеется гетеропереход на основе GaAs и материала с большей шириной запрещенной зоны, например – AlGaAs. В последний введена донорная примесь. Так как дно зоны проводимости у GaAs лежит ниже чем у AlGaAs, то электроны создаваемые донорной примесью будут из n+ AlGaAs проникать в зону проводимости GaAs. Поэтому в n+ AlGaAs образуется область пространственного неподвижного заряда. В то же время электроны проводимости GaAs электростатически притягиваются этой областью положительного заряда. В результате чего в GaAs на границе раздела с AlGaAs формируется область отрицательного подвижного пространственного заряда и распределение потенциала в области гетероперехода примет вид как показано на рисунке.
Электроны зоны проводимости в GaAs оказываются заключенными в потенциальный колодец с формой близкой к треугольной. Он расположен вблизи с границей раздела с AlGaAs. На границе раздела GaAs и AlGaAs между потенциальным барьером и дном зоны проводимости GaAs возникает стоячая волна электронов проводимости. Поэтому указанные электроны утрачивают способность движения в ортогональном границе раздела направлении. Создаются двумерные условия. Важно учитывать, что электроны зоны проводимости и донорные ионы пространственно разделены, поэтому рассеяние электронов на ионах пренебрежимо мало, что обеспечивает высокую подвижность носителей заряда, соответствующую массивному кристаллу.
Тонкий слой нелегированного AlGaAs, называемый спейсером, используется для дополнительного ослабления влияния кулоновского поля ионов донорной примеси.
Таким образом, использование гетероперехода позволяет достичь высокой подвижности электронов при их высокой концентрации в канале ВПЭТ.