К важнейшим параметрам, которые характеризуют основные электрофизические свойства полупроводниковых веществ, относятся:
—удельное электрическое сопротивление (проводимость) материала;
— температурный коэффициент удельного сопротивления (проводимости) вещества;
— ширина запрещенной зоны и энергии активации примесей;
— концентрация, время жизни носителей заряда;
— коэффициенты диффузии электронов и дырок, диффузионная длина;
— подвижность основных носителей заряда в полупроводнике.
В ряде случаев специального применения к этим параметрам добавляются и другие, например, коэффициент термо-электродвижущей силы (при использовании термоэлектрических эффектов в полупроводниках), коэффициент Холла и т. д.
а) Концентрация и время жизни, носителей заряда в полупроводниках
Как уже отмечалась, между процессами генерации и рекомбинации носителей заряда при любой температуре устанавливается динамическое равновесие, которому соответствуют равновесные концентрации носителей заряда, обозначаемые обычно через n0, p0. В случае собственного полупроводника концентрация электронов в зоне проводимости равна концентрации дырок в валентной зоне: n0,=p0=ni В состоянии термодинамического равновесия в невырожденном полупроводнике произведение равновесных концентраций основных и неосновных носителей заряда при заданной температуре является величиной постоянной, равной квадрату концентрации электронов (или дырок) в собственном полупроводнике при этой же температуре:
nn,*np=ni2 = const (4.6)
|
|
|

Перемножив эти два выражения и учтя, что ni= pi, получим выражение (4.6).

Концентрация носителей в полупроводнике, например n-типа, зависит от температуры и концентрации примесей (рис. 4.6). В области низких температур (область I) рост концентрации носителей заряда связан с интенсификацией процессов ионизации примеси. Наклон прямой в этой области определяется энергией активации примесей. С увеличением температуры число носителей, поставляемых примесями, возрастает до тех пор, пока не истощатся электронные ресурсы примесных атомов и не наступит область II область истощения примесей.
Рис. 4.6
В этой области примеси полностью ионизированы, а электроны еще не переходят через запрещенную зону и концентрация электронов в зоне проводимости остается практически постоянной величиной. Дальнейший рост температуры приводит к быстрому росту концентрации носителей вследствие перехода электронов через запрещенную зону — область III. Наклон этого участка кривой характеризует ширину запрещенной зоны полупроводника, а полупроводник можно считать собственным, так как концентрация носителей заряда определяется ионизацией собственных атомов полупроводника. Температура, при которой это происходит, т. е. начинается область III, будет тем меньше, чем меньше ширина запрещенной зоны полупроводника, и эта температура является максимальной рабочей температурой полупроводникового прибора, изготовленного из полупроводника с концентрацией примеси Ng. Угол наклона участка кривой в области I с увеличением концентрации примесей уменьшается, так как с увеличением концентрации примесей из-за взаимодействия примесных атомов происходит расщепление примесных энергетических уровней и уменьшение энергии ионизации примесей (∆Eg>∆Eg'>∆Eg''). При достаточно большой концентрации примесей Ng энергия ионизации примесей стремится к нулю, так как образовавшаяся примесная зона перекрывается зоной проводимости и полупроводник становится вырожденным.
Температура, соответствующая переходу от примесной электропроводности к собственной, увеличивается с увеличением концентрации примесей (например, T3'>T3). Это значит, что максимальная рабочая температура полупроводникового прибора, созданного на основе полупроводника с большей концентрацией примесей, будет также немного выше максимальной рабочей температуры такого же прибора из того же материала, но с меньшей концентрацией примесей.
Во многих случаях оказалось, что энергия, необходимая для перевода электрона с донорного уровня в зону проводимости, настолько мала, что при комнатных температурах все электроны с примесных уровней находятся уже в зоне проводимости. Если к тому же концентрация доноров намного превышает концентрацию собственных электронов, то количество носителей почти перестает зависеть от температуры и изменение электропроводности с температурой в этих условиях определяется, в основном, лишь температурной зависимостью подвижности.
Однако концентрацию носителей заряда в данном материале можно по желанию варьировать и при фиксированном содержании примесей. Одним из замечательных свойств полупроводников является наличие эффекта фотопроводимости. Это явление легко понять с помощью зонной модели. При поглощении кванта света, энергия которого достаточна для перевода электрона из состояния у потолка валентной зоны в зону проводимости, в обеих зонах появляются добавочные носители заряда и проводимость кристалла растет. Может иметь место также фотопроводимость, связанная с фотоионизацией примесных атомов, однако этот эффект менее значителен сравнительно с упомянутым выше в связи с тем, что концентрация примесей обычно во много раз меньше концентрации валентных электронов и, кроме того, примесные уровни заполнены лишь при низких температурах. Вместе с тем оказалось, что концентрация электронов и дырок в полупроводниках можно изменять и иными способами. Во-первых, путем инжекции носителей заряда в кристалл, например с помощью металлических электродов, и, во-вторых, при определенных условиях путем экстракции (удаления) носителей из кристалла электрическим полем.
В заключение приведем численный пример для иллюстрации относительного вклада различных механизмов электропроводности. В чистом германии собственная концентрация ni, электронов и дырок при комнатной температуре представляет собой величину 2,5x1013 см-3. Число атомов германия в единице объема равно 4,5x1022 см-3. Следовательно, если в германии присутствует донорная примесь, которая при комнатных температурах полностью «ионизирована», то при наличии одного атома примеси на 106 атомов германия мы получили бы n=4,5x1016 см-3 электронов. Отсюда p=ni2/n=1,4x1010 см-3, так что, действительно, n>>p. Если температуру поднять до 300°С, то ni = 1,5x1017см-3 и преобладающей становится уже собственная концентрация носителей заряда.
Из этой оценки видно, что для того, чтобы германий сохранял свойства собственного полупроводника при комнатной температуре, примеси, образующие уровни вблизи зоны проводимости, могут присутствовать в кристалле в количестве не более одного атома примеси на 109 атомов германия.
Рассмотрим распределение электронов по примесным уровням, лежащим между валентной зоной и зоной проводимости в примесном полупроводнике. Для проведения рассуждений поместим начало отсчета энергий на дно зоны проводимости. Если рассматривать генерацию и рекомбинацию электронов и дырок как химическую реакцию, приводящую к образованию нормального атома пли иона в кристалле N, то такую реакцию можно описывать уравнением
|
Из закона действующих масс следует
(4.9)
где f(Т) имеет вид [F(Т)2 ехр(—∆Е/kТ)], причем F(Т) — функция, медленно меняющаяся с температурой. Равенство (4.9) эквивалентно равенству np=Nc*Nv*ехр(-∆E/kТ)=ni2 в котором приводится вид функции F(Т). Если нам известна концентрация электронов в зоне проводимости, то очень легко проверить степень вырождения в полупроводнике. Пусть для примера Е=300 К., тогда при me≈mn≈m0 величина Nc 2,5x1019 см-3. Поэтому в области концентраций n<1019 см-3 для ЕF получаем ЕF < 2kТ, т.е. электронный газ невырожден. С другой стороны, если n≈2x1019см-3, то ЕF> 2kT и исходное предположение перестает быть справедливым, т.е. наступает вырождение электронов в зоне проводимости. Если me<<m0 как это имеет место в InSb, то вырождение в зоне проводимости наступает при значительно меньших концентрациях электронов.
Прежде чем приступить к исследованию более сложных случаев, рассмотрим полупроводник, содержащий Nd донорных уровней в единице объема. Предположим, что донорные уровни расположены в непосредственной близости от дна зоны проводимости, так что энергия ионизации примесей εd очень мала по сравнению с шириной запрещенной зоны; мы уже видели, что такие уровни довольно типичны, например в Ge, где εd ≈0,01 эВ при ∆Е = 0,7эВ. Предположим также, что уровень Ферми расположен существенно ниже дна зоны проводимости, т. е. ЕF <<-kТ. Вследствие малости εd практически все атомы примеси будут ионизированными и их электроны окажутся в зоне проводимости. Выясним сперва, какова предельная концентрация примесей, при которой эти условия перестают быть справедливыми. Для начала допустим, что Nd>>ni, так что можно пренебречь «собственными электронами», т. е. теми, которые перебрасываются в зону проводимости из валентной зоны. В этом случае мы имеем простое соотношение n=Nd. В этих условиях число электронов в зоне проводимости будет слабо зависеть от температуры.
Положение уровня Ферми в этих условиях определяется уравнением
n=Nd=Nc*exp(ЕF/kt)
или
ЕF=kT*ln(Nd/Nc) (4.10)
Формула (4.10) справедлива лишь при условии ЕF <-kТ, т.е. при Nd<Nc/2. Для Ge при Т=300 К это означает, что для применимости равенства (4.10) требуется, чтобы Nd < <1019 см-3; с другой стороны, однако, должно выполняться условие Nd >1014 см-3, чтобы можно было пренебречь концентрацией собственных носителей заряда. Итак, в Ge при комнатных температурах существует довольно широкая область значений Nd, для которых выполняются условия примесного истощения.
Из формулы (4.10) следует, что с ростом Nd уровень Ферми перемещается вверх примерно с середины запрещенной зоны до значения энергии примерно на kT ниже дна зоны проводимости, когда Nd→Nc. Если Nd≥Nc, то система электронов в зоне проводимости становится вырожденной и для определения положения уровня Ферми необходимо воспользоваться уже равенством типа
|
В этом случае полупроводник будет вести себя скорее как металл.
Интересно выяснить, что происходит в более общем случае, когда Nd того же порядка величины, что и ni,, но при этом Nd << Nc. Ясно, что, если ∆Е>>kТ, уровень Ферми будет находиться достаточно далеко от дна зоны проводимости, на основании чего по-прежнему можно предполагать, что все атомы примеси ионизированы. Тогда между n и р имеет место простое соотношение
n-р= Nd (4.11)
выражающее условие электрической нейтральности полупроводника. На основании равенства (4.11) можно выразить n и р через ni, и Nd и получить
|
Если Nd>>ni, (а также Nd<Nc), то приближенно имеем
|
N= Nd + ni2/Nd (4.13)
P= ni/Nd
Заметим, что концентрация дырок в этом случае намного меньше концентрации дырок в собственном веществе (в отношении ni/Nd). Например, при ni=2,37x1013 см-3 (как для Gе) и Nd=1016 см-3 мы получаем n≈1016 см-3 и р≈ 5,6x1010 см-3. В этом случае электроны являются основными носителями заряда, а дырки — не основными. Несмотря на малость концентрации не основных носителей по сравнению с концентрацией основных, первые могут играть в известных условиях очень важную роль. Предположив, что имеет место обратное неравенство Nd<<ni/, мы приближенно получаем
n=ni+1/2 Nd (4.14)
p=ni-1/2 Nd
Предположим теперь, что вместо донорной примеси имеется Na акцепторных атомов в единице объема, уровни энергии которых расположены непосредственно над потолком валентной зоны. Аналогично предыдущему будем считать, что уровень Ферми расположен выше потолка валентной зоны по крайней мере на несколько kТ. Тогда почти все акцепторные уровни будут заняты электронами из валентной зоны, т. е. примесные атомы будут «ионизированными», причем в валентной зоне останется около Nа свободных дырок, и мы получим
|
 (4.15)
(4.15)
Эта формула справедлива лишь при условии, что отношение Na/Nv ≤1/2. Снова с ростом Na от 0 до Nv„ уровень Ферми смещается примерно с середины запрещенной зоны до потолка валентной зоны.
Ясно, что вместо равенства (4.11) теперь имеем
p-n= Na
которое даст
|
|
(4.17)
При Na>>ni, приближенно имеем
n=ni2/Na (4.18)
p=Na+ ni2/Na
Если же ni >>Na, то приближенно
n=ni2-1/2*/Na (4.19)
p= ni + 1/2*Na
Допустим теперь, что в кристалле одновременно присутствуют как донорные, так и акцепторные примеси. Предположим вначале, что (Nd-Na>>ni. При Nа=0 уровень Ферми окажется существенно выше середины запрещенной зоны. При добавлении в кристалл акцепторов вероятность заполнения соответствующих им уровней, т.е. вероятность «ионизации» акцепторных атомов, очень велика, поскольку эти акцепторные уровни лежат значительно ниже уровня Ферми. Электроны, заполняя акцепторные уровни (по одному электрону на уровень), переходят с донорных уровней или из зоны проводимости. Число свободных дырок чрезвычайно мало, так как уровень Ферми располагается достаточно высоко над краем валентной зоны. Поэтому эффективное число доноров равно Nd-Na и положение уровня Ферми определяется из соотношения
Nd-Na= Nс*exp(ЕF/kТ). (4.20)
При Na → Nd акцепторы все в большей степени нейтрализуют действия доноров и уровень Ферми постепенно перемещается к середине запрещенной зоны. При Na > Nd эффективное число акцепторов становится равным Na-Nd, все электроны с донорных центров переходят на акцепторные уровни, уровень Ферми опускается еще ниже и в пределе оказывается у самого.края валентной зоны. Зависимость ЕF от концентрации

Рис. 4.7
примесных атомов показана на рис. 4.7 (фактический ход кривой зависит от температуры). Серия кривых, изображающих температурную зависимость n и р при различных значениях Nd-Na для Gе, представлена на рис. 4.8.
В переходных процессах до установления термодинамического равновесия концентрация носителей может превысить равновесную на величину, равную ∆n(∆p), которую называют избыточной концентрацией. После прекращения энергетического воздействия на полупроводник избыточная концентрация носителей заряда в нем из-за процесса рекомбинации через некоторое время уменьшится до нуля. Количество носителей заряда, рекомбинирующих в единицу времени в единице объема (быстрота изменения концентрации), пропорционально избыточной концентрации и обратно пропорционально некоторому параметру τ, который называют временем жизни неравновесных носителей:
-dn/dt=-d(∆n)/dt=∆n/τn; -dp/dt=-d(∆p)/dt=∆p/τp (4.21)

Рис.4.8 Рис.4.9
|
(4.22)

Это время, в течение которого перавновесная концентрация носителей уменьшается в е раз.
Время жизни неравновесных носителей заряда зависит от температуры полупроводника. Рассмотрим температурную зависимость времени жизни на примере полупроводника с электропроводностью n-типа с рекомбинационными ловушками в верхней половине запрещенной зоны (рис. 4.9, а и 4.9,6). При очень низкой температуре рекомбинационные ловушки заполнены электронами, так как вероятность их заполнения, судя по положению уровня Ферми, намного больше 50%. При этом первый этап рекомбинации (захват дырки рекомбинационной ловушкой) происходит быстро и время жизни оказывается небольшим. С повышением температуры уровень Ферми смещается вниз и находится вблизи энергетических уровней рекомбинационных ловушек. Это означает, что теперь не все ловушки заполнены электронами, т.е. не все ловушки могут захватить блуждающие по полупроводнику дырки. Поэтому с повышением температуры время жизни растет.
б) Подвижность носителей заряда в полупроводниках
На величину подвижности носителей заряда в основном влияют следующие факторы:
1) тепловые колебания атомов или ионов кристаллической решетки;
2) примеси в полупроводниковом или нейтральном состояниях;
3) всевозможные дефекты решетки (пустые узлы, искажения, вызванные атомами внедрения, дислокации, трещины, границы кристаллов и т.д.).
Рис. 4.9, в иллюстрирует температурную зависимость подвижности носителей заряда. В диапазоне малых температур с уменьшением температуры уменьшаются тепловые скорости хаотического движения носителей заряда, что приводит к увеличению времени пребывания носителя вблизи иона примеси, т. е. увеличивается длительность воздействия электрического поля иона примеси на носитель заряда. Поэтому в диапазоне малых температур с уменьшением температуры подвижность носителей также уменьшается.
При увеличении концентрации примесей увеличивается рассеяние на полях примесей, т.е. уменьшается подвижность носителей заряда. Однако в диапазоне высоких температур преобладающим механизмом рассеяния носителей, даже при большой концентрации примесей, остается рассеяние на тепловых колебаниях атомов кристаллической решетки и соответственно кривые температурной зависимости подвижности носителей заряда практически не смещаются с увеличением концентрации примесей. В этом диапазоне температур преобладает рассеяние носителей заряда на тепловых колебаниях атомов кристаллической решетки и поэтому подвижность носителей уменьшается (рис. 4.9, в). Если в рассеянии носителей заряда участвуют оба механизма (колебательно-решеточный и ионный) с преобладанием того или другого в различных интервалах температуры, то результирующая температурная зависимость подвижности имеет максимум, который смещается в область высоких температур при увеличении концентрации примесей.
в) Электропроводность полупроводников
Электропроводность полупроводников обусловлена дрейфом носителей обоих знаков: электронов и дырок.
Удельная электрическая проводимость собственного полупроводника определяется по формуле
γсобств=γn+γp=q n μn+q p μp=qni*(μn+μp) (4.23)
где γn— электропроводность, обусловленная передвижением электронов в зоне проводимости; γp — электропроводность, обусловленная передвижением дырок в валентной зоне; μn, μp — их подвижность.
Удельная проводимость примесного полупроводника n-типа равна сумме собственной и примесной электропроводности:
γn = γпр + γсобств; γпр =nД q μn (4.24)
Через nД обозначена концентрация свободных электронов, образовавшихся за счет ионизации донорной примеси. В дырочном полупроводнике
γp = γпр + γсобств; γпр =pa q μp (4.25)
Через pa обозначена концентрация дырок, образовавшихся за счет ионизации акцепторной примеси.
Анализируя результаты хода температурной зависимости концентрации и подвижности носителей заряда в полупроводниках, можно представить и общие закономерности в изменении удельной проводимости полупроводниковых материалов от температуры.
В предыдущих параграфах было отмечено, что концентрации носителей заряда в широком диапазоне температур изменяются по экспотенциальному закону, в то время как подвижность — лишь по степенному. Следовательно, температурная зависимость электропроводности как в собственных, так и примесных полупроводниках определяется, в основном, температурной зависимостью концентрации свободных носителей заряда и может быть представлена в виде
γi=γ0e-ΔE/2kT (4.26)
для собственных полупроводников,
γn=γ0e-ΔEa/2kT (4.27)
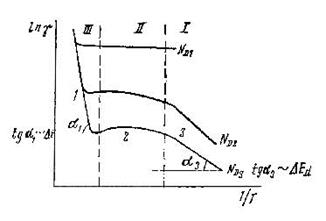
для примесных полупроводников (в данном случае для полупроводника n-типа). В выражениях (4.26), (4.27) - γ0 — постоянная, определяемая природой материала.
Рис. 4.10
В интервале средних значений температур (участок 2, рис. 4.10), соответствующих полному истощению примеси, концентрация основных носителей практически не меняется при увеличении температуры. Поэтому температурная зависимость γ на этом участке определяется температурной зависимостью подвижности. Как видно из рисунка 4.10, температурный коэффициент удельного сопротивления полупроводниковых материалов в области I и II является отрицательной величиной, т.е. удельное электрическое сопротивление полупроводников уменьшается с ростом температуры в отличие от проводниковых материалов.
Зависимость удельной проводимости от напряженности электрического поля показана на рис. 4.11. В области I выполняется закон Ома, и электропроводность полупроводника не изменяется с ростом напряженности электрического поля. При превышении некоторого критического значения Екр (примерно 104—106 В/м) наблюдается отклонение от закона Ома на участке II вследствие термоэлектронной ионизации, в области III — вследствие ударной и электростатической ионизации, IV — вследствие пробоя.
Явление термоэлектронной ионизации заключается в том, то электрическое поле большой напряженности изменяет энергетическое состояние электронов так, что энергия, необходимая для перевода электронов в зону проводимости, уменьшается, а следовательно, возрастает вероятность тепловой генерации пар носителей заряда. В этом случае изменение концентрации носителей с ростом поля происходит по
 |
экспоненциальному закону.
Рис. 4.11
Процесс ударной ионизации сводится к тому, что в сильных электрических полях носители заряда на длине свободного пробега могут приобрести энергию, достаточную для ионизации вещества. Это означает, что при столкновении носителей с атомами происходит генерация электронно-дырочных пар. В электрических полях большой напряженности (более 108 В/м) может наблюдаться туннельный эффект, при котором благодаря волновым свойствам электронов возможен прямой переход их из валентной зоны в зону проводимости без увеличения энергии. Рассмотренные процессы термоэлектронной, ударной и электростатической ионизации, увеличивая концентрацию носителей заряда, не носят лавинообразного характера, так как уравновешиваются процессами рекомбинации. Однако в электрических полях напряженностью более 108 В/м наблюдается лавинообразное нарастание числа носителей, приводящее к электрическому пробою.
Воздействие сильного электрического поля приводит не только к изменению концентрации свободных носителей заряда, но и к значительному изменению их подвижности. С изменением подвижности носителей заряда связаны явление разогрева электронно-дырочного газа и эффект Ганна.
Первое заключается в том, что свободные носители за счет увеличения скорости во внешнем электрическом поле обладают энергией, большей, чем равновесная тепловая энергия решетки. Такие носители называют «горячими». Под эффектом Ганна понимают явление, наблюдаемое в постоянном электрическом поле большой напряженности в некоторых полупроводниковых материалах и сводящееся к возникновению периодических колебаний тока, протекающего через образец.
Описанные выше явления лежат в основе работы многих полупроводниковых приборов: стабилитронах и лавинных диодах, нелинейных резисторах (варисторах), генераторах Ганна и др.
г) Диффузионная длина носителей заряда в полупроводниках
Если предположить, что в какой-либо точке или плоскости полупроводника создается избыточная по сравнению с равновесной концентрация электронов или дырок ∆n0, то тогда избыточные (неравновесные) носители заряда будут диффундировать вглубь и по.мере удаления от этой точки их концентрация будет падать за счет рекомбинации по экспоненциальному закону
∆n(х) =∆n0*e-x/L (4.28)
где L — диффузионная длина, т.е. расстояние, на котором в однородном полупроводнике при одномерной диффузии в отсутствие электромагнитного поля избыточная концентрация носителей заряда уменьшается вследствие рекомбинации в e раз, т.е. это расстояние, на которое носитель диффундирует за время, равное времени жизни носителей заряда τ. Диффузионная длина связана со временем жизни неравновесных носителей следующими соотношениями:
|
 (4.29)
(4.29)
где Dn и Dp —.коэффициенты диффузии для электронов и дырок, определяемые как
Dn=Фn/grad n (4.30)
В выражении (4.30) Фn — поток частиц при диффузии, т. е. число частиц, пересекающих в единицу времени единичную площадку, перпендикулярную направлению градиента их концентрации — grad n
Диффузионная длина является важным параметром полупроводниковых материалов, зависящим от наличия в них примесей, совершенства кристаллической решетки и т.д. Для германия и кремния эта величина указывается в паспорте данного материала.
Не следует путать диффузионную длину с длиной свободного пробега носителей заряда, которая определяется как среднее расстояние, проходимое носителем между двумя последовательными актами рассеяния.
д) Оптические свойства полупроводников
Для описания оптических параметров материалов обычно используют комплексны показатель преломления n* 
n*=n (1—iκ) (4.31)

состоящий из действительной и мнимой частей. В таком случае для плоской электромагнитной волны λ — длина волны, ν— частота), распространяющейся в направлении х:
Ψ=A*exp(2πiν*(t-n*x/c) (4.32)
можно записать
Ψ=A*exp(-2πνnκx/c)*exp(2πiν (t-nx/c)) (4.33)
Фазовая скорость v = с/n, а длина волны λ, если поглощение не слишком велико, равна с/νn:
Ψ=A*exp(-αx/2)*exp(2πiν (t-x/v)) (4.34)
Α=4πκ/ λ= 4πnκ/λ0 (3 35)
где λ0 — длина волны в вакууме при частоте ν; κ— показатель поглощения; α — коэффициент поглощения. Из классической электродинамики следует, что
ε*=ε – iσ/(2πνε0) (4.36)
где ε — обычная диэлектрическая проницаемость; σ — электропроводность и (n*)2 = ε*2:
ε=n2*(1-κ2)ε (4.37)
σ=4πn2 κνε0) (4.38)
при ε > 0
α= σ/(n2 λ ν ε0)= σ/(n c ε0) (4.39)
На частотах, недостаточно высоких, чтобы вызвать межзонные переходы или образование экситонов, поглощение обусловлено возбуждением колебаний решетки или переходами между состояниями в одной золе.
Уравнение движения электронов в переменном поле с частотой,ω/2 π в одномерном случае имеет вид
|
|
(4.41)
где ne — концентрация электронов.
Вместо комплексной диэлектрической проницаемости ε*, определяемой уравнением (4.36), можно ввести комплексную проводимость с помощью уравнения jx=σ*εx:
σ*=i ω εe* ε0= σ+iω εe ε0 (4.42)
где εe — электронная часть диэлектрической проницаемости. Поляризация атомов решетки дает вклад в диэлектрическую проницаемость, которую мы обозначим εL. Тогда диэлектрическая проницаемость будет равна
ε= εL+ εe
Рассмотрим предельный случай ω < τ> >>1. При длине волны λ =10 мкм / ω = 2*1014 рад*с-1/ и при T=300 К ωτe»260, так что в ближней ИК-области это условие хорошо выполняется. В этом пределе, заменяя me на дрейфовую эффективную массу mc, получим
|
 (4.43)
(4.43)
|

Используя формулу (4.5), можно получить выражение для коэффициента поглащения
α= σ0 g (e2/ ω2 mc2)/(mc2 c ε0 n) (4.44)
где n — показатель преломления.
|
 |
где ne, — концентрация электронов в зоне проводимости. Измерения поглощения на свободных носителях заряда, проведенные на длинах волн за краем собственного поглощения, позволили проверить справедливость формулы (4.44) для многих полупроводников.
Оптические свойства полупроводников и фотоэлектрические явления в объеме и на поверхности полупроводника привлекают всеобщее внимание по целому ряду причин, главной из которых является открытие новых областей электроники и радиотехники — оптоэлектроники, функциональной электроники, квантовой электроники, — а также возможность непосредственного исследования структуры энергетических уровней, переходов между ними и т. д.
Рассмотрим падение пучка света на плоскую поверхность. Коэффициент пропорциональности а, представляющий собой количество поглощенной энергии из пучка единичной интенсивности в слое единичной длины, называется коэффициентом поглощения:
dI =a Idx (4.45)
После интегрирования выражения (4.45) получим
I=I0e-ax
Зависимость a= f (l) называется спектром поглощения.
|
 |
В общем виде интенсивность отраженных и пропущенных материалом потоков, как это следует из рисунка 4.12, можно представить в виде выражений
|
 |
где I — интенсивность прошедшего через образец луча, а Т— отраженного.
При поглощении света должны выполняться законы сохранения энергии и импульса. Учитывая специфику данного курса, нас в первую очередь будут интересовать квантовые эффекты, вызванные переходами как внутри зон, так и между ними.


Рис. 4.12
Рис. 4.13
Различают собственное, экситонное, примесное, решеточное поглощение света полупроводниками, а также поглощение света свободными носителями заряда в полупроводниках. Общий вид спектра поглощения схематически представлен на рис. 4.13.
Собственное (основное, фундаментальное) поглощение света связано с переходом электронов из валентной зоны в зону проводимости. Закон сохранения энергии требует того, чтобы отсутствовало поглощение квантов света (по этому механизму) с энергией меньше ширины запрещенной зоны, т. е.
(hn)погл ³ DЕ.
Определение ширины запрещенной зоны по краю фундаментального поглощения возможно лишь для очень чистых и совершенных кристаллических образцов. При изменении длины волны света в коротковолновую сторону от края значение коэффициентов поглощения достигает величины 10-4 — 10-5 см-1. Различают прямые и непрямые переходы. Вероятность непрямых переходов много меньше, чем прямых. Эти переходы определяют поглощение, расположенное с длинноволновой стороны у границы собственного поглощения. Как правило, энергию нельзя представить в виде функции одной переменной, за исключением специальных случаев, например, когда Е зависит лишь от величины вектора К. Обычно зависимость Е от К изображают графически для некоторых главных направлений в кристалле. Наглядно познакомиться с прямыми и непрямыми переходами можно на примере рис. 4.14. Непрямой переход 5 можно представить

Рис. 4.14
в виде двух случаев. В одном случае электрон, находящийся вблизи потолка валентной зоны с К1 = 0, возбуждаясь светом, переходит в зону проводимости, занимая там состояния с тем же волновым вектором [1] (прямой переход). В валентной зоне осталась дырка с К1= 0. Однако электрон проводимости с К1=0 обладает большей энергией, чем та, которая соответствует дну зоны проводимости, поэтому он через очень малый промежуток времени совершает переход в состояние с минимальной энергией (К2=Кmin), испуская фонон (непрямой переход 2). В другом случае электрон возбуждается излучением из глубоко лежащего состояния в валентной зоне и совершает «вертикальный» переход в состояние зоны проводимости, характеризуемое волновым вектором К= Кmin (прямой переход 3 на рис. 4.14). В валентной зоне остается глубоко лежащая дырка, которая совершает переход в состояние вблизи потолка валентной зоны, где K=0, и одновременно испускает или поглощает фонон (непрямой переход 4 на рис. 4.14). Материалы Si и Gе являются непрямыми полупроводниками, и у того, и у другого вершина валентной зоны расп


















