Вырожденные полупроводники.
Рассмотренные выше полупроводники, идущие на изготовление большинства обычных полупроводниковых приборов, имеют концентрацию легирующих примесей порядка 1014 — 1018см−3. Дальнейшее повышение количества примеси приводит к качественным изменениям свойств полупроводниковых материалов, которые необходимо рассмотреть. Знание свойств таких сильнолегированных материалов очень важно, потому что они служат основой для изготовления туннельных диодов.
В обычных полупроводниках атомы примеси, произвольно расположенные в исходном материале, достаточно удалены друг от друга, так что между собой не взаимодействуют. На энергетической диаграмме это отображается расположением отдельных, не расщепленных в зону энергетических уровней электронов примесных атомов. Вследствие локализованности этих уровней электроны, находящиеся на них, не могут перемещаться по кристаллу и участвовать таким образом, в электропроводности.
По мере увеличения концентрации примесей расстояния между их атомами уменьшаются, что увеличивает взаимодействие между ними. Это приводит к расщеплению примесных уровней в примесную зону, которая может слиться с основной зоной (зонной проводимости для примесной зоны доноров или с валентной зоной для примесной зоны акцепторов). Такое слияние зон происходит при концентрациях примеси, превышающих, некоторое критическое значение. Так, для германия значение этой концентрации составляет около 2·1019 см−3, а для кремния — 6·1019 см−3. Такие сильнолегированные полупроводники относятся к типу вырожденных, отличительной чертой которых является то, что уровень Ферми находится внутри либо зоны проводимости, либо валентной зоны.
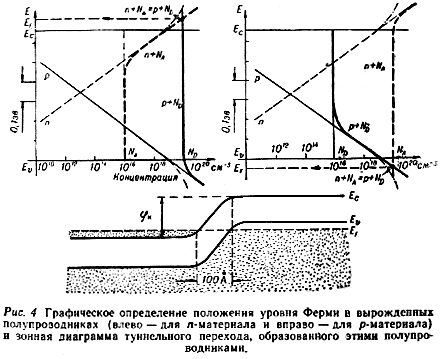
Для определения положения уровня Ферми в вырожденном полупроводнике можно воспользоваться тем же графическим методом по определению положения этого уровня, ко то рый был применен к обычным (невырожденным) полупроводникам. Соответствующие построения для электронного и дырочного полупроводников приведены на рис. 4. Как видно изграфиков, уровень Ферми расположен внутри зоны проводимости для электронного полупроводника и внутри валентной зоны для дырочного, что характерно для вырожденных полупроводников.
Туннельный диод.
 Как было упомянуто ранее, свое название туннельный диод получил из-за лежащего в его основе работы известного в квантовой механике туннельного эффекта. Еще до открытия Эсаки этот эффект в полупроводниках был достаточно изучен, первоначально Зенером, затем Мак−Аффи, Шокли и другими, которые рассмотрели туннелирование электронов через запрещенную зону в сплошном полупроводнике. Дальнейшее развитие теория туннельного эффекта в полупроводниках получила в фундаментальных работах Л. В. Келдыша.
Как было упомянуто ранее, свое название туннельный диод получил из-за лежащего в его основе работы известного в квантовой механике туннельного эффекта. Еще до открытия Эсаки этот эффект в полупроводниках был достаточно изучен, первоначально Зенером, затем Мак−Аффи, Шокли и другими, которые рассмотрели туннелирование электронов через запрещенную зону в сплошном полупроводнике. Дальнейшее развитие теория туннельного эффекта в полупроводниках получила в фундаментальных работах Л. В. Келдыша.
Основа этого явления заключается в том, что частица (например, электрон 2 на рис.5), имея энергию Eэл, которая меньше высоты потенциального барьера Eб обладает конечной вероятностью проникновения сквозь этот барьер. Потенциальный барьер Eб (например, связанный с работой выхода электрона из металла) по законам классической физики не составляет препятствия для электрона 1, обладающего большей энергией, чем высота этого барьера. При определенных условиях и электрон 2 может преодолеть его, хотя энергия электрона меньше высоты потенциального барьера. Причем этот электрон не огибает барьера, а как бы «туннелирует» сквозь него (отсюда и название эффекта), имея одну и ту же энергию до и после перехода.
Такой механизм преодоления потенциального барьера можно связать с волновым представлением движения электрона в твердом теле, когда при столкновении с барьером электрон подобно волне проникает на какую-то глубину внутрь его. В случае барьера конечной толщины имеется какая-то конечная вероятность найти волну (электрон) с другой стороны барьера, что эквивалентно прохождению электроном барьера. Чем меньше ширина барьера, тем больше «прозрачность» его для волны; т. е. тем больше вероятность прохождения электрона сквозь этот потенциальный барьер. При определенных условиях туннельный эффект может
наблюдаться в p - n -переходе. Чтобы найти условия, при которых возможен туннельный эффект, необходимо выяснить влияние параметров перехода на вероятность туннельного эффекта.
Ширина сплавного p - n -перехода связана с концентрацией примесей в полупроводнике следующим образом:

где ε — диэлектрическая проницаемость материала;
e — заряд электрона.
При обычном легировании полупроводниковых материалов (концентрация примесей донорных или акцепторных порядка 1016 см−3) обедненный слой получается довольно широким (около 10−4 см). При такой ширине перехода вероятность туннелирования электронов через него пренебрежимо мала.

Вероятность Wэл туннельного прохождения электрона через p - n -переход для треугольного потенциального барьера определяется следующим выражением
где Eg − ширина запрещенной зоны (здесь принято Eg ≈ e·φk что справедливо для вырожденных полупроводников).

Для определения плотности туннельного тока необходимо найти вероятное количество электронов, проходящих через потенциальный барьер в 1 сек. Оно будет равно произведению вероятности туннелирования электрона Wэл на число столкновений электрона с барьером за 1 сек, равному a·Eg/ћ·δ (а— постоянная решетки кристалла), т. е.
С ростом степени легирования материала ширина p - n -перехода уменьшается и вероятность туннелирования возрастает. При концентрации примесей 1019—1020 см−3, соответствующих вырождению, ширина перехода получается порядка 100 А° и вероятное количество туннельных переходов электрона за 1 сек будет уже порядка 1012 (для германия). При этом напряженность электрического поля в p - n -переходе около 106 в/см и переброс электронов за счет эффекта Зенера еще не сказывается.
Таким образом, туннельный эффект становится практически ощутимым лишь в сильнолегированных материалах. Изучая узкие сильнолегированные сплавные переходы в германии, Эсаки и открыл новый тип полупроводникового прибора — туннельный диод, вольтамперная характеристика которого изображена на рис. 6, а в сравнении с вольтамперной характеристикой обычного диода, изображенной штриховой линией.
Энергетическая диаграмма туннельного перехода при отсутствии внешнего смещения была показана на рис. 4. Образовавшееся вследствие вырождения полупроводникового материала перекрытие зон является необходимым условием для возможного туннелирования электронов через потенциальный барьер узкого p - n -перехода. Положение уровня Ферми затенено снизу для выделения того уровня энергии электронов в разных материалах, который находится в одинаковых энергетических условиях при термодинамическом равновесии тел. Вероятность заполнения этого уровня, как известно, равна половине. Такому выделению уровня Ферми способствует и слабая зависимость его положения в примесных полупроводниках от изменения температуры в пределах, встречающихся на практике. Подобное выделение этого уровня облегчает рассмотрение вопросов, связанных с распределением электронов по энергетическим уровням в зонах.
Такой подход и применен (рис. 6, б — ж) для объяснения формы вольтамперной характеристики туннельного диода.
При отсутствии внешнего смещения на p - n -переходе уровень Ферми имеет одинаковое энергетическое положение в p- и n -областях (см. рис. 6. б). Распределение электронов выше и ниже уровня Ферми в обеих областях перекрывающихся
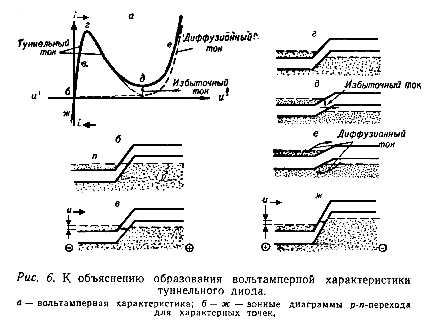
частей зон будет аналогичное, что определяет одинаковые вероятности для туннелирования электронов слева направо и справа налево. Результирующий ток через переход в этом случае равен нулю, что соответствует точке в на вольтамперной характеристике (см. рис. 6, а)
При подаче на переход прямого смещения (плюс источника питания на p -область и минус — на n -область), уменьшающего перекрытие зон. Энергетические распределения электронов смещаются друг относительно друга совместно с уровнями Ферми (см рис. 6. в). Это приводит к преобладанию электронов в n -области над электронами одной и той же энергии в p -области и количества свободных уровней в p -области над незанятыми уровнями в n -области на одинаковых уровнях в месте перекрытия зон. Вследствие этого поток электронов из n -области в p -область будет преобладать над обратным потоком и во внешней цепи появится ток, что соответствует точке в на характеристике (см. рис. 6, а).По мере роста внешнего смещения результирующий ток через переход будет увеличиваться до тех пор, пока не начнет сказываться уменьшение перекрытия зон, как это показано на рис. 6, г. Это будет соответствовать максимуму туннельного тока. При дальнейшем увеличении напряжения в результате уменьшения величины перекрытия зон туннельный ток начнет спадать и наконец спадает до нуля (штрих-пунктир на рис. 6, а) в момент, когда границы дна зоны проводимости и потолка валентной зоны совпадут (см. рис. 6, д).
Из рассмотрения действительной вольтамперной характеристики туннельного диода видно, что ток в точке д не равен нулю. Это можно понять, если учесть, что при положительном смещении будет иметь место инжекция электронов из электронной области в дырочную и инжекция дырок из дырочной области в электронную, т. е. появится диффузионная компонента тока, как в обычном p - n -переходе. При этом носители проходят над потенциальным барьером, величина которого уменьшена приложенным внешним положительным смещением (за счет своей тепловой энергии), в то время как при туннельном эффекте они проходят сквозь него.
Но расчеты показывают, что ток в точке д вольтамперной характеристики значительно больше диффузионного тока. который должен быть при этом напряжении смещения. Превышение действительного тока над диффузионным, обусловленным инжекцией, получило название избыточного тока. Природа его еще до конца не выяснена, но температурная зависимость этого тока говорит, что он имеет туннельный характер. Предполагаемый механизм туннельного перехода через глубокие уровни в запрещенной зоне показан на рис. 6, д. Электрон из зоны проводимости переходит на примесный уровень и с него туннелирует в валентную зону.
Возможны и другие механизмы переходов, но этот наиболее вероятен.
В случае дальнейшего увеличения положительного смещения от точки д ток через диод опять начнет возрастать по тому же закону, что и в обычном диоде. Зонная схема, соответствующая этому случаю, изображена на рис. 6, е. Стрелки показывают, что носители должны взбираться на барьер, а не проходить сквозь него, как при туннелировании.
При подаче на переход обратного смещения перекрытие зон увеличится (рис. 6, ж). В результате против электронов на уровнях в валентной зоне материала p -типа окажется увеличенное число свободных уровней в зоне проводимости материала n -типа. Это приведет к проявлению результирующего потока электронов уже справа налево, и ток во внешней цепи будет обратным. При увеличении смещения обратный ток возрастает. Таким образом, туннельный механизм обратного тока обеспечивает малое обратное сопротивление туннельного диода в отличие от обычного диода, имеющего большое обратное сопротивление.
Следует отметить, что из-за квантово-механической природы туннельного эффекта возникает много трудностей при построении теории туннельного диода. Но в этом направлении ведутся интенсивные работы, особенно по теории вольтамперной характеристики туннельного диода. Полученные выражения пока довольно громоздки и неудобны для использования в аналитическом расчете цепей с туннельными диодами, так как не дают прямой зависимости между током и напряжением.
Обычные диоды при увеличении прямого напряжения монотонно увеличивают пропускаемый ток. В туннельном диоде квантово-механическое туннелирование электронов добавляет горб ввольтамперную характеристику, при этом, из-за высокой степени легирования p и n областей, напряжение пробоя уменьшается практически до нуля. Туннельный эффект позволяет электронам преодолеть энергетический барьер в зоне перехода с шириной 50..150 Å при таких напряжениях, когда зона проводимости в n-области имеет равные энергетические уровни с валентной зоной р-области.[1] При дальнейшем увеличении прямого напряжения уровень Ферми n-области поднимается относительно р-области, попадая на запрещённую зону р-области, а поскольку туннелирование не может изменить полную энергию электрона[2], вероятность перехода электрона из n-области в p-область резко падает. Это создаёт на прямом участке вольт-амперной характеристики участок, где увеличение прямого напряжения сопровождается уменьшением силы тока. Данная область отрицательного дифференциального сопротивления и используется для усиления слабых сверхвысокочастотных сигналов.


Вольт-амперная характеристика туннельного диода. В диапазоне напряжений от U1 до U2 дифференциальное сопротивление отрицательно.
Наибольшее распространение на практике получили туннельные диоды из Ge, GaAs, а также из GaSb. Эти диоды находят широкое применение в качестве генераторов и высокочастотных переключателей, они работают на частотах, во много раз превышающих частоты работы тетродов, — до 30…100 ГГц.
Решил автоматизировать процесс измерения. Линейно возрастающее пилообразное напряжение подал на эмиттерный повторитель, а с выхода повторителя, через 910 Ом на анод диода. Катод диода, через резистор 100 Ом, соединил с общим проводом. Осциллограф подключил параллельно резистору 100 Ом. Вот что показал осциллограф. Верхняя осциллограмма - ток через туннельный диод.
Нижняя осциллограмма - напряжения на туннельном диоде (осциллограф параллельно диоду).
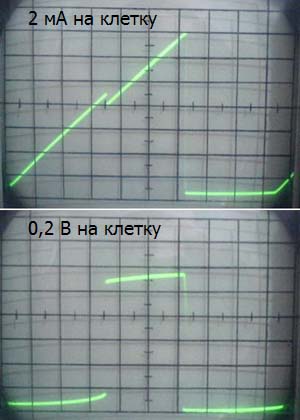
Туннельный диод – это полупроводниковый диод на основе вырожденного полупроводника, в котором туннельный эффект приводит к появлению на вольт-амперной характеристике при прямом напряжении участка с отрицательной дифференциальной проводимостью.
Для изготовления туннельных диодов используют полупроводниковый материал с очень высокой концентрацией примесей  , вследствие чего получается малая толщина p-n -перехода (около
, вследствие чего получается малая толщина p-n -перехода (около  ), что на два порядка меньше, чем в других полупроводниковых диодах, и сквозь тонкий потенциальный барьер возможно туннелирование свободных носителей заряда.
), что на два порядка меньше, чем в других полупроводниковых диодах, и сквозь тонкий потенциальный барьер возможно туннелирование свободных носителей заряда.
На рис. 2.13 представлена вольт-амперная характеристика типичного туннельного диода при прямом смещении.

Рис. 2.13. Туннельный диод 1И104:
а – вольт-амперная характеристика при прямом смещении; б – конструктивное исполнение; в – условное графическое изображение импульсных диодов
Параметрами туннельных диодов являются:
1. Пиковый ток  – значение прямого тока в точке максимума вольт-амперной характеристики;
– значение прямого тока в точке максимума вольт-амперной характеристики;
2. Ток впадины  – значение прямого тока в точке минимума вольт-амперной характеристики;
– значение прямого тока в точке минимума вольт-амперной характеристики;
3. Отношение токов  – (для туннельных диодов из
– (для туннельных диодов из  отношение
отношение  , для германиевых
, для германиевых  );
);
4. Напряжение пика  – значение прямого напряжения, соответствующее пиковому току;
– значение прямого напряжения, соответствующее пиковому току;
5. Напряжение впадины  – значение прямого напряжения, соответствующее току впадины;
– значение прямого напряжения, соответствующее току впадины;
6. Напряжение раствора  – значение прямого напряжения на второй восходящей ветви, при котором ток равен пиковому току.
– значение прямого напряжения на второй восходящей ветви, при котором ток равен пиковому току.
Работа туннельного диода иллюстрируется диаграммами, изображенными на рис. 2.14.

Рис. 2.14. Зонные энергетические диаграммы, поясняющие особенности вольт-амперной характеристики туннельного диода
В равновесном состоянии системы уровень Ферми постоянен для обеих областей полупроводникового диода, поэтому другие энергетические уровни искривляются настолько сильно, что нижняя граница дна зоны проводимости области n -типа оказывается ниже верхней границы потолка валентной зоны области p -типа, и так как переход очень узкий, то носители заряда могут переходить из одной области в другую без изменения своей энергии, просачиваться сквозь потенциальный барьер, т. е. туннелировать (рис. 2.14, б).
В состоянии равновесия потоки носителей из одной области в другую одинаковы, поэтому результирующий ток равен нулю. Под воздействием внешнего поля энергетическая диаграмма изменится. При подключении прямого напряжения уровень Ферми и положение энергетических зон сместится относительно равновесного состояния в сторону уменьшения потенциального барьера и при этом степень перекрытия между потолком валентной зоны материала p -типа и дном зоны проводимости материала n -типа уменьшится (рис. 2.14, в). При этом в зоне проводимости материала n -типа уровни, заполненные электронами (ниже уровня Ферми) окажутся против незаполненных уровней в валентной зоне материала p -типа, что приведет к появлению тока, обусловленного большим количеством электронов, переходящих из n -области в p -область. Максимальное значение этого тока будет тогда, когда уровень Ферми материала n -типа и потолок валентной зоны материала p -типа будут совпадать (рис. 2.14, г). При дальнейшем увеличении прямого напряжения туннельное перемещение электронов из n -области в p -область начнет убывать (рис. 2.14, д), так как количество их уменьшается по мере уменьшения степени перекрытия между дном зоны проводимости материала n -типа и потолком валентной зоны материала p -типа. В точке, где эти уровни совпадают, прямой ток p-n -перехода достигнет минимального значения (рис. 2.14, е), а затем, когда туннельные переходы электронов станут, невозможны (рис. 2.14, ж), носители заряда будут преодолевать потенциальный барьер за счет диффузии и прямой ток начнет возрастать, как у обычных диодов.
При подаче на туннельный диод обратного напряжения, потенциальный барьер возрастает, и электрическая диаграмма будет иметь вид, показанный на (рис. 2.14, з). Так как количество электронов с энергией выше уровня Ферми незначительно, то обратный ток p-n -перехода в этом случае будет возрастать в основном за счет электронов, туннелирующих из p -области в n -область, причем, поскольку концентрация электронов в глубине валентной зоны p -области велика, то даже небольшое увеличение обратного напряжения и связанное с этим незначительное смещение энергетических уровней, приведет к существенному росту обратного тока.
Рассмотренные процессы позволяют сделать вывод, что туннельные диоды одинаково хорошо проводят ток при любой полярности приложенного напряжения, т. е. они не обладают вентильными свойствами. Более того, обратный ток у них во много раз больше обратного тока других диодов. Это свойство используется в другом типе полупроводникового прибора – обращенном диоде.
Выводы:
1. Отличительной особенностью туннельных диодов является наличие на прямой ветви вольт-амперной характеристики участка с отрицательным диф-ференциальным сопротивлением. Это позволяет использовать туннельный диод в качестве усилительного элемента.
2. Туннельный эффект достигается за счет очень высокой концентрации примесей в p- и n -областях.
3. Так как возникновение туннельного тока нес вязано с инжекцией носителей заряда, туннельные диоды имеют малую инерционность и вследствие этого могут применяться для усиления и генерации высокочастотных колеба-ний.
Туннельный диод.
Такие диоды изготавливаются из полупроводников с высокой концентрацией примесей – это вырожденные полупроводники. Их особенность в том, что в запрещенной зоне образуются не примесные уровни, а примесные зоны вблизи зоны проводимости в «n» полупроводнике и вблизи валентной зоны в «p» полупроводнике. На рис. показана энергетическая диаграмма вырожденного p-n перехода при отсутствии на нем напряжений.
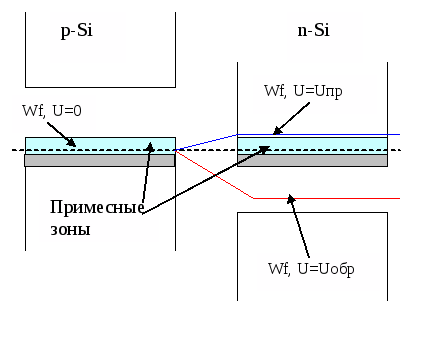
Рис. Энергетическая диаграмма вырожденного p-n перехода
Допустим, что электроны находятся на уровнях энергий ниже уровня Ферми, выше их нет и эти разрешенные уровни свободны от электронов. При подаче обратного напряжения происходит деформация уровня Ферми в сторону увеличения энергетического барьера (на рис показан красным цветом). Смещаются и разрешенные зоны n полупроводника. Здесь наступает самое главное; валентная зона p полупроводника заполненная электронами становится напротив зоны проводимости n полупроводника свободной от электронов. Так как высокая концентрация примеси приводит к малой толщине перехода (см. предыдущую тему), на переходе возникает большая напряженность электрического поля. При этих условиях возникают предпосылки для туннельного движения носителя: электрон из p области переходит (туннелирует) в n область. Возникает большой обратный ток.
При подаче прямого напряжения деформация уровня Ферми идет в другую сторону (показан синим цветом). При этом наблюдается следующее: зона заполненная электронами в n области становится напротив зоны свободной от электронов в p области. Становится возможным туннельный переход электронов из n области в p. Заметим, что это сопровождается появлением большого прямого тока до открытия перехода, связанного с уменьшением энергетического барьера. На рис. показана ВАХ туннельного диода и здесь же обычного.
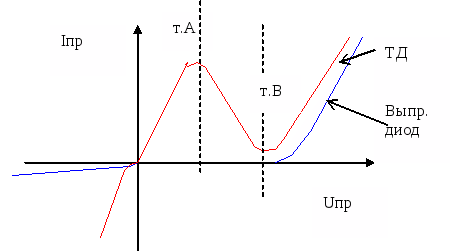
Рис. Вольт - амперная характеристика туннельного диода
Наличие падающего участка между точками А и В – замечательная особенность туннельного диода. Эта область отрицательного динамического сопротивления, позволяющая реализовать на его основе высокочастотные и быстродействующие генераторы, усилители, импульсные устройства.
Параметры туннельного диода следующие.
- Прямое допустимое напряжение, Uпр. доп.
- Координаты точки пика и впадины, точки А, Uпика, Iпика.
- Координаты точки впадины, точки В, Uвпадина, Iвпадина.
- Отрицательное динамическое сопротивление на падающем участке, Rдин.= Δ Uпр/ΔIпр.
На туннельном диоде можно выполнить устройство, активно преобразующее сигнал (генератор и усилитель). Допустим, имеется колебательный контур состоящий из индуктивности и емкости. Вспомним, что будет происходить, если зарядить конденсатор. Электрическая энергия будет переходить в магнитную, которая накапливается в индуктивности. Далее магнитная энергия будет переходить в электрическую, которая в свою очередь накапливается в конденсаторе. Возникнет колебательный процесс, которых носит затухающий характер из – за сопротивлений в контуре. Это сопротивление катушки, проводов. Это сопротивление приводит к потерям энергии, поэтому уместно назвать его сопротивлением тепловых потерь. Если его компенсировать отрицательным сопротивлением, то потерь не будет и в контуре возникнут незатухающие колебания. Таким образом, мы можем получить генератор в котором роль отрицательного сопротивления выполняет туннельный диод. Схема такого генератора показана на рис. здесь же показано условное обозначение диода. Источник питания совместно с сопротивлением Rпит обеспечивает задание рабочей точки в области отрицательного сопротивления диода. Генерация возникает при условии Rдин (-)>Rпот.
Рис. Генератор на туннельном диоде
Туннельный эффект движение носителей малоинерционный процесс. Это и определило область применения туннельных диодов. Это усилители и генератору СВЧ диапазона, например, спутниковые системы связи, быстродействующие импульсные схемы, например, триггеры т и. д.
Параметры туннельного диода и их определение.