ЭЛЕКТРИЧЕСКИЙ ТОК В ПОЛУПРОВОДНИКАХ
Полупроводник -
- вещество, у которого удельное сопротивление может изменяться в широких пределах и очень быстро убывает с повышением температуры., а это значит, что электрическая проводимость (1/R) увеличивается.
- наблюдается у кремния, германия, селена и у некоторых соединений.
Механизм проводимости у полупроводников
Кристаллы полупроводников имеют атомную кристаллическую решетку, где внешние электроны связаны с соседними атомами ковалентными связями.
При низких температурах у чистых полупроводников свободных электронов нет и он ведет себя как диэлектрик.

Полупроводники чистые (без примесей)
Если полупроводник чистый(без примесей), то он обладает собственной проводимостью? которая невелика.
Собственная проводимость бывает двух видов:
1) электронная (проводимость "n " - типа)
При низких температурах в полупроводниках все электроны связаны с ядрами и сопротивление большое; при увеличении температуры кинетическая энергия частиц увеличивается, рушатся связи и возникают свободные электроны - сопротивление уменьшается.
Свободные электроны перемещаются противоположно вектору напряженности эл.поля.
Электронная проводимость полупроводников обусловлена наличием свободных электронов.
2) дырочная (проводимость " p" - типа)
При увеличении температуры разрушаются ковалентные связи, осуществляемые валентными электронами, между атомами и образуются места с недостающим электроном - "дырка".
Она может перемещаться по всему кристаллу, т.к. ее место может замещаться валентными электронами. Перемещение "дырки" равноценно перемещению положительного заряда.
Перемещение дырки происходит в направлении вектора напряженности электрического поля.
Кроме нагревания, разрыв ковалентных связей и возникновение собственной проводимости полупроводников могут быть вызваны освещением (фотопроводимость) и действием сильных электрических полей
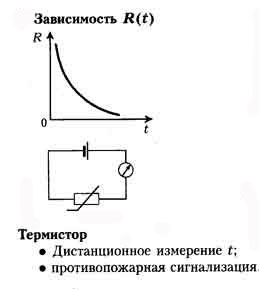

Общая проводимость чистого полупроводника складывается из проводимостей "p" и "n" -типов
и называется электронно-дырочной проводимостью.
Полупроводники при наличии примесей
- у них существует собственная + примесная проводимость
Наличие примесей сильно увеличивает проводимость.
При изменении концентрации примесей изменяется число носителей эл.тока - электронов и дырок.
Возможность управления током лежит в основе широкого применения полупроводников.
Существуют:
1) донорные примеси (отдающие)
- являются дополнительными поставщиками электронов в кристаллы полупроводника, легко отдают электроны и увеличивают число свободных электронов в полупроводнике.
Это проводники " n " - типа, т.е. полупроводники с донорными примесями, где основной носитель заряда - электроны, а неосновной - дырки.
Такой полупроводник обладает электронной примесной проводимостью.

Например - мышьяк.
2) акцепторные примеси (принимающие)
- создают "дырки", забирая в себя электроны.
Это полупроводники " p "- типа, т.е. полупроводники с акцепторными примесями, где основной носитель заряда - дырки, а неосновной - электроны.
Такой полупроводник обладает дырочной примесной проводимостью.

Например - индий.
Электрические свойства "p-n" перехода
"p-n" переход (или электронно-дырочный переход) - область контакта двух полупроводников, где происходит смена проводимости с электронной на дырочную (или наоборот).
В кристалле полупроводника введением примесей можно создать такие области. В зоне контакта двух полупроводников с различными проводимостями будет проходить взаимная диффузия. электронов и дырок и образуется запирающий электрический слой.Электрическое поле запирающего слоя препятствует дальнейшему переходу электронов и дырок через границу. Запирающий слой имеет повышенное сопротивление по сравнению с другими областями полупроводника.

Внешнее электрическое поле влияет на сопротивление запирающего слоя.
При прямом (пропускном) направлении внешнего эл.поля эл.ток проходит через границу двух полупроводников.
Т.к. электроны и дырки движутся навстречу друг другу к границе раздела, то электроны, переходя границу, заполняют дырки. Толщина запирающего слоя и его сопротивление непрерывно уменьшаются.
Пропускной режим р-n перехода: 
При запирающем (обратном) направлении внешнего электрического поля электрический ток через область контакта двух полупроводников проходить не будет.
Т.к. электроны и дырки перемещаются от границы в противоположные стороны, то запирающий слой утолщается, его сопротивление увеличивается.
Запирающий режим р-n перехода:

Таким образом, электронно-дырочный переход обладает односторонней проводимостью.
Полупроводниковые диоды
Полупроводник с одним "p-n" переходом называется полупроводниковым диодом.
При наложении эл.поля в одном направлении сопротивление полупроводника велико,
в обратном - сопротивление мало.
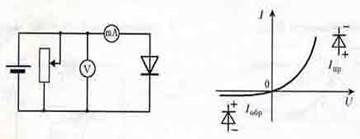
Полупроводниковые диоды основные элементы выпрямителей переменного тока.
Полупроводниковые транзисторы
- также используются свойства" р-n "переходов,

- транзисторы используются в схемотехнике радиоэлектронных приборов
Тема №6.
Полупроводниковые соединения типа AIII BV
Кристаллическая структура и химическая связь. Соединения AUIBV являются ближайшими электронными аналогами кремния и германия. Они образуются в результате взаимодействия элементов Ш-б подгруппы Периодической системы элементов Д. И. Менделеева (бора, алюминия, галлия, индия) с элементами V -б подгруппы (азотом, фосфором, мышьяком и сурьмой). Висмут и таллий не образуют соединений рассматриваемого ряда. Соединения AinBv принято классифицировать по металлоидному элементу. Различают нитриды, фосфиды, арсениды и антимониды. Полупроводниковые свойства соединений AmBv впервые были предсказаны отечественными учеными Н.А. Горюновой и А. Р. Регелем в начале 1950-х гг.
Рассматриваемые соединения относятся к группе алмазоподобных полупроводников. Все они, за исключением нитридов индия, галлия и алюминия, кристаллизуются в решетке цинковой обманки кубического типа — сфалерита, элементарная ячейка которой показана на рис. 10, а. Для нитридов характерна структура гексагонального типа — вюрцита (рис.10, б).

Рис. 10. Кристаллические структуры типа сфалерита (а) и вюрцита (б)
В решетке того и другого типов каждый атом элемента III группы находится в тетраэдрическом окружении четырех атомов элемента V группы, и наоборот. Обе структуры характеризуются отсутствием центра симметрии.
Для соединений AnIBv характерен особый тип химической связи, называемой донорно-акцепторной. Из четырех ковалентных sр3-связей, которыми каждый атом встраивается в решетку, три образуются обобществлением валентных электронов атомов А111 и Bv, а четвертая связь осуществляется неподеленной парой валентных электронов атомов Bv. На рис.11 такие электроны изображены крупными точками.

Рис. 11. Схема химических связей в соединениях AinBv на примере фосфида галлия
Образование этой связи соответствует энергетически выгодному переходу электронов от атома Bv в энергетическое состояние, общее для донора (атома Вv и акцептора (атома Аш). В каждой ковалентной связи максимум электронной плотности смещен в сторону атома с более высокой электроотрицательностью, т. е. электронные облака стянуты к узлам решетки, где находятся атомы Bv. Благодаря такой поляризации связей атомы А111 приобретают некоторый эффективный положительный заряд, а атомы Bv — отрицательный. Величина этого эффективного ионного заряда (±q) определяет степень ионности соединения, которая закономерно изменяется при переходе от одного соединения к другому в соответствии с положением химических элементов в Периодической системе элементов Д. И. Менделеева.
Полупроводниковые соединения AIIIBv образуют гомологический ряд, в котором наблюдается закономерное изменение многих свойств при изменении атомных номеров компонентов.
В большинстве случаев одна из эвтектик вырождена в сторону легкоплавкого металлического компонента. Благодаря этому образуется широкое температурное и концентрационное поле первичной кристаллизации соединения A!1IBV, что широко используется для выращивания монокристаллов и эпитаксиальных слоев рассматриваемых материалов из жидкой фазы. Точки плавления полупроводниковых соединений лежат выше соответствующих температур плавления исходных компонентов. Исключение составляет антимонид индия, температура плавления которого 525 "С лежит между температурой плавления сурьмы 630 °С и индия 157 "С.
Экспериментальные данные и теоретические расчеты свидетельствуют о возможности достаточно заметных отклонений от стехиометрического состава этих соединений.
Основными видами нестехиометрических дефектов структуры являются вакансии в обеих подрешетках, а также избыточные атомы в междоузельных позициях. В некоторых случаях существенную роль могут играть антиструктурные дефекты, когда собственный атом внедряется в «чужой» узел решетки.
Как правило, точечные дефекты в полупроводниковых кристаллах обладают электрической активностью и могут влиять на тип электропроводности и концентрацию носителей заряда. Например, вакансиии в металлической подрешетке в большинстве случаев ведут себя подобно акцепторным примесям, а антиструктурный дефект AS  в решетке GaAs играет роль двухзарядного донора. Отдельные точечные дефекты могут взаимодействовать между собой и образовывать более сложные комплексы. Протяженность области гомогенности полупроводниковой фазы уменьшается при понижении температуры. Воспроизведение стехи-ометрического состава кристаллов не означает уничтожение точечных дефектов структуры, а свидетельствует лишь о равенстве числа металлических и металлоидных атомов в решетке. Для кардинального улучшения структурного совершенства кристаллов необходимо понижать температуру синтеза соединений. Этим объясняется широкое распространение эпитаксиальных методов кристаллизации.
в решетке GaAs играет роль двухзарядного донора. Отдельные точечные дефекты могут взаимодействовать между собой и образовывать более сложные комплексы. Протяженность области гомогенности полупроводниковой фазы уменьшается при понижении температуры. Воспроизведение стехи-ометрического состава кристаллов не означает уничтожение точечных дефектов структуры, а свидетельствует лишь о равенстве числа металлических и металлоидных атомов в решетке. Для кардинального улучшения структурного совершенства кристаллов необходимо понижать температуру синтеза соединений. Этим объясняется широкое распространение эпитаксиальных методов кристаллизации.
За исключением антимонидов все соединения AinBv разлагаются при нагревании, причем разложение происходит по схеме

Равновесное давлениенасыщенного пара, состоящего практически из молекул компонента Bv, растет с повышением температуры и в точке плавления достигает значений 104... 105 Па для арсенидов и 106... 107 Па для фосфидов.
Большинство соединений AinBv имеют прямую структуру энергетических зон, т.е. положение главных экстремумов валентной зоны и зоны проводимости в них соответствует точке к = 0. К числу прямозонных полупроводников относятся нитриды элементов III группы Периодической системы элементов Д.И.Менделеева, все соединения с индием, а также арсенид и антимонид галлия. Именно в таких соединениях достигается максимальная эффективность рекомбинационного излучения, что используется при создании инжекционных лазеров и светоизлучающих диодов.
Внутри каждой группы соединений-аналогов наблюдается монотонное уменьшение ширины запрещенной зоны с ростом суммарного атомного номера и средней атомной массы. Такую закономерность можно объяснить увеличением межатомных расстояний в решетке и соответствующим ослаблением ковалентных химических связей при переходе к более тяжелым атомам. Уменьшение энергии химических связей сопровождается также понижением температуры плавления, предела механической прочности и твердости материала. Полупроводниковые соединения, образованные тяжелыми элементами, по своим механическим свойствам приближаются к металлам.
Прямозонные соединения отличаются существенно более высокой подвижностью электронов, что является следствием малой эффективной массы последних. Рекордно высокой подвижностью электронов (7,8 м2/(В • с)) при комнатной температуре обладает антимонид индия.
Основным фактором, ограничивающим подвижность носителей заряда в нормальных условиях, является их рассеяние на оптических тепловых колебаниях решетки, под которыми следует понимать противофазное смещение соседних атомов. Поскольку атомы Аш и Bv обладают некоторым ионным зарядом, то их противофазное смещение приводит к появлению дипольного момента, являющегося эффективным центром рассеяния электронов и дырок. Чем больше разность электроотрицательностей элементов, образующих соединение, тем сильнее выражена ионная составляющая химической связи. Соответственно возрастает рассеяние на оптических колебаниях решетки и уменьшается подвижность носителей заряда.
В ряду ковалентных полупроводников подвижность электронов повышается при переходе от алмаза к кремнию и далее к германию, т. е. приближенно можно считать, что подвижность носителей заряда увеличивается с ростом атомной массы. Аналогичная зависимость, более отчетливо выраженная для электронов, чем для дырок, имеет место и в соединениях AII!BV.
Вследствие большого различия в значениях подвижностей электронов и дырок в InSb, InAs, InPи GaAs их собственное удельное сопротивление практически полностью определяется движением электронов. При фиксированной температуре минимальная удельная проводимость этих материалов наблюдается у образцов р-тппа в области смешанной электропроводности.
Поведение примесей в соединениях AinBv в целом подчиняется тем же закономерностям, которые характерны для кремния и германия, а именно: примеси замещения с валентностью, большей валентности замещаемых атомов решетки, являются донорами, а с меньшей валентностью — акцепторами. Однако в бинарных соединениях существует два типа узлов, поэтому возникает вопрос о характере замещения. Исследования показывают, что встраивание примесей в кристаллическую решетку соединений AIIIBV происходит таким образом, чтобы при замещении не возникало центров с большим локальным зарядом. В частности, примеси элементов II группы (Be, Mg, Zn и Cd), образующие твердые растворы замещения, — всегда занимают узлы металлического компонента и при этом являются акцепторами благодаря меньшей валентности по сравнению с валентностью вытесняемых атомов (рис. 14).

Рис, 5.26. Схема поведения примесей в полупроводниковых соединениях типа AnIBv
В то же время примеси элементов VI группы (S, Se, Те) всегда располагаются в узлах Bv и играют роль доноров.
Более сложным характером отличается поведение примесей элементов IV группы. Поскольку в этом случае при замещении атомов одной из двух подрешеток имеется избыток или недостаток лишь одного валентного электрона, то атомы примесей IV группы могут занимать как узлы А111, так и узлы Bv, проявляя при этом донорные или акцепторные свойства соответственно. Замещение должно сопровождаться наименьшей деформацией кристаллической решетки. Поэтому одним из критериев донорного или акцепторного действия примесей может служить соответствие размеров замещающего и замещаемого атомов.
В большинстве случаев атомы примесей элементов IV группы локализуются в одной из подрешеток. Так, атомы углерода, отличающиеся малыми размерами, практически всегда проявляют акцепторные свойства. Среди элементов IV группы углерод характеризуется наименьшей растворимостью в соединениях AII!BV. Наоборот, атомы олова имеют достаточно большой ковалентный радиус и замещают более свободные металлические узлы в кристаллической решетке, создавая при этом мелкие донорные уровни в запрещенной зоне полупроводника. Кремний и германий замещают в антимониде индия только атомы сурьмы, а в арсениде индия — только индий. Однако в некоторых соединениях наблюдается амфотерное поведение этих примесей. Так, при легировании арсенида и фосфида галлия происходит парное вхождение атомов кремния и германия в кристаллическую решетку соединения с одновременным замещением узлов А111 и Bv. В зависимости от степени легирования, температуры роста и состава кристаллизационной среды имеет место преимущественное вхождение этих примесей в ту или иную подрешетку. При легировании амфотерными примесями полупроводник обычно оказывается компенсированным, т.е. концентрация носителей заряда в нем существенно меньше концентрации вводимых примесей.
Большинство соединений AinBv относительно просты по механизму легирования. Под этим подразумевается, что тип электропроводности полупроводника и концентрация носителей заряда в нем достаточно легко управляются изменением содержания легирующих примесей. Как правило, введение избытка одного из компонентов в среду кристаллизации не приводит к радикальному изменению электрофизических свойств материала. Такую особенность в поведении нестехиометрических дефектов структуры можно объяснить узкой областью гомогенности синтезируемых соединений при типичных температурах эпитаксиального процесса. Исключение из правила составляют нитриды. Например, нитрид галлия при легировании традиционными методами не инвертируется в материал с электропроводностью р-типа, что обусловлено достаточно высокой концентрацией вакансий азота, создающих мелкие донорные уровни. Лишь реализация низкотемпературных режимов эпитаксии, использование активных источников атомарного азота, применение дополнительной очистки исходных реагентов позволяют при легировании магнием и последующем отжиге в азоте при температуре около 700 "С получать слои с концентрацией дырок порядка 1024 м-3. В отличие от GaN кристаллы нитрида алюминия даже при введении легирующих примесей проявляют полуизолирующие свойства, так как доноры и акцепторы создают глубокие уровни в запрещенной зоне.
Элементы I группы в некоторых соединениях AmBv образуют твердые растворы внедрения. Они имеют один валентный электрон и при внедрении в междоузлие легко теряют его, т. е. проявляют свойства доноров. Если же эти атомы размещаются в узлах решетки, то они ведут себя как многозарядовые акцепторы, создавая несколько энергетических уровней в запрещенной зоне полупроводника.
Примеси переходных металлов (Fe, Ni, Co), а также Сг и Мn создают глубоколежащие энергетические уровни акцепторного типа и являются эффективными рекомбинационными ловушками. Например, легирование арсенида и фосфида галлия хромом используется для получения кристаллов с полуизолирующими свойствами. Благодаря компенсации полупроводника глубокими примесями удается получать материал с удельным сопротивлением свыше 107 Ом' м.
Атомы примесей V группы Периодической системы элементов Д. И. Менделеева замещают узлы в металлоидной подрешетке соединения, образуя нейтральные центры, изовалентные основным атомам. Если же атомы, участвующие в замещении, существенно Различаются по электроотрицательности и ковалентному радиусу, то в результате легирования образуются дискретные уровни в запрещенной зоне, которые способны захватывать носители заряда.
Примеси элементов III группы Периодической системы элементов Д. И. Менделеева входят как изовалентные атомы в металлическую подрешетку AnIBv. Экспериментальные данные указывают на отсутствие локальных состояний в запрещенной зоне полупроводника. При взаимозамещении Al, Ga и In отсутствуют ограничения на растворимость металлических компонентов в соответствующей подрешетке.
Имеются многочисленные свидетельства косвенного влияния изовалентных примесей на электрические свойства кристаллов. Механизм этого влияния может быть различным. Например, в результате изовалентного легирования может изменяться фон остаточных примесей или же происходить их перераспределение по узлам металлической и металлоидной подрешеток. Кроме того, электрические свойства могут изменяться вследствие образования малоподвижных ассоциатов, включающих в себя наряду с изовалентными центрами собственные точечные дефекты структуры или атомы электрически активных примесей. Так, легирование фосфида галлия азотом вызывает увеличение его удельного сопротивления на несколько порядков, что является следствием более сильной компенсации полупроводника. В свою очередь, возрастание степени компенсации при изовалентном легировании обусловлено частичным переселением остаточных атомов кремния из узлов галлия в металлоидную подрешетку. Такое перераспределение амфотерной примеси способствует уменьшению упругих искажений структуры, порождаемых встраиванием в решетку атомов азота. Аналогичным образом ведет себя висмут в кристаллах арсенида галлия.
Многообразие свойств полупроводников типа AmBv обусловливает их широкое применение в приборах и устройствах различного технического назначения. Особый интерес к этой группе материалов был вызван, прежде всего, потребностями оптоэлектроники в быстродействующих источниках и приемниках излучения. Инжекционные лазеры и светоизлучающие диоды на основе полупроводников AmBv характеризуются наиболее высокой эффективностью преобразования электрической энергии в электромагнитное излучение. Существенными достоинствами таких приборов являются компактность и конструктивная простота, совместимость с элементами интегральных микросхем по рабочим параметрам и технологическим операциям.
Большой набор значений ширины запрещенной зоны у полупроводников AmBv позволяет создавать на их основе различные виды фотоприемников, перекрывающих широкий диапазон спектра. Среди них наибольшее распространение получили фотодиоды и фотоэлементы, принцип действия которых основан на разделении генерируемых светом носителей заряда внутренним полем n-перехода. Фотодиоды работают в режиме обратного включения и отличаются малым временем формирования фотоответа.
По принципу действия к фотодиодам очень близки фотоэлектрические преобразователи солнечной энергии. Арсенид галлия является одним из лучших полупроводниковых материалов для применения в солнечных батареях, особенно в условиях космоса. По сравнению с кремнием арсенид галлия GaAs обладает более высокой термической и радиационной стабильностью. Наибольшая эффективность фотоэлектрического преобразования солнечного излучения (27 %) получена с помощью гетероструктур AlGaAs/GaAs при аккумулировании концентрированного светового потока. Пропорционально степени концентрации излучения уменьшается стоимость используемых материалов и структур.
Прогресс в технологии арсенида галлия, достигнутый за последние 25 лет, открыл богатые возможности применения этого материала при создании полевых транзисторов, больших (до 104 элементов) и сверхбольших (до 106 элементов) интегральных схем. По сравнению с кремнием арсенид галлия является более сложным в технологическом плане материалом. На нем трудно вырастить стабильный собственный оксид. Формируемая оксидная пленка характеризуется низким качеством и высокой плотностью поверхностных состояний, что затрудняет создание МДП-транзисторов. Кроме того, для арсенида галлия характерна невысокая растворимость донорных примесей, практически исключена возможность их диффузионного введения в кристалл. Разложение GaAs при высоких температурах создает дополнительные трудности при проведении операций отжига. Однако совершенствование техники эпитаксии, освоение технологии ионного легирования, лазерного отжига, электронно-лучевой литографии, а также разработка новых методов осаждения защитных слоев позволяют реализовать возможности арсенида галлия в повышении быстродействия интегральных схем при одновременном снижении потребляемой ими мощности. Этому способствуют высокая подвижность электронов и благоприятные теплофизические характеристики.
Среди других материалов, перспективных для применения в интегральной микроэлектронике, необходимо выделить фосфид индия. В сильных электрических полях InP характеризуется более высокой скоростью дрейфа электронов, нежели GaAs. Благодаря этому появляется возможность освоения частотного диапазона работы приборов СВЧ и сверхбыстродействующих ИС вплоть до 100 ГГц.
К важным достоинствам арсенида галлия и фосфида индия при их использовании в качестве материала для субмикронных быстродействующих приборов следует отнести и относительную простоту изготовления на их основе полуизолирующих подложек.
По масштабам применения и номенклатуре создаваемых приборов арсенид галлия прочно занимает второе место после кремния среди всех материалов полупроводниковой электроники. Из других применений GaAs следует отметить высокотемпературные выпрямительные диоды, детекторы ядерных излучений, лавинно-пролетные диоды. Токовая неустойчивость в сильных электрических полях, обусловленная междолинными переходами электронов, используется для создания генераторов СВЧ-колебаний (генераторов Ганна), работающих в диапазоне частот 109... 1010 Гц. Кроме арсенида галлия подходящими материалами для этих целей являются InP, InAs и твердые растворы на их основе.
Арсенид галлия и антимонид индия применяются для изготовления туннельных диодов. По сравнению с германиевыми диодами приборы из GaAs характеризуются более высокой рабочей температурой, а диоды из InSb отличаются лучшими частотными свойствами при низких температурах.
На основе узкозонных полупроводников AIIIBV (InAs, InSb), обладающих высокой подвижностью электронов, изготовляют магниторезисторы и датчики Холла. Антимонид индия применяют также для создания приемников ИК-излучения, проявляющих фоточувствительность вплоть до 7 мкм. Пластины фосфида индия находят массовое применение в качестве подложек при формировании эпитаксиальных лазерных и светодиодных гетероструктур, излучающих в области максимальной оптической прозрачности кварцевого волокна.
Твердые растворы на основе соединений A'"BV
Твердые растворы позволяют существенно расширить по сравнению с элементарными полупроводниками и полупроводниковыми соединениями набор электрофизических параметров, определяющих возможности применения материалов в конкретных полупроводниковых приборах.
Особенности внутреннего строения. Среди алмазоподобных полупроводников, в том числе соединений типа AniBv, распространены твердые растворы замещения. Необходимыми условиями образования твердых растворов являются кристаллохимическое подобие кристаллических решеток соединений-компонентов и близость размеров взаимозамещаемых атомов. Наиболее хорошо изучены тройные твердые растворы, в которых замещение происходит по узлам лишь одной из подрешеток бинарного соединения (металлической или металлоидной). Состав таких твердых растворов принято характеризовать символами АxВ1-x С и АСyD1-yгде А и В обозначают элементы III группы, а С и D — элементы V группы периодической системы элементов Д. И. Менделеева. В формуле АxВ1-x С индекс х определяет мольную долю соединения АВ в твердом растворе. Если твердые растворы существуют во всем диапазоне концентраций, то х может изменяться от 0 до 1.
При термодинамическом описании таких твердых растворов удобно в качестве независимых компонентов рассматривать два бинарных соединения, имеющих общий элемент. Фактически тройной твердый раствор представляет собой квазибинарную систему, в которой взаимозамещаемые атомы статистически неупорядоченно распределяются по узлам соответствующей подрешетки. Критерий непрерывной растворимости компонентов в этом случае сводится к соответствию периодов решеток соединений-партнеров, образующих твердый раствор.
Несмотря на отсутствие строгой трансляционной симметрии твердые растворы во многих аспектах подобны кристаллическим веществам: им также присуща анизотропия физических свойств, рентгеновская дифракция выявляет в их структуре определенную элементарную ячейку с некоторыми усредненными параметрами, для них характерен зонный характер энергетического спектра электронов, т. е. к ним применимы основные представления зонной теории твердого тела. Таким образом, в изовалентных твердых растворах элементы структурного беспорядка выражены относительно слабо. Как и в бинарных соединениях, между атомами устанавливаются смешанные ковалентно-ионные sp3-гибридные связи, поскольку в среднем сохраняется четыре валентных электрона на атом.
По своему внутреннему строению и свойствам эти материалы занимают промежуточное положение между упорядоченными и неупорядоченными фазами. Благодаря жестким ковалентным связям в них не наблюдается значительных отклонений от стехиометрического состава, если под стехиометрией понимать равенство между всей совокупностью металлических атомов решетки и суммарным числом атомов металлоидных элементов.
Подобно бинарным соединениям, твердые растворы относительно просты по механизму легирования, допускают инверсию типа электропроводности, что открывает возможности формирования в них электронно-дырочных переходов. Различия в кова-лентных радиусах взаимозамещаемых атомов являются причиной деформации равновесных длин связей и валентных углов. Энергия внутренних упругих искажений решетки накладывает ограничения на взаимную растворимость компонентов и определяет термодинамическую устойчивость твердого раствора. Из-за сильного различия размеров металлоидных атомов твердые растворы не образуются между нитридами АШВУ, с одной стороны, и фосфидами, арсенидами или антимонидами — с другой (за исключением областей крайне низкой концентрации растворяемого компонента). Наоборот, близость ковалентных радиусов атомов алюминия и галлия обеспечивает образование непрерывных твердых растворов в системах AlxGa1-xAs, AlxGa1-x Р и AlxGa1-xSb во всем диапазоне концентраций.
В гомогенных твердых растворах слабо выражены эффекты, связанные с размытием спектра электронных состояний. Поэтому у прямозонных полупроводников сохраняются достаточно резкий край собственного поглощения и сравнительно узкие линии в спектре рекомбинационного излучения. Отмеченные обстоятельства позволяют рассматривать изовалентные твердые растворы как важнейшие материалы оптоэлектроники. К этому следует добавить, что температурные изменения электрофизических параметров также принципиально не отличаются от соответствующих зависимостей для бинарных соединений.
Многие свойства твердых растворов являются аддитивными функциями состава. Поэтому для расчета физических параметров материала широко используются методы линейной интерполяции. Здесь уместно выделить правило Вегарда, устанавливающее линейную зависимость периода решетки от состава квазибинарного твердого раствора. Пользуясь этим правилом, можно надежно определять состав твердых растворов по измерениям периода решетки с помощью рентгеновских методов дифракции.
Получение однородных твердых растворов представляет собой весьма трудную технологическую задачу. Обычными методами кристаллизации из расплава в лучшем случае удается получать однородные поликристаллические слитки. Монокристаллические слои твердых растворов, используемые в приборных структурах, формируют исключительно методами эпитаксии. При этом практически всегда приходится иметь дело с гетероэпитаксией, т. е. производить осаждение слоев на инородные подложки. В качестве последних используют пластины бинарных соединений, вырезанные из объемных слитков параллельно определенной кристаллографической плоскости. Сравнительно редко применяют подложки из других материалов (кремний, сапфир).
Более совершенными и надежными методами формирования эпитаксиальных структур на основе твердых растворов являются химическое осаждение из паров металлоорганических соединений и молекулярно-пучковая эпитаксия (см. подразд. 5.5). Химическое осаждение твердых растворов осуществляется в соответствии с реакциями следующего типа:

Изменяя давление алкилов и гидридов на входе в реакционный объем, можно легко управлять составом кристаллизуемой фазы и скоростью осаждения.
В методе молекулярно-пучковой эпитаксии состав синтезируемого материала зависит от плотности потоков веществ, испаряемых из эффузионных ячеек. Средства управления и диагностики позволяют контролируемо осаждать слои с требуемым содержанием компонентов толщиной менее одного периода кристаллической решетки.
Применение твердых растворов. Область применения твердых растворов достаточно многообразна, но преимущественно ориентирована на полупроводниковую оптоэлектронику. Именно с помощью твердых растворов удается получать самые высокоэффективные лазеры и светоизлучающие диоды. Исключительная роль твердых растворов в полупроводниковой технологии определяется прежде всего тем, что при их использовании появляются большие возможности для формирования высококачественных гетеропереходов. Под гетеропереходом понимается контакт двух полупроводников с различной шириной запрещенной зоны. Композиции, сформированные из нескольких гетеропереходов, называются гетероструктурами. Различают изотипные и анизотипные гетеропереходы. Изотипный гетеропереход образуют материалы с одинаковым типом электропроводности, а в анизотипных гетеропереходах знак основных носителей заряда различен по обе стороны от гетерограницы.
Гетеропереход, в котором отсутствуют поверхностные состояния (дефекты) на гетерогранице, называют идеальным. В таком гетеропереходе скорость поверхностной рекомбинации ничтожно мала. Для создания гетероперехода со свойствами идеального контакта необходимо добиться строгого согласования периодов решеток сопрягаемых материалов. Допустимые несоответствия периодов Аа/а, как правило, не должны превышать 0,1 %. Только в этом случае удается избежать генерации дислокаций, обусловленных релаксацией возникающих упругих напряжений.