Формула Шокли (4.15) удовлетворительно описывает вольт-амперные характеристики германиевых pn переходов при низких плотностях токов. Однако для полупроводников с большей шириной запрещённой зоны (кремний, арсенид галлия) и, соответственно, с меньшим значением ni, эта формула даёт лишь качественное согласие с реальными характеристиками. Основными причинами отклонения характеристики от идеальной являются: 1) влияние процессов генерации и рекомбинации носителей в обеднённом слое, 2) высокий уровень инжекции при прямом смещении, 3) влияние последовательного сопротивления.
При обратном смещении перехода, когда  преобладающим в переходе будет процесс эмиссии носителей. При этом скорость генерации электронно-дырочных пар в этих условиях будет определяться временем жизни:
преобладающим в переходе будет процесс эмиссии носителей. При этом скорость генерации электронно-дырочных пар в этих условиях будет определяться временем жизни:
 , (5.5)
, (5.5)
где tе - время жизни, определяемой концентрацией генерационных центров (см. 2.15). Плотность тока, обусловленного генерацией в обеднённой области принимается равной
 , (5.6)
, (5.6)
где W - ширина обеднённого слоя. Температурная зависимость генерационного тока определяется температурной зависимостью ni, а не ni2, как для диффузионного тока. В этом случае наклон характеристики в логарифмическом масштабе от обратной температуры (lnJ =f(1/T) для генерационного тока в два раза меньше, чем для диффузионного тока, т.е. определяется величиной Eg/2.
При заданной температуре ширина обеднённого слоя резкого перехода увеличивается с напряжением как (5.2), а полный обратный ток определяется суммой диффузионного тока в нейтральной области и генерационного тока:
 (5.7)
(5.7)
В полупроводниках с большим значением ni, таких как германий, преобладает диффузионнный ток. Если ni мало (как в кремнии), то преобладает генерационный ток. В этом случае величина обратного тока перехода резко возрастает, как приведено на рисунке 5.1¶.
|
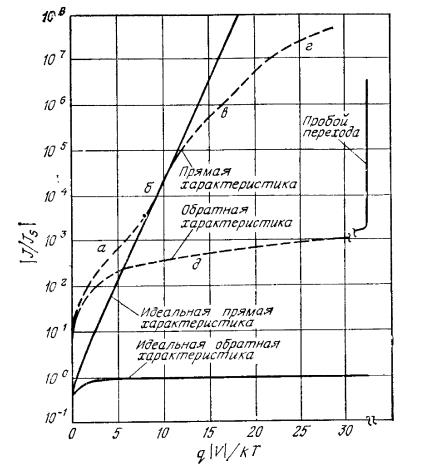
При прямом смещении, когда в обеднённом слое идут интенсивные процессы рекомбинации, к диффузионному току добавляется рекомбинационный ток, что заметно на кривой a) рисунка 5.1. При дальнейшем сильном увеличении тока концентрация инжектированных неосновных носителей сравнивается с концентрацией основных носителей и здесь необходимо учитывать не только диффузионную, но и дрейфовую составляющую тока. Это приводит к изменению наклона прямой характеристики вида в) рисунка 5.1. И, наконец, при высоких плотностях тока начинает играть роль конечное последовательное сопротивление областей, примыкающих к диоду (вид кривой г) на рисунке 5.1. Во всех этих случаях идёт отклонение прямой ветки тока в полулогарифмическом масштабе от идеальной, определяемой значением наклона q/kТ, что следует из уравнения (4.15).
Диффузионная ёмкость
|

Такая емкость проявляет себя при переменном сигнале. Тогда проводимость перехода G и его емкость C можно определить, рассматривая схему рисунка 5.2. При этом СºdQ/dV ~ d(qDn)/dV, где d(Dn)/dV - изменение концентрации неосновных носителей при переменном сигнале.
Пробой pn перехода
При большом обратном смещении на pn переходе, которое создаёт большое электрическое поле, переход "пробивается", т.е. через него течет большой ток. Различают три механизма пробоя: тепловой, туннельный и лавинный.
При протекании большого тока в обратно -смещенном переходе выделяется тепло (это особенно характерно для материалов с малой шириной запрещенной зоны, например, германия). Увеличение температуры на переходе приводит к увеличению тока (например, как в (5.1), что опять приводит к увеличению температуры и т.д., что может привести разрушению диода (диод "горит"), если не принять мер по ограничению тока. Такоё явление называется тепловым пробоем. До такого режима работы стараются не допускать, вследствие разрушения прибора.
Туннельный пробой имеет место в pn переходе обе стороны которого являются вырождены (сильно легированы). Уровень Ферми в каждой стороне будет находится не в запрещённой зоне, а в зоне проводимости для n- п/п типа и в валентной зоне для п/п р- типа.
Энергетическая диаграмма такого диода приведена на рисунке 5.3
|

Ширина такого pn перехода составляет менее 100Å. Даже маленькие напряжения на таком переходе приводят к очень большому электрическому полю ~106в/см. При небольшом обратном смещении электроны из валентной зоны п/п р- типа могут переходить на свободные места в зоне проводимости n -типа - туннелируя через потенциальный барьер. (Это явление квантовое. Оно означает, что волновая функция электрона левой части отлична от нуля в правой части, а значит электрон имеет вероятность локализации в правой части и эта вероятность отлична от нуля при конечной величине потенциального барьера близкому к Eg). Такой вид протекания тока при обратном смещении называется туннельным. Вид такой характеристики показан на рисунке 5.4. Такие диоды носят название диодов Зенера по имени ученого Карлоса Зенера, который впервые исследовал такое явление в 1933г. Данный механизм пробоя действует до 5.5В, дальше преобладает лавинный механизм пробоя.
|

С увеличением температуры ширина запрещённой зоны, как показывают эксперименты, уменьшается, и напряжение туннельного пробоя падает, что видно на рисунке 5.4.
Наиболее распространённым является лавинный пробой. В основе лавинного пробоя лежит явление "размножения носителей" в сильном электрическом поле, действующем в области перехода. Электрон и дырка, ускоренные электрическим полем на длине свободного пробега, могут разорвать одну из ковалентных связей нейтрального атома полупроводника. В результате рождается новая пара электрон - дырка и процесс повторяется уже с участием новых носителей. При достаточно большой напряжённости поля, когда исходная пара порождает больше одной новой пары, ионизация приобретает лавинный характер, подобно самостоятельному разряду в газах. При этом ток будет ограничиваться только внешним сопротивлением.
Если ширина перехода равна W, то максимальное электрическое поле Еm, вызывающее лавинный процесс, связано с напряжением пробоя VB выражением:  , т.е. поле Еm образуется напряжением VB, приложенным к половине перехода.
, т.е. поле Еm образуется напряжением VB, приложенным к половине перехода.
Т.к. (см. (3.7))  , а для резкого перехода, в котором NA>>ND, а значит Xn>>Xp и Xn»W, можно записать
, а для резкого перехода, в котором NA>>ND, а значит Xn>>Xp и Xn»W, можно записать  или
или  , то
, то
 (5.8)
(5.8)
Очевидно, что с увеличением концентрации размер обеднённой области становится меньше и при одном и том же значении Еm напряжение пробоя VВ.уменьшается.
График на рисунке 5.5 иллюстрирует этот вывод
|

Для расчёта Еm используется эмпирическая формула:
 , (5.9)
, (5.9)
где NB измеряется в см-3
Для pn переходов с другими профилями примеси (не резкими) такая тенденция (уменьшения напряжения пробоя с увеличением концентрации) аналогична.
С повышением температуры напряжение лавинного пробоя возрастает (в отличие от туннельного пробоя). При повышенной температуре носители легче тратят свою энергию на взаимодействие с колебаниями решетки (фононами), чем на ионизацию, поэтому нужно повышать электрическое поле, а значит и обратное напряжение для достижения эффекта лавины.
Отметим ещё одну важную особенность лавинного пробоя pn переходов, создаваемых в локальных областях поверхности кремния (это ~ 99% всех диодов). Как видно из рисунка 5.6 такие диоды смеют цилиндрические и сферические области, в которых размер обеднённой области меньше, чем у плоской части и, соответственно, напряженность поля выше при заданном напряжении на переходе. Именно в таких местах и будет проходить лавинный пробой перехода.


| |||
| |||
Это особенно заметно при формировании точечных диодов - диодов с очень малой площадью электрического перехода, который может быть получен вплавлением металлической иглы с нанесенной на неё примесью в полупроводниковую пластинку с определенным типом электропроводимости. (рис. 5.7)
Благодаря малой площади p-n перехода, и как следствие маленькой ёмкости перехода, точечный диод обычно имеет предельную частоту около 300—600 МГц. При использовании более острой иглы без электроформовки получают точечные диоды с предельной частотой порядка десятков гигагерц.
[1] Изобретение Бардиным, Бреттейном и Шокли биполярного транзистора в Bell Lab.Incorporated в 1947г.
[2] Индексы c и v происходят от conduction band и valence band
[3] Электрохимический потенциал характеризует в термодинамике приращение энергии системы, при изменении количества носителей на единицу
[4] С Зи "Физика полупроводниковых приборов" Книга 1 стр. 22