


На практике значительно проще измерить х и у, где x=a—b
y=a+b,a xy =a2-b2 При этом d0=(1/2R)xy=xy/D Считается, что этот способ позволяет точнее определить край и получить лучшее окрашивание, а следовательно, более точно измерить глубину перехода.
К параметрам диффузионного слоя относят глубину залегания p-n - перехода xJ, поверхностное сопротивление слоя RS (поверхностную концентрацию примеси NS) и зависимость концентрации примеси от глубины N(х).
Обычно xJ измеряют с помощью сферического шлифа. Для этого вращающимся металлическим шаром диаметром 20 - 150 мм, на поверхность которого нанесена алмазная паста, вышлифовывают лунку на поверхности пластины. Образовавшаяся лунка должна быть глубже уровня залегания p-n - перехода (рис.3.8).
Для четкого выявления p-n - перехода (границ областей) применяют химическое окрашивание. Например, при обработке шлифа в растворе, состоящем из НБ (20 вес.ч.) и СuSО4 (100 вес.ч.), покрывается медью n-область. При обработке в плавиковой кислоте с добавкой 0,1%-ной HNOз темнеют p- области.
После окрашивания в поле инструментального микроскопа должны быть четко видны две концентрические окружности. Измерив с помощью микроскопа длину хорды внешней окружности, касательную к внутренней окружности, можно рассчитать глубину залегания p-n - перехода:
xJ = l2 / 4d Ø,
где l - длина хорды; d Ø - диаметр металлического шара.
Погрешность определения xJ в этом случае составляет около 2 %.  Рис.3.8Принцип измерения глубины залегания p-n перехода
Рис.3.8Принцип измерения глубины залегания p-n перехода
Контроль концентрации легирующей примеси в диффузионном слое.

Для определения удельной электрической проводимости тонких диффузионных слоев измеряется xJ и поверхностное сопротивление слоя RS четырехзондовым методом. Для измерения RS на поверхности кремния по прямой линии располагают четыре зонда на равных расстояниях друг от друга (обычно 1 нм). Через внешние зонды пропускают ток I, внутренние зонды служат для измерения падения напряжения U компенсационным методом. Схема измерения представлена на рис.3.9.
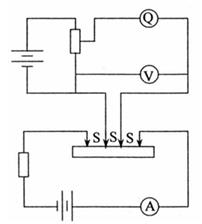
Рис. 3.9 Схема измерения поверхностного сопротивления диффузионного
 |
cлоя
Удельное сопротивление слоя, или поверхностное сопротивление (Ом/кв) определяется по формуле
где k - геометрический коэффициент.
В случае образцов, диаметр которых много больше расстояния между зондами S, коэффициент k ≈π/ln2 ≈ 4,54.
 |
Удельное объемное сопротивление (Ом*см) слоя связано с RS:
С помощью четырехзондового метода можно построить график зависимости распределения концентрации примеси по глубине слоя. С этой целью измерения RS чередуют со снятием тонких поверхностных слоев кремния (анодное окисление кремния с последующим стравливанием SiO2).
Между средней проводимостью слоя и поверхностной концентрацией примеси в слое существует связь, для определения которой необходимо знать закон распределения примеси и исходную концентрацию ее в подложке Nn. Для двух функций распределения (exp и еrfc) этот расчет приводится в специальной литературе.
Ионное лигирование
Эффект каналирования
В том случае, когда кристалл ориентирован точно по направлению с низкими кристаллографическими индексами, для движущегося иона ряды атомов кристалла образуют как бы канал (рис.3.15,а), а траектория иона совпадает с осью канала (рис,3.15,б).
Движение частиц строго по центру канала маловероятно, однако вполне может существовать траектория, осциллирующая около оси канала, из-за последовательных легких соударений иона с рядами атомов, образующих стенки канала.

Рис. 3.15 Эффект каналирования: а- расположение атомов в кремнии в плоскости, перпендикулярной направлению [110]; б - движение внедрённого иона вдоль канала 1, образованного атомами мишени 2.
Максимальный угол р, при котором исчезает направляющее действие ряда атомов, называется критическим углом каналирования pK.
Значения критического угла в зависимости от энергии некоторых бомбардирующих ионов, представляющих практический интерес, приведены в табл.3.5 для трех основных ориентации кремниевой мишени.
Таблица 3.5

Если падающий пучок ориентирован вдоль кристаллографической оси в пределах угла каналирования, то существенная часть падающих ионов будет направлена по каналам; в противном случае кристаллическая мишень окажется по существу неотличимой от аморфной.
Часть ионов может в результате столкновений выйти из канала - такие ионы принято называть деканалированными.
Каптированные ионы образуют иногда явно выраженный пик. Качественно теория ЛШШ представляет окончательное распределение ионов в виде суперпозиции двух гауссовых распределений, обладающих двумя максимумами (рис.3.16).
Рис. 3.16 Распределение примеси при каналировании: I - основное распределение, II - деканалированные ионы, III - каналированные ионы
 (3,16)
(3,16) 
.
2. Атомное и электронное торможение имплантированных ионов.Боковое рассеяние.
Для расчета зависимости пробега от энергии частицы в случае ионного внедрения рассматриваются два основных вида потерь энергии: в результате взаимодействия с электронами твердого тела (как связанными, так и свободными) и при столкновении с ядрами мишени.
 |
Считается, что эти два вида потерь энергии не зависят друг от друга. Такое допущение позволяет выразить среднюю величину удельных потерь энергии для одной бомбардирующей частицы в виде суммы:
где Е - энергия частицы в точке х, расположенной на ее пути; SN (E)- ядерная тормозная способность; SE (E) - электронная тормозная способность; N - среднее число атомов в единице объема мишени.
Ядерная тормозная способность SN (E)- это энергия, теряемая движущимся ионом с энергией Е на интервале пути Дх при столкновении с ядрами мишени, плотность которой равна единице.
Электронная тормозная SE (E)- это энергия, теряемая движущимся ионом с энергией Е при столкновении с электронами.
При известных SN(E) и SE(E) интегрирование (3.20) дает общее расстояние R, пройденное движущимся ионом с начальной энергией Е0 до его остановки,
 |  | ||
Было показано, что в первом приближении ядерная тормозная способность SN (E) может не зависеть от энергии движущегося иона и равна
где
Z1/3 = (Z2/3 + Z22/3)1/2
Здесь Z1 и Z2 - атомные номера движущейся частицы и атома мишени соответственно, а M1 и M2 - их массы.
В предположении, что все электроны твердого тела образуют свободный электронный газ, электронная тормозная способность пропорциональна скорости V движущегося иона, если только V меньше скорости электрона, соответствующей энергии Ферми EF свободного электронного газа. Тогда
SE(E) = kE1/2. (3.22)
Коэффициент пропорциональности k определяется природой как движущегося иона, так и материала подложки, Однако в приближенных расчетах для аморфной подложки следует считать, что величина к почти не зависит от свойств движущейся частицы. Для аморфного кремния она составляет
k ≅ 0,2 -10-15уА1,2 • ni 2
Если величины SE и SN определяются выражениями (3.21) и (3.22), то SE с увеличением Е возрастает, а EN, меняется мало. Тогда существует некоторая критическая энергия EK при которой S0N и SE будут равны:

Величина EK для бомбардирующих ионов бора (Z1= 5, M1= 10) составляет около 10 кэВ, в случае ионов фосфора (Z1= 15, M1 = 30) она равна приблизительно 200 кэВ.
 |
Если начальная энергия бомбардирующего атома значительно меньше ЕЬ то преобладающим механизмом потерь энергии будет ядерное торможение. В этом случае соотношение (3.20) можно заменить на следующее:
 |
Оценка соответствующего пробега для кремниевой мишени (N = 5 -1022ni -3) дает
где Е0 - начальная энергия, выраженная в электрон-вольтах. Если взять более точные значения S0N, то для Е0«EK пробег будет все еще приблизительно пропорционален энергии, однако коэффициент пропорциональности станет гораздо более сложным.
Значения R для легких ионов (бор, углерод и азот) в кремниевой мишени, найденные с помощью (3.23), примерно в два раза выше экспериментальных; однако для более тяжелых бомбардирующих ионов это соотношение позволяет определить значения R. в пределах 10 % (германий, мышьяк).
Если начальная энергия движущегося иона гораздо больше EK, то электронное торможение преобладает над ядерным и соответствующий пробег для кремниевой мишени равен
 |
Радиационные нарушения мишени создаются преимущественно в той области энергии бомбардирующих ионов, где SN«SE. При внедрении ионов малых энергий радиационные дефекты образуются вдоль всей траектории частицы, а в случае бомбардировки ионами высокой энергии - только в конце пробега. При ориентации кристалла в произвольном направлении иону трудно избегать близких ядерных столкновений. Соответственно движущийся атом, влетая в решетку, теряет в результате большого числа ядерных столкновений значительную часть своей энергии (выбивая атомы из узлов решетки), так что кристалл предстает в виде почти аморфной мишени. В этом случае для оценки распределений пробегов можно использовать изложенную теорию.

3. Структурная схема и принцип работы установки ионного легирования
Развитие методов ионного легирования и внедрение его в промышленное производство зависят от наличия специального технологического оборудования. Существующие типы ионных ускорителей предназначены для работы в диапазоне энергий от 10 кэВ до нескольких мегаэлектрон-вольт, но чаще всего энергия ионов лежит в интервале от 20 до 500 кэВ, а ионный ток - от нескольких микроампер до десятков миллиампер. Причина ограничения энергии ионов несколькими сотнями килоэлектронвольт заключается в том, что стоимость аппаратуры постоянно возрастает, а методы генерации и анализа ионов усложняются.
Установки ионного легирования содержат следующие основные части: ионный источник, анализатор ионов по массам, сканирующее устройство и коллектор ионов. На рис.3.20 приведена схема установки для ионного легирования.

Рис.3.20. Схема установки для ионного легирования: 1 - источник ионов; 2 - вытягивающий электрод; 3 - фокусирующие линзы; 4 - ускоритель; 5 - устройство коррекции пучка ионов; 6 - диафрагмы; 7 - электронный масс- сепаратор; 8 - система отклонения (сканирования) пучка; 9- заслонки; 10 - коллектор; 11 - облучаемые мишени.
Для каждого типа примесей используется отдельный ионный источник, а конструкция установки предусматривает его свободную замену. В ионном источнике ионизируются газообразные, жидкие или твердые исходные вещества и ускоряются в электрическом поле. Ускоренный ионный пучок для удаления многозарядных ионов и загрязняющих его ионов примесей поступает в систему, чувствительную к массе ионов (анализатор по массам).
Для равномерного облучения поверхности образца применяют два различных метода. Первый состоит в следующем: диаметр ионного пучка, облучающего поверхность образца, больше диаметра самого образца, причем распределение плотности ионного тока по образцу равномерное. Поэтому вместо фокусирующей линзы используют дефокусирующую. Во втором методе диаметр пучка делают малым, а затем сканируют его по поверхности образца. Для этого после анализатора ионов по массам используют систему фокусирующих линз. Система сканирования необходима не только для равномерной обработки пластины, но и для направления пучка в нужную ее часть. Так как при легировании возникает необходимость свободно изменять температуру и угол легирования, пластина устанавливается в камере для образцов, где можно проводить все эти регулировки. Дозу легирования определяют с помощью интегратора тока.