Цель работы – приобретение навыков по исследованию собственно-дефектной структуры полупроводникового соединения по диаграмме равновесия собственных точечных дефектов.
Диаграммы равновесия собственных точечных дефектов (СТД) дают богатую информацию о дефектах в кристалле бинарного соединения в зависимости от условий роста. Построение этих диаграмм базируется на известных физико-химических свойствах кристалла, таких как: температурная зависимость ширины запрещенной зоны, константы диссоциации и давления насыщенных паров металла (металлоида), а также знании энергий дефектообразования и ионизации дефектов. Расчет диаграмм проведен по схеме Шоттки-Френкеля при постоянной температуре для кристалла, выращенного из паровой фазы. Поскольку установление равновесия возможно только при температурах, когда подвижность дефектов (их диффузия) еще достаточно высока, то результаты расчета соответствуют высоким температурам роста или термообработки кристаллов.
Высокотемпературное равновесие может быть пересчитано к низкой температуре, при которой кристалл используется. Такой пересчет соответствует закалке – условно до 0 или 300 К. При резком охлаждении кристалла закалке, высокотемпературное равновесие практически сохраняется для атомных дефектов вследствие их малой подвижности. Концентрации атомных дефектов не успевают измениться. Однако электронные дефекты (избыточные электроны и дырки), обладая высокой подвижностью, при любой скорости охлаждения приходят к новому равновесию, перераспределяясь между атомными дефектами (по уровням акцепторов и доноров в соответствии со статистикой Ферми). Такое перераспределение электронов и дырок означает перезарядку атомных дефектов. Соответствующая "низкотемпературная" диаграмма равновесия той же системы (охлажденной с закалкой до 0 К) предлагается для изучения.
Р-Т-Х диаграммы ряда соединений (рис. 7.1 – 7.3) построены на основе расчетов равновесия СТД при разных температурах в приемлемом для диффузии диапазоне температур. Р-Т-Х диаграмма определяет область существования соединений, ограничивая ее прямыми, соответствующими температурной зависимости давления насыщенных паров компонентов. На шкале давлений Р-Т-Х диаграммы приведено только давление Р м для компонента М, а давление паров второго компонента Р Х2, связанное с ним через константу диссоциации соединения, можно найти при сопоставлении шкал Р м – Р Х2 на предложенной Вам диаграмме для заданной температуры (или из константы диссоциации Кдис).

Рис. 7.1. Р-Т-Х диаграммы ZnS (а) и ZnSe (б)
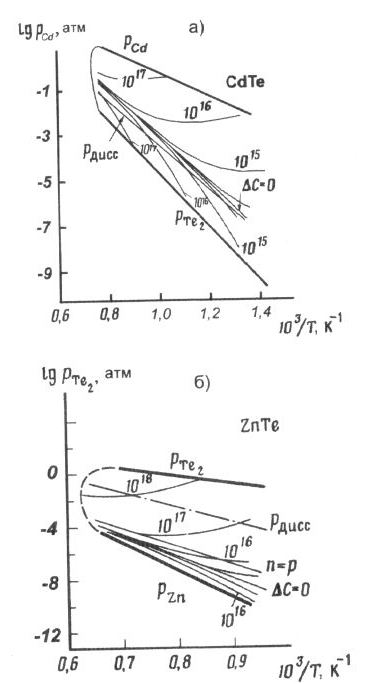
Рис. 7.2. Р-Т-Х диаграммы CdTe (а) и ZnTe (б)
В зависимости от условий получения соединения: температуры и давления паров компонентов Р-Т-Х диаграмма позволяет получить ряд важных технологических сведений о кристалле: точку стехиометрического состава ΔС=0, величину и тип отклонения от стехиометрии, точку п = р и др.
Анализ собственно-дефектной структуры кристалла по диаграмме равновесия СТД предполагает следующий порядок выполнения работы.
Уяснить схему дефектообразования, записав ее в виде системы уравнений, определяющих образование электронных и всех видов атомных дефектов, условия ионизации последних, реакцию собственно-дефектной структуры кристалла на состав внешней среды – газовой фазы. Кроме того, одним из необходимых уравнений схемы дефектообразования – равновесия дефектов, является условие электронейтральности кристалла.
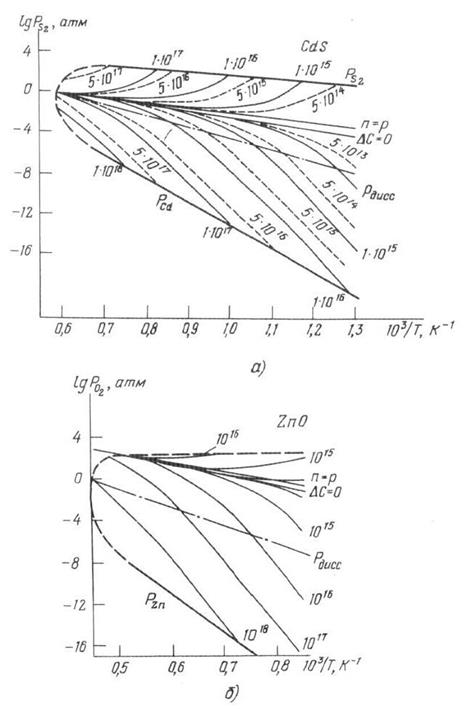
Рис. 7.3. Р-Т-Х диаграммы CdS (а) и ZnO (б)
По прилагаемой Р-Т-Х диаграмме Вашего соединения необходимо определить имеет ли оно одностороннюю или двустороннюю область гомогенности, а затем на своей диаграмме отметить точки Р м mах или Р Х2mах, которые ограничивают область гомогенности соединения при конкретной температуре роста кристалла (расчета высокотемпературного равновесия).
Рассчитать величину отклонения от стехиометрии ΔС, понимая под стехиометрией соответствие состава кристалла химической формуле соединения. Максимальное отклонение от стехиометрии определяем на границах области гомогенности по суммарной концентрации дефектов, при водящих к избытку одного из компонентов. Величина ΔС зависит от типа дефектов в кристалле. Например, при избытке М:
ΔС = [М i ] + [Vx] – [VM],
считая, что [М i ], [Vx] и [VM] включают все типы разнозаряженных дефектов. При определении отклонения от стехиометрии выявить преобладающий тип дефектов и указать избытку какого из компонентов (М или Х) соответствует полученная величина ΔС.
Найти на диаграмме точку стехиометрического состава соединения ΔС = 0, определив таким образом условия получения соединения стехиометрического состава. В точке стехиометрии суммарная концентрация дефектов минимальна, и кристалл более совершенен.
Определить тип проводимости кристалла на границах области гомогенности. Для этого, исходя из общих соображений, разобраться какие типы дефектов в соединении МХ являются донорами и какие акцепторами. Например, к донорам следует отнести М i, Vx; к акцепторам – VM, Х i и т.д.
В тех случаях, когда избыток всех типов доноров превышает концентрацию всех типов акцепторов более чем на порядок, можно полагать, что полупроводник имеет п -тип проводимости (и, наоборот, в случае преобладания акцепторов – р -тип проводимости).
Оценить величину проводимости кристалла, которую определяют дефекты. В том случае, когда имеется несколько типов доноров, необходимо рассчитать концентрацию электронов, поставляемых в зону проводимости отдельно каждым донором. Затем определить проводимость, просуммировав все электроны.
При расчете проводимости Вам необходимо построить схемы расположения в запрещенной зоне уровней дефектов, ответственных за проводимость п - или р -типа. Построение схем необходимо для выяснения –какое зарядовое состояние (одного и того же дефекта) дает свободный носитель – дырку или электрон.
Например, для дефекта М i × <=> М i + величина Nd определяется концентрацией [М i ×], поскольку М i × отдает электрон, перезаряжаясь в М i +. Для дефекта V M2 – <=> V M – концентрация акцепторов Na определяется [ V M –], так как V M – – h <=> V M2 – и т.п.
Схемы должны быть построены для каждого изучаемого разреза отдельно в масштабе Eg, учитывая положение уровней дефектов в запрещенной зоне по данным таблицы 1. Столбец Δ Ed определяет две энергии ионизации собственных доноров. В большинстве случаев учитываем только мелкие доноры, реже учитывается также глубокий донор. Столбец Δ Ea определяет две энергии ионизации собственных акцепторов.
В средней части диаграммы полупроводник становится высокоомным вследствие взаимной (частичной или полной) компенсации доноров и акцепторов. В этой области соединение имеет "точку п = р " перехода от п - к р -типу проводимости. Определить ее и выявить условия получения высокоомного материала.
Некоторые физико-химические характеристики соединений Таблица 7.1
| мх | Еg, эВ | μ n, | μ p, | mn * /m0 | mp * /m0 | Δ Ed, эВ | Тип | Δ Ea, эВ | Тип | |
| З00К | см2/В·с | см2/В·с | от Еc | дефекта | от Еv | дефекта | ||||
| ZnO | 3,02 | 10-20 | 0,32 | 0,27 | 0,04 | М i ×(+) | 0,9 | V M ×(–) | ||
| 0,15 | М i +(2+) | 1,8 | V M – (2–) | |||||||
| ZnS | 3,52 | 0,25 | 0,75 | 0,1 | М i ×(+) | 0,6 | V M ×(–) | |||
| 0,2 | М i +(2+) | 1,9 | V M – (2–) | |||||||
| ZnSe | 2,58 | 0,17 | 0,60 | 0,07 | М i ×(+) | 0,5 | V M ×(–) | |||
| 0,23 | М i +(2+) | 1,1 | V M – (2–) | |||||||
| ZnTe | 2,16 | 0,15 | 0,65 | 0,11 | М i ×(+) | 0,3 | V M ×(–) | |||
| 0,27 | М i +(2+) | 0,8 | V M – (2–) | |||||||
| CdTe | 1,5 | 0,11 | 0,35 | 0,007 | М i ×(+) | 0,35 | V M ×(–) | |||
| 0,015 | М i +(2+) | 0,6 | V M – (2–) | |||||||
| CdS | 2,27 | 0,20 | 0,70 | 0,06 | М i ×(+) | 0,8 | V M ×(–) | |||
| 0,12 | М i +(2+) | 1,5 | V M – (2–) | |||||||
| 0,40 | VX ×(+) |
Оценить электрические свойства кристалла, полученного в нейтральных условиях при давлении диссоциации Рдисс, т.е. без введения избытка какого-либо компонента в паровую фазу. Объяснить – избыток какого компонента по сравнению с Рдисс необходим в паровой фазе для получения соединения стехиометрического состава.
При значительных концентрациях СТД в нелегированном равновесном полупроводнике дефекты определяют положение уровня Ферми F, как и смещение его в зависимости от условий получения кристалла. Оцените положение F при 300 К в изучаемых разрезах на границах области гомогенности. Для выяснения этого помогут построенные Вами схемы расположения уровней дефектов, ответственных за проводимость, в запрещенной зоне. Поскольку уровень Ферми F – это энергетический уровень, вероятность заполнения которого электронами равна 1/2 при Т> 0, то можно полагать, что все уровни, лежащие выше F, свободны, а ниже F – заполнены электронами. Вероятность заполнения отличается от 1 или 0 только в том случае, если уровень Ферми лежит вблизи уровня дефекта (~3 kТ). Если концентрации разнозаряженных, свободных и заполненных электронами, состояний одного и того же дефекта равны, то уровень Ферми совпадает с уровнем дефекта. Если концентрация свободных состояний больше, чем заполненных, то уровень Ферми лежит ниже уровня дефекта и, наоборот, – в случае преобладания заполненных состояний данного дефекта уровень Ферми лежит несколько выше уровня дефекта Е. Диаграмма равновесия СТД показывает вблизи уровня какого дефекта закреплен F, поскольку это должен быть атомный дефект в 2-х зарядовых состояниях.
Можно определить также удаление F от Е при изменении концентраций разнозаряженных состояний одного и того же дефекта с изменением отклонения от стехиометрии ΔC с изменением условий роста кристалла. Таким образом, возможно оценить положение уровня Ферми по разрезам в пределах всей области диаграммы соединения МХ.
Задание
1. При оформлении отчета указать соединение и температуру расчета равновесия СТД. Представить в виде системы уравнений полную схему дефектообразования.
2. Границы области гомогенности соединения при конкретной температуре построения Вашей диаграммы представить в РМ или lg РМ.
3. Привести величины отклонения от стехиометрии соединения с указанием разреза (РМ или lg РМ) и избытка Х или М.
4. Записать типы дефектов, преобладающие на границах области гомогенности (при максимальном отклонении от стехиометрии при данной температуре). Относятся эти дефекты к донорам или к акцепторам?
5. Привести схемы, определяющие положения уровня Ферми и уровней дефектов в запрещенной зоне в изученных разрезах.